前英特尔CEO加入光刻技术初创公司
近日,英特尔前CEO帕特·基辛格(Pat Gelsinger)宣布加入xLight,担任董事会执行董事长,xLight官网上个月也公布了这一消息。xLight是一家面向极紫外(EUV)光刻机开发基于直线电子加速器的自由电子激光(FEL)技术的EUV光源系统的初创公司。
本文引用地址:https://www.eepw.com.cn/article/202504/469409.htm
xLight虽然规模很小,但其团队在光刻和加速器技术领域拥有多年的经验,不仅拥有来自斯坦福直线加速器和其他地方的粒子加速器资深研究人士,其首席科学家Gennady Stupakov博士还是2024年IEEE核能和等离子体科学学会粒子加速器科学技术奖 (PAST)的两名获奖者之一。
xLight声称目前拥有一种功率超过1000瓦的LPP光源,并且将在2028年准备好用于商业应用。基辛格表示,xLight的技术将每片晶圆的成本降低了大约50%,并将资本和运营成本降低了3倍,这是制造效率的重大飞跃。这可能意味着与ASML今天的机器相比,基于FEL的光刻工具成本将大幅降低。
此外,xLight并不打算取代ASML的EUV光刻工具,而是生产一种“将在2028年连接到ASML扫描仪并运行晶圆”的LPP光源。这可能意味着xLight的LPP光源将与现有的ASML工具兼容,不过与下一代High-NA EUV工具的兼容性尚不确定。
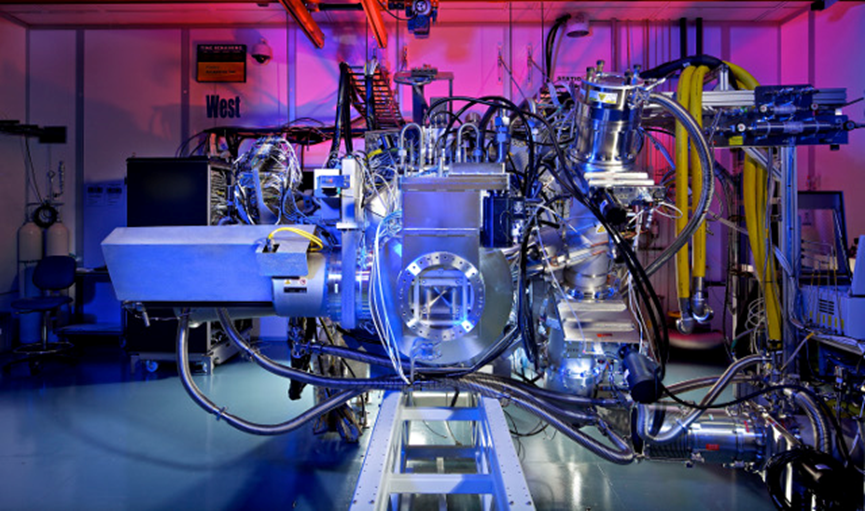
目前光刻机巨头ASML的EUV光刻机所采用的是EUV光源系统,正是基于被称为激光等离子体EUV光源(LPP),其原理是通过30kW功率的二氧化碳激光器轰击以每秒50000滴的速度从喷嘴内喷出的锡金属液滴,每滴两次轰击(即每秒需要10万个激光脉冲),将它们蒸发成等离子体,通过高价锡离子能级间的跃迁获得13.5nm波长的EUV光线。
由于EUV-LPP系统需要依靠功率强大高能激光脉冲来蒸发微小的锡滴,使得其整个光源系统不仅庞大复杂,且功耗巨大,所产生的EUV光源的功率也有限。ASML的Twinscan NXE:3600D配备了250瓦的LPP光源,而NXE:3800E则配备了约300瓦的光源。尽管ASML在研究环境中已经展示了超过500瓦的EUV光源功率,但这些更高的功率水平尚未在商业部署的系统中实现。
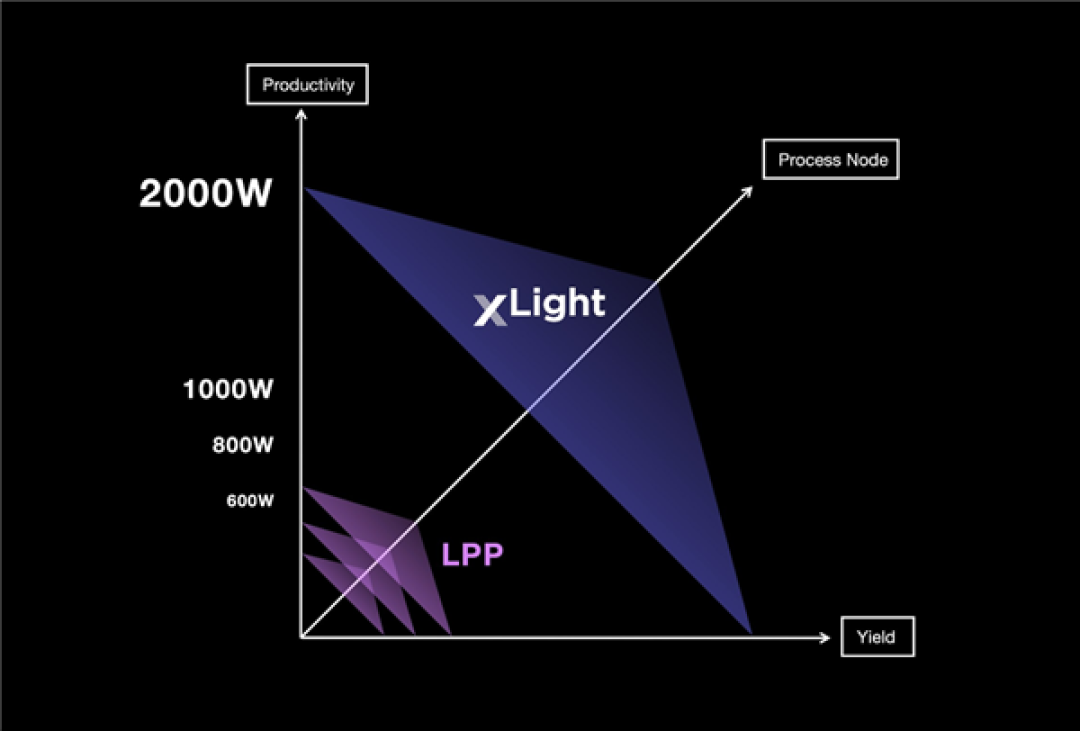
光刻技术是所有先进半导体制造的核心。这个概念看似简单 —— 在硅片上“打印”图像 —— 但它却是业内技术最复杂、成本最高的工艺之一,占据了资本支出的主导地位。随着半导体行业的不断创新,有两种关键手段可以提高性能、生产率和芯片的整体良率:功率和偏振。
LPP是目前用于尖端半导体制造的唯一EUV光产生方法,然而极其耗电(约1.5MW 的电力仅能产生500W的光)。有关研究显示,10kW功率的FEL EUV光源的建设成本约为4亿美元,每年运营成本4000万美元。相比之下,250W功率的LPP EUV光源的建设成本约为2000万美元,每年运营成本1500万美元。
FEL则是一种利用相对论电子束产生相干高强度辐射的激光器,与依靠原子或分子跃迁产生光的传统激光器不同,FEL利用自由电子的加速来产生从红外到X射线波长范围广泛的电磁辐射。FEL是xLight系统的核心,因为它能够在很宽的波长范围内产生强烈、可调的光束。
值得注意的是,ASML在十年前曾考虑转向EUV-FEL光源,近年也在将EUV-FEL光源的技术进展与EUV-LPP光源技路线图进行比较时,再次考虑转EUV-FEL光源。但最终,ASML公司高管认为EUV-LPP光源带来的风险较小。

虽然EUV-FEL光源相比EUV-LPP光源拥有着很多的优势,但是其也面临着体积庞大,难以融入现有的晶圆制造洁净室的问题,比如在现有标准低EUV光刻机当中,光源位于机器本身的下方,而对于High NA EUV设备,其EUV-LPP光源位于同一水平面上,因此任何“第三方”光源系统都必须考虑到这些事实,如果EUV-FEL光源被证实具有商业化价值的话,或许EUV-FEL光源将会融入下一代晶圆厂的设计考虑当中。









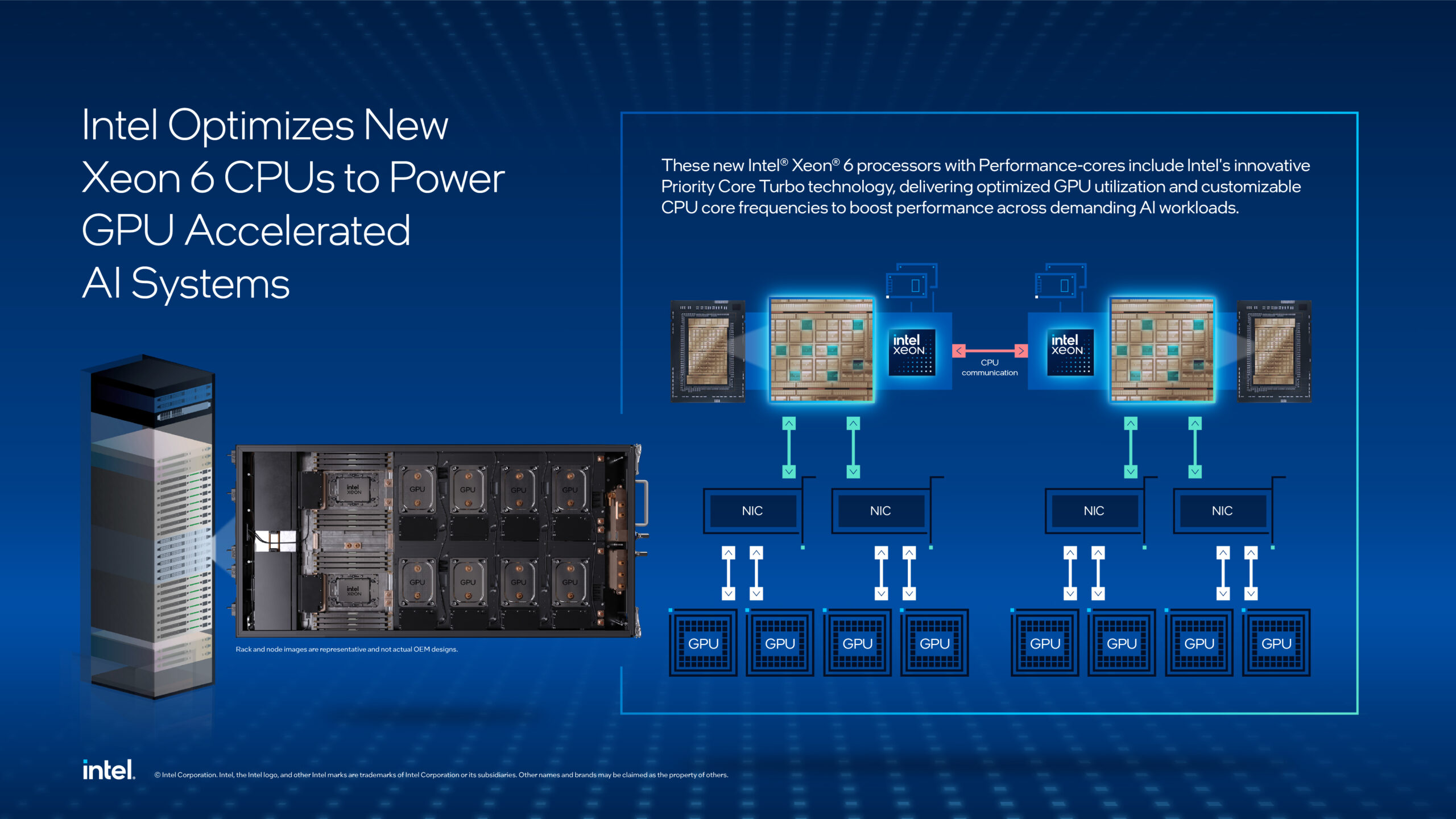




评论