突破性的 KLA-Tencor 技术--通过识别可印刷缺陷实现高等级光罩检测
【加州圣何塞市 2008 年 4 月 24 日讯】KLA-Tencor 公司(纳斯达克股票代码:KLAC)今天推出其称为“晶片平面光罩检测” (Wafer Plane Inspection, WPI) 的最新光罩检测技术。该技术系业界首次在单一系统上提供既可查找光罩上的所有缺陷,又能显示只印刷在晶片上的缺陷的多功能性,堪称独一无二的光罩检测突破性技术。WPI不但征服了对优良率至关重要的 32 纳米光罩缺陷检测的挑战,它的运行速度也比先前的检测系统快达40%,从而有望缩短检测光罩占用生产总时间的百分比。
本文引用地址:https://www.eepw.com.cn/article/81911.htmKLA-Tencor 光罩检测部副总裁兼总经理Harold Lehon指出:“32 纳米技术中的光罩检测越来越需要多种检测模式来辨识所有缺陷。有了TeraScan HR系统及其WPI功能,光罩制造商及芯片制造商不但能够查找所有关键缺陷,还能准确区分哪些光罩缺陷可能被转移至晶片的印刷电路上。有了这一独一无二的技术,客户就能够在光罩检测和晶片厂优良率之间建立与一个成本效益有关的直接联系。”
使用具有业界标准TeraScanHR光罩检测平台,加上先进的软件算法与图像计算技术,用户能够获得基于三个不同的平面--光罩平面(reticle plane)、虚像平面(aerial plane)及晶片平面(wafer plane)的图像。WPI 独一无二的建模算法还能在关键光罩区域自动增加系统灵敏度,一般而言,通常会在那些区域发现降低芯片优良率的缺陷。在多个客户现场进行的测试已证明,与传统模式(检测高等级光罩需要比较小的检测像素)相比,WPI可以使用相对较大的检测像素,从而能缩短光罩检测时间最高达 40%,并藉此提高拥有成本。
关于 KLA-Tencor 的 WPI 技术的更多信息,请见国际光学工程学会 (SPIE) 第十五届国际光罩专题讨论会/日本光罩大会上发表的若干技术论文,该会议于4月16~18日在日本横滨太平洋会展中心举行。
由英特尔公司及 KLA-Tencor 公司的作者撰写的论文“Wafer Plane Inspection (WPI) for Reticle Defects”[Session 12, Friday, 14.30; paper 7028-52] 介绍了具有创新性的WPI 检测在联合开发期间的性能评估。英特尔的文章指出:“光罩检测的目标高度依赖于最终使用。对于光罩车间:(1) 查找实际印刷或影响晶片优良率的缺陷。(2) 查找不印刷但却对光罩制造具有深刻影响的缺陷,并缩短光罩开发周期。对于晶片无尘室。(3) 提供可能限制优良率之缺陷的早期检测。WPI 与高分辨率检测的结合满足了上述所有三个目标。”
英特尔的文章继续指出:“本文的研究证明,在许多测试案例中,90 纳米检测像素能够替代在常规模式下72 纳米检测像素(高 NA)。在 WPI 模式中,在不损失对关键缺陷灵敏度的前提下,‘移植 (migrate)’一个像素的能力(增加像素尺寸)可缩短光罩检测时间约 40%。”
WPI 已被证实可满足芯片制造商在关键 的32 纳米技术中对缺陷灵敏度的要求,且 WPI 技术正联同美国及台湾的领先芯片制造商进行beta版测试。配备 WPI 的系统已经出货给多家客户。



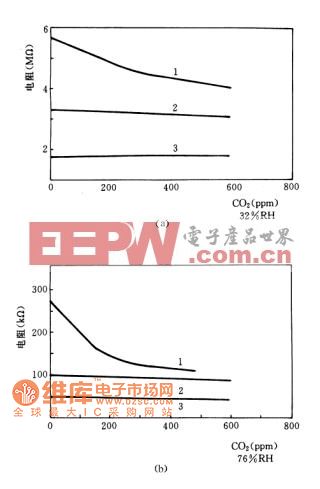



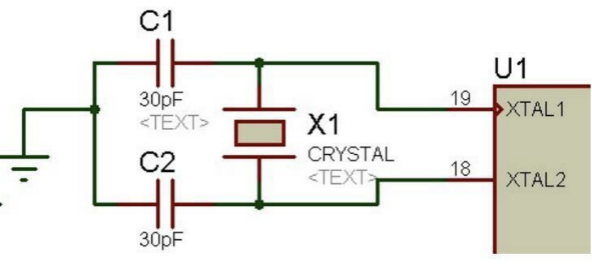
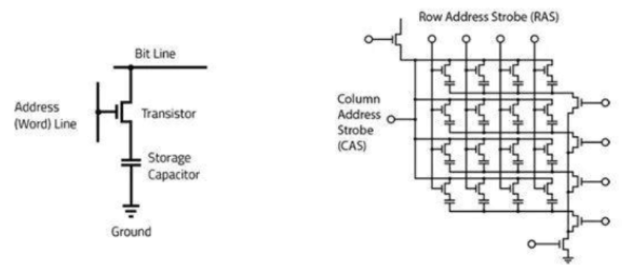
评论