浅析半导体行业图形化工艺之光刻工艺
图形化工艺是要在晶圆内和表面层建立图形的一系列加工,这些图形根据集成电路中物理“部件”的要求来确定其尺寸和位置。
本文引用地址:https://www.eepw.com.cn/article/201810/393570.htm图形化工艺还包括光刻、光掩模、掩模、去除氧化膜、去除金属膜和微光刻。图形化工艺是半导体工艺过程中最重要的工序之一,它是用在不同的器件和电路表面上建立图形的工艺过程。这个工艺过程的目标有两个:

1. 在晶圆中和表面上产生图形,这些图形的尺寸在集成电路或器件设计阶段建立。
2. 将电路图形相对于晶圆的晶向及以所有层的部分对准的方式,正确地定位于晶圆上。
除了两个结果外,有许多工艺变化。或者限定晶圆表面层被去除部分,或者限定晶圆表面层留下部分。
正确地放置被称为各种电路图形地对准或注册。一种集成电路工艺要求40个以上独立地光刻步骤。图形定位地要求就好像是一幢建筑物每一层之间所要求地正确对准。很容易想象,如果建筑物每一层和每一层不能很好地对准,那么它会对电梯以及楼梯带来什么样地影响。在一个电路中,如果每层和他的上一层不能很好的对准可能会导致整个电路的失效。
此外,光刻工艺必须控制所要求的尺寸和缺陷水平。给出在每次图形化操作中的步骤数和掩膜层数,掩模工艺是主要的缺陷来源。在图形化工艺中每个掩模步骤贡献不同。图形化工艺是一个折中和权衡的过程。
光刻工艺概述
光刻刻蚀工艺是和照相、蜡纸印刷比较接近的一种多步骤的图形转以过程。开始将电路设计转化成器件和电路的各个部分的三个维度。接下来绘出X-Y的尺寸、形状和表面对准的复合图。然后将复合图分割成单独掩膜层。这个电子信息被加载到图形发生器中。来自图形发生器的信息又被用来制造放大掩模版和光刻掩模版。或者信息可以驱动曝光和对准设备来直接将图形转移到晶圆上。

有三种主要技术被用于在晶圆表面层产生独立层图形。它们是:
1. 复制在一块石英板上铬层的芯片专门层的图形。依此使用reticle来产生一个携带用以整个晶圆图形的光掩模。
2. Reticle 可以使用步进光刻机,直接用于晶圆表面层的图形。
3. 在图形发生器中的电路层的信息可以直接用于引导电子束或其他源到晶片表面。
这里描述的十步基本图形化工艺在对准和曝光步骤使用放大掩模版或光刻掩模版。图形转移是通过两步来完成的。首先,图形被转移到光刻层。光刻胶类似胶卷上所涂的感光物质。曝光后会导致它滋生性质和结构的变化。光刻胶被曝光的部分由可溶性物质变成了非溶性物质。这种光刻胶被称为负胶,这种化学变化称为聚合。通过化学溶剂把可以溶解的部分去掉,就会在光刻胶层留下一个孔,这个孔和掩模版或光刻母版不透光的部分相对应。
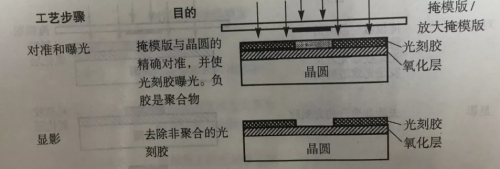
第二次图形转移时从光刻胶层到晶圆层。当刻蚀剂把晶圆表面没有被光刻胶盖住的部分去掉时,图形转移就发生了。光刻胶的化学性决定了它不会在化学刻蚀溶剂中溶解或时慢慢溶解;它们是抗刻蚀的,因此被称为抗蚀剂或是光致抗蚀剂。

在上图中,晶圆表面形成了孔洞。空洞的形成是由于在掩模版上有一部分是不透光的。如果掩模版的图形是由不透光的区域决定的,则称为亮场掩模版,如下图所示。而在一个暗场掩模版中,在掩膜版上图形是用相反的方式编码的。如果按照同样的步骤,就会在晶圆表面留下岛区,如下右图所示。

刚刚我们介绍了对光有负效应的光刻胶,称为负胶。同样还有对光有正效应的光刻胶,称为正胶。光可以改变正交的化学结构从不可溶到可溶。这种变化称为光致溶解。下图显示了用正胶和亮场掩膜版在晶圆表面产生岛区的情况。
显示了用不同极性的掩膜版和不同极性的光刻胶相结合二产生的结果。通常来讲,我们是根据控制尺寸和防止缺陷的要求来选择光刻胶和掩膜版极性,从而使电路工作的。
光刻十步法工艺过程
把图像从掩膜版转移到晶圆表面是由多个步骤来完成的。特征图形尺寸、对准容限、晶圆表面情况和光刻层数都会影响到特定光刻工艺的难易程度和每一步骤的工艺。许多光刻工艺都被定制成特定的工艺条件。然而,大部分都是基本光刻十步法的变异或选项。我们所演示的这个工艺过程是一个亮场掩膜版和负胶相作用的过程。
下面就是这十步工艺的具体流程。

下节小编继续为大家讲解光刻工艺。







评论