晶圆级封装: 热机械失效模式和挑战及整改建议
摘要
本文引用地址:https://www.eepw.com.cn/article/201708/362885.htmWLCSP(Wafer Level Chip Scale Packaging,晶圆级封装)的设计意图是降低芯片制造成本,实现引脚数量少且性能出色的芯片。晶圆级封装方案是直接将裸片直接焊接在主板上。本文旨在于介绍这种新封装技术的特异性,探讨最常见的热机械失效问题,并提出相应的控制方案和改进方法。
晶圆级封装技术虽然有优势,但是存在特殊的热机械失效问题。很多实验研究发现,钝化层或底层破裂、湿气渗透和/或裸片边缘离层是晶圆级封装常见的热机械失效模式。此外,裸片边缘是一个特别敏感的区域,我们必须给予更多的关注。事实上,扇入型封装裸片是暴露于空气中的(裸片周围没有模压复合物覆盖),容易被化学物质污染或发生破裂现象。所涉及的原因很多,例如晶圆切割工序未经优化,密封环结构缺陷(密封环是指裸片四周的金属花纹,起到机械和化学防护作用)。此外,由于焊球非常靠近钝化层,焊球工序与线路后端栈可能会相互影响。
本文采用FEM(Finite Element Method,有限元法)方法分析应力,重点放在扇入型封装上。我们给出了典型的应力区域。为降低机械失效的风险,我们还简要介绍了晶圆级封装的特异性。在描述完机械失效后,我们还对裸片和钝化边缘进行了全面的分析。分析结果显示,钝化边缘产生最大应力,这对沉积策略(直接或锥体沉积方法)和边缘位置提出了要求。此外,研究结果还显示,必须降低残余应力,并提高BEoL(线路后端)的钝化层厚度。
1. 前言和背景
晶圆级封装的设计意图是降低芯片制造成本,实现引脚数量少且性能出色的芯片。晶圆级封装方案是直接将裸片直接焊接在主板上。双层电介质、RDL(ReDistribution Layer, 重新布线层)、UBM (可焊接薄层,用于焊球底部金属化)和焊球都位于标准BEoL栈之上。因此,这些层级扩展了传统晶片制程(多层沉积薄膜配合光刻工艺)范围。晶圆级封装的焊球工艺与倒装片封装非常相似。
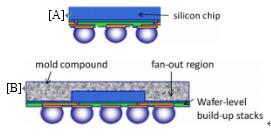
图1:) [A]扇入型封装(晶圆级封装)和[B]扇出封装(封装大小取决于裸片边缘与装配栈层的间隙)
晶圆级封装主要分为扇入型封装和扇出型封装(图1)两种。扇入型封装是在晶圆片未切割前完成封装工序,即先封装后切割。因此,裸片封装后与裸片本身的尺寸相同(图2 [A])。扇出型封装是先在人造模压晶圆片上重构每颗裸片,“新”晶圆片是加工RDL布线层的基板,然后按照普通扇入型晶圆级封装后工序,完成最后的封装流程(图2 [B]) [1-2-3-4-5]。
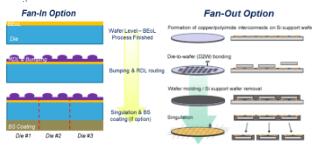
图2:扇入和扇出型封装流程
这里需要说明的是,为提高晶圆级封装的可靠性,目前存在多种焊球装配工艺,其中包括氮化物层上焊球[6]、聚合物层上焊球[7-8]、铜柱晶圆级封装等等。本文重点讨论在RDL层/聚合物层上用UBM层装配焊球的方法(图3)。

图3:采用聚合物方案装配UBM焊球
下一章重点介绍晶圆级封装特有的热机械失效现象。
2. 晶圆级封装集成技术引起的热机械问题
本文特别分析了发生在BEoL层远端(Far-BEoL)和BEoL层的热失效问题。焊球疲劳等与裸片封装相关的失效模式不在本文讨论范围,想了解更信息,请查阅相关资料,例如本文后面的文献[9]。我们先用 BEoL层大面积离层实验图解释裸片边缘敏感性问题,然后讨论焊球附近区域是BEoL远端层破裂的关键位置。
- 裸片边缘
扇入型标准封装裸片是直接暴露于空气中(裸片周围无模压复合物),人们担心这种封装非常容易受到外部风险的影响。优化晶片切割工艺是降低失效风险的首要措施。为防止破裂在封装工序和/或可靠性测试过程中曼延,必须控制切割工序在裸片边缘产生的裂缝(图4 [A])。此外,这种封装技术的聚合物层末端靠近裸片边缘,因为热膨胀系数(CTE)失匹,这个区域会出现附加的残余应力。
为预防这些问题发生,最新技术提出有侧壁的扇入型封装解决方案。具体做法是,采用与扇出型封装相同的制程,给裸片加一保护层(几十微米厚),将其完全封闭起来,封装大小不变,只是增加了一个机械保护罩。
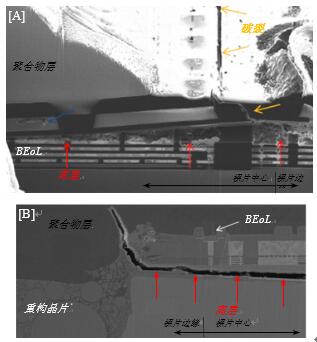
图4:在BEoL内部的裸片边缘离层;[A]扇入型封装[B]扇出型封装
树脂、聚合物层和裸片边缘相互作用,致使扇出型封装的失效风险增加(图4 [B])。
在这种情况下,密封环结构是一个有效的压制应力的方法。作为BEoL层的一部分,密封环是围绕在裸片四周的金属图案,具有防护作用,避免化学污染和裂缝曼延,然而这个结构不足以预防所有的失效问题,所以,必须从以下两方面进行优化:
- 焊球和钝化层下面
晶圆级封装的焊球可以装配在BEoL层上面。钝化层、UBM层和焊球组件具有不同的热膨胀系数,这会在聚合物层上产生应力,在某些极端情况下,甚至还会导致聚合物层破裂,并有可能最终曼延到BEoL栈。BEoL的最上层是钝化层,是由氧化物层和氮化物层组成,前者是化学污染保护层,后者则用于预防机械应力。如果钝化层受损,裸片就会受到各种形式的污染,导致电气失效。因此,必须精心设计BEoL远端层(RDL、焊球和聚合物)。RDL层的密度及其布线需要分布均匀。聚合物及其沉积方法的选择对于器件的可靠性也很重要。图5描述了某些典型缺陷。
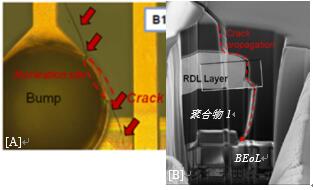
图5:[A]焊球靠近钝化层而引起聚合物层破裂的顶视图[B]在整个栈内出现破裂的BEoL远端层和BEoL层的横截面
解决这些问题需要我们深入了解相关结构和专用的优化方法。
3. 有限元法数值分析
本文重点介绍扇入型封装配置。需要说明地是,某些分析结果同样适用于扇出型封装解决方案(例如,焊球附近结构)。
数值模型
我们使用Ansys的商用软件进行了有限元法分析。第一步是创建一个3D封装模型,以了解WLP封装的应力分布区域。我们探讨了焊球附近和裸片边缘附件的应力分布情况。出于对称性考虑,只描述封装的四分之一(图6)。
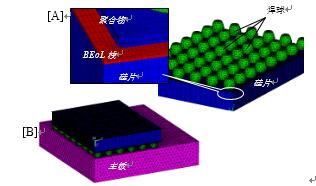
图6:有限元法3D扇入型封装模型 [A] 独立封装 [B] 组装好的封装
第二步是简化BEoL层和聚合物层的建模,用一个20D模型进一步探讨各层之间的相互作用(图7)。这个栈包括四个顶层共行覆膜的金属层和一个标准的密封环结构。为避免数值错误,所有配置均保持网格不变,并根据结果分析材料性质。
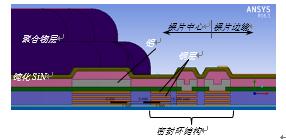
图7:有限元法2D模型包括标准密封环和聚合物层末端
我们对两个模型都施加了225°C至25°C的热负载,模拟回流焊工序,并做了一个线弹性分析。














评论