搞定晶圆贴合/堆叠材料 3D IC量产制程就位
三维晶片(3D IC)商用量产设备与材料逐一到位。3D IC晶圆贴合与堆叠制程极为复杂且成本高昂,导致晶圆厂与封测业者迟迟难以导入量产。不过,近期半导体供应链业者已陆续发布新一代3D IC制程设备与材料解决方案,有助突破3D IC生产瓶颈,并减低晶圆薄化、贴合和堆叠的损坏率,让成本尽快达到市场甜蜜点。
本文引用地址:https://www.eepw.com.cn/article/158915.htm工研院材化所高宽频先进构装材料研究室研究员郑志龙强调,3D IC材料占整体制程成本三成以上,足见其对终端晶片价格的影响性。
工研院材化所高宽频先进构装材料研究室研究员郑志龙表示,高昂成本向来是3D IC量产时程一拖再拖的主要因素,由于成本与制程良率息息相关,因此改良3D IC制造设备与材料,使整体生产流程更上轨道,已然成为供应链业者当务之急。尤其3D IC新增的矽穿孔(TSV)、晶圆薄化、暂时贴合(Temporary Bonding)和堆叠等制程步骤,更是半导体设备和材料商全力抢攻的重点。
据悉,2.5D矽中介层(Interposer)或3D IC包含矽穿孔、暂时贴合、重分布层(RDL)、底部填充(Underfill)、堆叠及成型(Molding)等关键制程,样样都为半导体业者带来严峻挑战。郑志龙指出,晶圆在矽穿孔制程之前或之后,须以特殊胶材暂时与机具贴合,进行晶圆薄化的动作,将晶圆磨薄并剥离后再进入导电材料填充、堆叠和成型等阶段,系传统平面式制程不曾面临的难题,复杂度可见一斑。
由于薄晶圆应力承受度较差,须从一开始的材料掺杂着手,确保在后段制程中不易破碎;而暂时贴合胶材也要具备耐高温、强固贴合且容易剥离等特性,才能提高3D IC制程良率。郑志龙强调,包括IBM、陶氏化学(Dow Chemical)和杜邦(DuPont)等半导体材料研发暨供应商,皆已分别提出3D IC材料掺杂技术论文,以及新的贴合材料与制程方案;同时,台商勤友和志圣也已发表相关贴合设备,有助推进3D IC量产步伐。
事实上,勤友日前甫与IBM签订合作计划,将授权IBM的复合雷射剥离制程技术,开发全新半导体晶圆贴合和剥离设备,提高3D IC生产速度与良率。此外,志圣亦开始出货3D IC真空晶圆压膜机及贴合设备,并已取得一线晶圆代工厂和封测业者的订单,协力打造3D IC产线。
另一方面,3D IC还须导入堆叠制程,包括晶片到晶圆(C2W)、晶片到晶片(C2C)或晶圆到晶圆(W2W)等三种型式;接合方法则有氧化物融熔(Oxide Fusion)、金属-金属(Metal-Metal)、聚合物黏着(Polymer Adhesive)等,以实现立体晶片架构。
郑志龙坦言,堆叠系3D IC制程中最重要却也相对困难的环节,不仅要考量裸晶良率(KGD)问题,还须仰赖高度客制化的设备和材料技术,才能达到量产良率。目前美日半导体设备暨材料厂均各自押宝特定技术,并投资大笔资金开发依存性相当高的材料和设备,拉拢半导体制造业者;而鸿浩、肥特补、南亚、长春化工和长兴化工等台商在台积电高呼将增加国内采购比重后,亦积极展开研发,未来可望在3D IC市场抢占一席之地。
与此同时,工研院材化所亦致力研发3D IC暂时贴合、堆叠、电镀液和RDL层感光材料,正陆续导入电光所建置的奈米晶圆产线进行测试与验证,一旦技术成熟并技转后,台商在3D IC上游供应链将更具竞争力。
逆变器相关文章:逆变器原理
可控硅相关文章:可控硅工作原理
pwm相关文章:pwm是什么
逆变器相关文章:逆变器工作原理
比较器相关文章:比较器工作原理







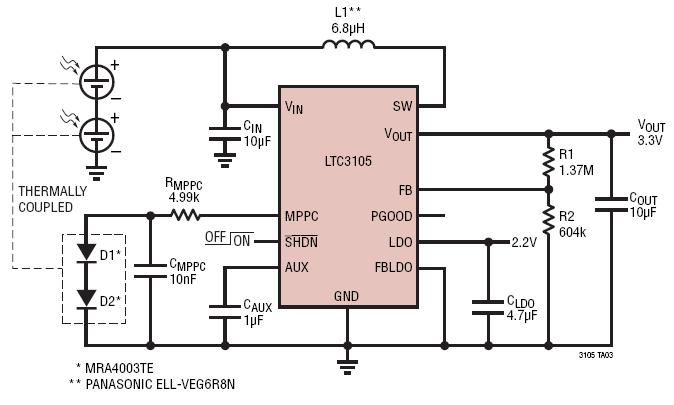
评论