英特尔的Tri-gate并非一场容易的竞争
—— FinFETs可能在性能和功率上更加通用
领导加州大学伯克利分校小组的胡正明在十二年期提出过实际可行的FinFET器件,他说:“最重要的一点是,英特尔正在投入生产FinFETs。英特尔公司是很值得尊重的,他们连续带领了两年的结垢产业” 胡先生在5月4日宣布:“这进一步证实了作为一个公司的名誉和做事态度。还表明如果一个组织投资充足,他们就可以对这些投资作出更充足的回报。最初这些过渡也许会非常艰难,但是,如果有适量的时间和金钱以及人们的投资,他们就能完成。”
“我对于我自己关于FinFETs和UTB-SOI将要生产的想法立场坚定。我希望两个都成为成品。像英特尔和TSMC这样的大公司,将有资源去生产FinFETs,而其它公司也许会去生产UTB-SOI,意法半导体也是最有可能使用UTB-SOI的”他说。
胡先生还说:“FinFETs可能在性能和功率上更加通用。另一方面,FinFETs在生产控制、布局、元件库方面采取了更多的发展资源。” FinFET器件的制作是具有挑战性的。“我觉得设备工业并没有被世界上其它国家所熟知,所以英特尔公司真的没有必要花很多精力在新的装备上。如果界面设计团队紧密,资源足够大,FinFETs的诱惑会很大,但是还要获得投资,UTB-SOI就不需要那么多的技术发展投资,”胡先生说。 胡先生指出,翅片必须非常薄,约等于栅极的长度,以完成抑制漏电流的目的。为了保持翅片厚度完全一样,需要整个晶圆过程有非常良好的控制。 “为了大规模的FinFETs,工业还需使翅片越来越薄。早在1999年的论文中,我们被告知它可以缩小到10nm,但是现在我相信我们能够超越它。” 汤普森先生的五年预见 斯科特汤普森,佛罗里达大学教授,他说,“开发一个像tri-gate复杂的技术需要在硅资源和人力上有重大投资—可能超过1000人的开发团队” 这个挑战很复杂以至于英特尔大约需要成千上万的晶圆来解决问题。
tri-gate是“至少一个数量级要复杂于90nm的应变硅或者45nm的high-k金属栅极。这就是为什么它花费了英特尔八年的时间来落实和为什么我不认为其他人将要在未来五年或者更长的时间来购买它。”早年在英特尔技术制造部工作的项目经理汤普森说。 tri-gate有不少非常新颖的元素,他说,最关键的是“在没有任何代工生产的今天。”复杂性存在于发展精准的用原子层沉积工具把“gate-last”与介质和金属沉积层的叠加。
“该p+SiGe S/D(用 >50% Ge) /n+Si S/(>1e19)的集成需要一个非常复杂的工艺,材料和异国处方。在生长过程中硅的鳍密度目前看来是非常低并且它呈现出的挑战以取得该鳍的蚀刻侧壁统一的计划免疫,”他补充说。 具有低接触电阻的鳍,外延必须种在鳍的源极和漏极—否则驱动电流和性能会受到影响。 “在英特尔性能要求的基础上,可以得出结论:pFETs,高度原位掺杂硼p+硅锗是在p型晶体管的鳍上增长。而NFET,掺硅外延硅或需要在源/漏极成长。” 为了用低缺陷鳍在pFETs和nFETs培养双重选择性外延薄膜“是一个困难,复杂和昂贵的过程,”他说。为了制造外双延,汤普森说他相信英特尔“实施的许多限制性的鳍布局设计规则。这些新的设计规则将阻止传统IP重用。这些问题都不是英特尔的目标市场的问题:高性能,高利润的CPU。但是,经济权衡不同于SOC的世界,有许多不同类型的晶体管被提供,”汤普森说。
汤普森说,在22纳米的tri-gate鳍显得相对短,在未来的两个节点,英特尔将有可能试图让它们长得更高,这就提供了更大的面积。 “但高鳍将推出一个附加电容和一个在鳍和接触点之间的高重叠电容,以及更大的栅极电容。随着高尺寸鳍变化阈值的变化会增加,超过了标准线边缘粗糙度较大,会增加Vt的变化,这是在22纳米及以下的关键。
“英特尔公司没有公布其AVT,但是其它公司报告的2 mVum 大容量FinFET元件,已是高于预期值。这背后的物理学是,掺杂鳍非常困难,随机掺杂效应使得相同的电晶体有不同的阈值电压。”汤普森说。制造完美的过亿元或万亿晶体管的鳍是“一个很大的挑战,”汤普森说,虽然英特尔的优势是用工厂设备和运行的保持恒定管理一个绝对单一的团队。生产22纳米晶圆的成本是很高的,在$4-5B范围内,英特尔的这个决定,会提高其今年资本支出计划100亿美元,汤普森说。 看到应用的“大胆步伐” 克劳斯徐格拉夫,硅系统集团应用材料首席技术官说:“我认为我们首先应该认识到胡晨敏教授和伯克利分校设备组。这是一个长达十年的追求,以满足部分将如何就其能够使在一个非常突然的方式对一个晶体管的最终能力。在考虑到以非常突然的方式的发动能力下如何发现晶体管的极限容量英特尔的22纳米一代在行动“是一个大胆的一步,它体现了英特尔的勇气,随着我们在新的FinFET领域,使之成为现实。”
徐格拉夫说。 FinFET元件要求的鳍是“非常垂直的,”它提出的几个方面的挑战。蚀刻在90度角附近的结构,没有锥度,是必不可少的。 “这蚀刻结构实际上是该设备的通道。如果稍微偏离轴线,晶体管的流动性就不会太理想。” 光刻必须能够制作出一个非常狭窄的鳍,比扫描仪的限制分辨率还要少。 “在这种情况下,鳍是与门同样的情况。鳍比照片限制少,所以两层必须要少。” 如何收缩CD在这样紧凑中,如何蚀刻胶片会得到一个可靠的收缩,小于照片限额,而且要可靠,只是众多挑战之一。在Dan Maydan Center工作的,应用材料公司的技术专家已“在光盘蚀刻均匀性的产品上努力工作,在蚀刻过程非常精确的控制。这方面的需要是很普遍的,不仅仅是FinFET元件,还有许多其他的结构,包括闪存和DRAM,徐格拉夫说。 三维扫描仪相关文章:三维扫描仪原理



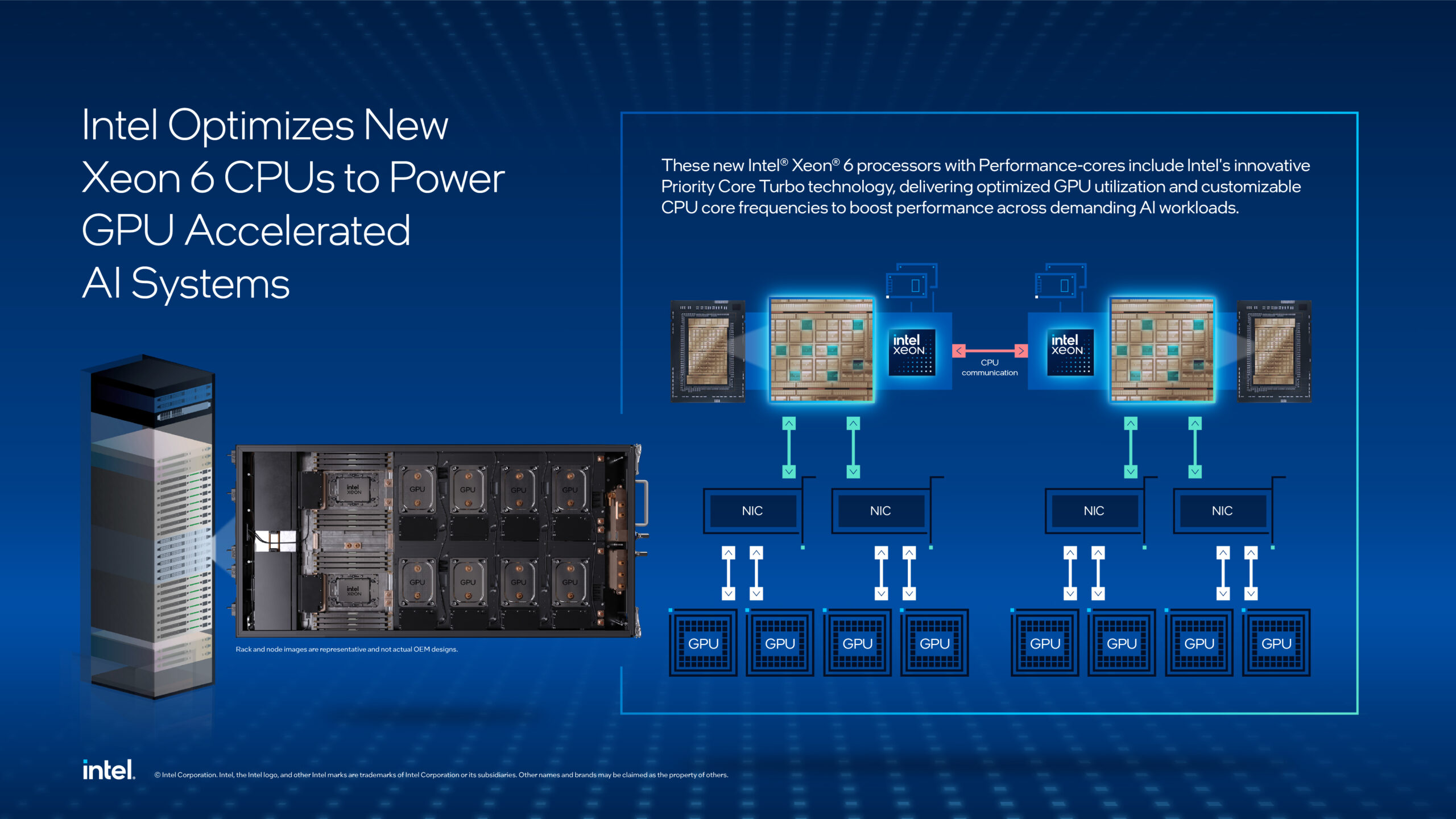












评论