技术探秘:英特尔45纳米高k金属栅极工艺
英特尔出货采用高k金属栅极技术的首款45纳米微处理器。不论是为了突出这件事的重要意义,还是为了强调其著名定律仍然有效,摩尔已成为英特尔45纳米技术营销活动的主角。摩尔称这项创新是“20世纪60年代多晶硅栅极MOS晶体管出现以来,晶体管技术的最大变化”。甚至《时代》杂志认为,英特尔Penryn微处理器是2007年最佳发明之一。
但在这些高调宣传背后还是有一些实质内容的。硅半导体产业对多晶硅爱不释手,难以割舍;实际上,许多制造商在到达32纳米节点以前不会放弃多晶硅。英特尔向来比同业更快地推出新技术,它的45纳米处理器也不例外。英特尔的这种晶体管工程,是一个巨大进步。这主要是通过采用高k金属栅极——HkMG实现的。
摩尔定律随着MOS晶体管尺寸、功率和性能不断缩小而得到证明。自从到达90纳米节点以来,晶体管的物理尺寸一直保持不变。一旦栅极介质缩小到1.2纳米(大约相当于四个原子层),就难以进一步缩小了。
硅CMOS发展成我们目前占据的ULSI世界,主要是因为这种天生的氧化物在所有的硅表面上都能快速生长。以非常低的缺陷密度在通道表面上生长SiO2的能力,产生了NMOS和CMOS,取代了硅双极技术,用于生产集成电路。从130纳米节点开始,把氮加入SiO2使电气性能有了一些提高。
90纳米需要有新材料来代替栅极介质,这样才能维持摩尔定律的有效性。但是,通道应变工程得到广泛采用,把栅极介质替换推迟了几代。应变硅提高了晶体管的性能和功耗,在没有引入革命性材料的情况下维持了制程的发展速度。
模片标记(die marking):Intel Penryn
但氧氮化物,即SiON栅极介质的厚度已经不能再薄了。由于SiON只能使介电常数(k)改善50%左右,所以材料必须有根本性变化。进一步降低SiON的厚度,将导致栅极漏电流过高,并降低器件的可靠性。45纳米器件目标需要1纳米厚的SiON层,实际上只有三个原子层那样厚。不仅漏电流是个大问题,而且也没有为厚度变化留出余地。
利用高k材料的好处是,可以把它的物理厚度做得很小,以限制栅极漏电流,同时从电气角度也可以把厚度做到很薄,以对FET通道有足够的控制,维持或提高性能。
英特尔向来在缩小尺寸方面不遗余力,尤其是在栅极介质方面。65纳米节点上的物理厚度值比AMD的四核微处理器薄13%。在65纳米节点上,英特尔与AMD技术之间的根本差异是开始晶圆(starting wafer)。AMD转向绝缘体硅(SOI),英特尔则坚持使用块状硅(bulk silicon)。乍看起来这可能显得不合逻辑,因为SOI器件的栅极漏电流问题较小,而且可以利用更薄的栅极电介质来满足规格。AMD的做法是在给定的晶体管性能水平上,更加严格地限制功耗。
NOMS晶体管:电子扫描电镜截面分析
英特尔声称,进一步降低SiON的厚度是可行的,但考虑到缺乏到32纳米的可缩放性,可能还不具备生产条件或者值得这么做。为了说明这点,在11月初举行的IBM通用平台技术论坛会议上是这样表述的:“原子不能缩放。”
在宣布45纳米制程和高k之前,英特尔科技与制造部门的高级研究人员Mark Bohr经常指出,源极与漏极之间的通道泄漏比栅极至通道的泄漏大得多。英特尔认为,不值得在SOI上面下功夫,而且它增加了成本。在大家全力提高MPU时钟频率的时代的早期,晶体管权威Tahir Ghani就指出,100 A/cm2左右的栅极漏电流密度是可以接受的。当时的普遍目标只有1 A/cm2。因此,英特尔迫使业内的其它厂商放松了对可以达到的栅极泄漏的期望。
但那是在过去。现在,集成电路已发展到了新的时期。陌生的新材料首次出现在英特尔的45纳米晶体管的栅极堆叠结构之中。利用在栅极堆叠技术方面取得的巨大进步,英特尔现在的目标是把漏电流改善10倍,甚至更多。
PMOS晶体管:电子扫描电镜截面分析
高k电介质对于半导体产业来说并不是全新的东西。摩尔定律已经推动DRAM单元尺寸缩小到了相当的水平,以至于存储电容器需要采用专门的电介质。
各种材料在DRAM中得到了广泛采用。Al2O5和ZrO2被许多厂商用于生产大批量DRAM。但英特尔是采用任何高k材料的第一家逻辑IC制造商,而且是业内第一家利用高k栅极电介质生产FET的厂商。
技术路线图
2005年国际半导体技术路线图指向2008年可用的技术,但更重要的是,它指出栅极漏电流达到900 A/cm2左右时,必须采用高k电介质。
在45纳米上,对于HkMG来说有两个似乎可行的选择。你可以从一个mid gap金属开始,并分别为NFET和PFET优化栅极电介材料。这是一种双重高k方法。另一种选择是采用一种单一栅极电介材料,同时为N型和P型器件调整栅极材料选择。这就是所谓的双重栅极工艺。后一种选择被英特尔选中,而且可能是分析师押注时间最长的一种选择。
英特尔45纳米技术的主要特点是利用HfO2作为高k电介材料,把TiN用于NFET取代栅极,把TiN barrier与一种功函数金属组成的合金用于PFET取代栅极。
英特尔发表了一篇文章,其中有据信是它的最终材料选择,但采用了保守的设计规范制造。英特尔高级研究人员Robert Chau及其共同作者(他们在英特尔的HkMG研究方面都有许多成果)声称,在1.3V的漏极电压下,NFET的ION = 1.66 mA/微米,IOFF = 37 nA/微米。据称PFET的数据是ION = 0.71 mA/微米,IOFF = 45 nA/微米。这些数值是利用80纳米栅长度晶体管得到的。我们的英特尔晶体管特征值现已齐备,可以与文献中的数据加以对比。
采用高k栅极电介质未能降低英特尔65纳米SiON的等效氧化物厚度(EOT),似乎有些奇怪。实际上,我们的测量与估计显示,厚度还略有上升。但此处真正的故事是金属栅极技术,因此我们同意摩尔的说法,即这可能是多晶硅栅极推出以来晶体管技术的最大变化。正如其他人所指出的那样,它使MOS器件全面地较早采用了金属栅极。
许多技术世代以来,EOT缩放问题的最重要部分是多晶硅栅极的空乏层电容。大自然不会允许多晶硅提高金属性,以克服这个问题。SiON的物理缩放也已达到极限。英特尔只能转向金属栅极,而且有理由同时利用新型电介质来代替氧氮化物。展望未来,英特尔将继续改善电介质工艺参数,以开始提高新型高k堆叠的性能。
45纳米节点NFET突破2-mA/微米障碍似乎是可行的。但是,我们预计,第一代英特尔45纳米制程,性能不会比80纳米测试结构有太大的提高。但是,是英特尔第一个开始采用45纳米制程的吗?也许松下电器的最新制程更应该早点提及,但我认为,它已习惯或者将会习惯处于英特尔45纳米阴影之中。就尺寸和晶体管密度而言,松下的UniPhier IC实现了真正的45纳米技术,而且先于英特尔投入了市场。采用这种工艺的松下Blu-Ray播放器在11月初就上市了。通过采用沉浸光刻工艺,松下实现了我们迄今看到的最小的金属图案,M4 half-pitch为67纳米。但是,这种栅极堆叠技术比较传统,而且比英特尔的落后很多。36纳米多晶硅栅极的设计目标不是为了实现最佳性能,而是为了把两种并列的H.264解码器塞进一个单一硅片之中。
也许令人惊讶,松下实现的金属间距比英特尔更紧。虽然英特尔可能因为把干式光刻推进到了45纳米而感到自豪,但它无法与松下工厂所达到的尺寸相比,松下工厂目前采用的沉浸设备。例如,UniPhier器件最小间距是138纳米,直到M4层金属。而英特尔Penryn的M2层间距为158纳米。
未来节点
英特尔已为45纳米选择了一种解决方案,只需连续地改善工艺,而不必对材料进行重大改变,就能缩微到32纳米。超过了32纳米,将是新的游戏。sacrificial poly的线宽为22纳米,将导致沟道过窄,无法沉积金属栅极材料。我们可以预期,英特尔将采纳一种垂直通道晶体管技术,它被称为三栅极(tri-gate),将包含许多在45纳米平台上推出的材料技术。
虽然英特尔可能已被打到了45纳米,但它的高k金属栅极堆叠技术是一个重大技术成就,将允许晶体管缩微进程在停滞了多年以后重新启动。












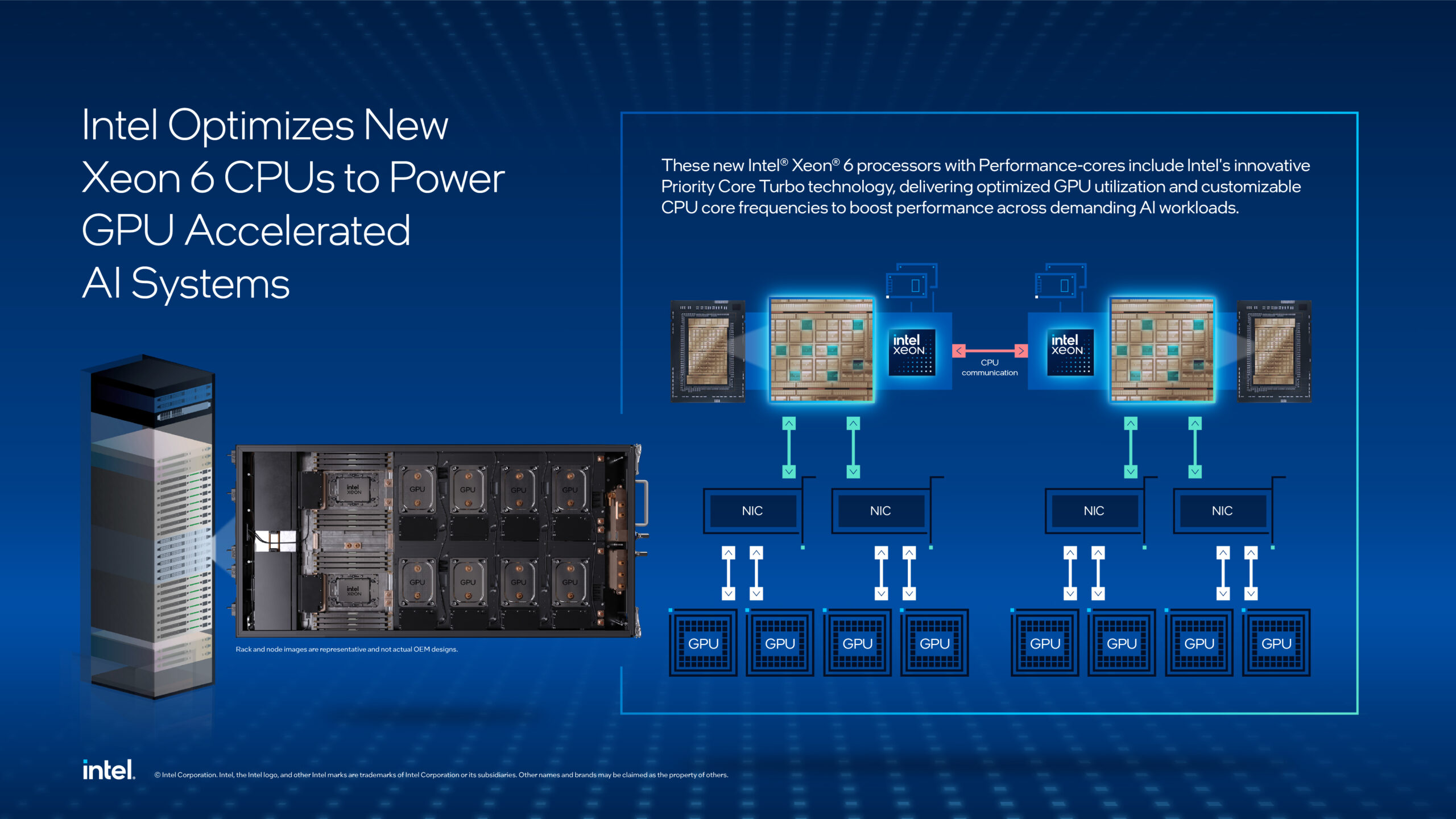



评论