多芯片封装:高堆层,矮外形
SoC 还是 SiP?随着复杂系统级芯片设计成本的逐步上升,系统级封装方案变得越来越有吸引力。同时,将更多芯片组合到常规外形的单个封装中的新方法也正在成为一种趋势。
要 点
多裸片封装是建立在长久以来确立的提高电路密度的原则基础上的。用90nm工艺开发单片系统ASIC 的高成本促使人们研究多芯片的替代方案。很多雄心勃勃3D芯片封装的前兆是用于手机存储器中相对简单的叠式裸芯片结构。经过多年的单纯概念性研究以后,完全3D化芯片至芯片连接成为现实可行的技术。
现在我们有了系统级封装(SiP),或多芯片封装。以前它们叫做多芯片模块,更早时叫混合电路。本质上来说,这些都不是什么新鲜东西,无非是将多个有源元器件装入一个认为是 IC 的封装里。事实上,它就是集成电路的早期实现方法。在遥远的过去,常见的方法是用“单片 IC”表示厂商将所有功能集成到一个硅片上。而建立这种组合的基本动机至今没有变化。我们采取这种途径,是因为无法从技术上或经济上在单个芯片中实现某些功能的组合。随着时间的流逝,这些因素之间平衡的变化可能改变对多芯片解决方案的决策。
很快有了更大内存
决策过程的一个方面是依据工艺技术的极限。例如,对于内存,长期以来确立了一条通过创新封装提高器件密度的路径。当内存沿着摩尔定律发展时,在任何时点上 DRAM 芯片都有一个相应的最大可行尺寸。并且在那相同时刻,总会出现这个尺寸不够用的一些项目。一些专业供应商会将多个裸芯片装入标准单芯片外形尺寸的封装内,从而制造出满足要求的部件。通过预测封装印脚的未来发展,这些供应商已经能在产品上市之前几个月就可以估计并模仿出下一代单芯片部件的器件。由于 SRAM 内存单元的尺寸较大,它的密度总是比 DRAM 要落后一至两代,而将多个 SRAM 芯片封装为一个部件,就可以用类似的尺寸提供相等的密度。今天,这个办法同样已用在闪存上。像White Electronic Designs公司这样的供应商不断将多个芯片封装为一体,而且White Electronic Designs公司最近还宣布推出了一种 64 MB 的 Flash MCP(多芯片封装),设计用于嵌入式应用和高可靠性应用,提供商用、工业和军用温度范围。该器件为13mm









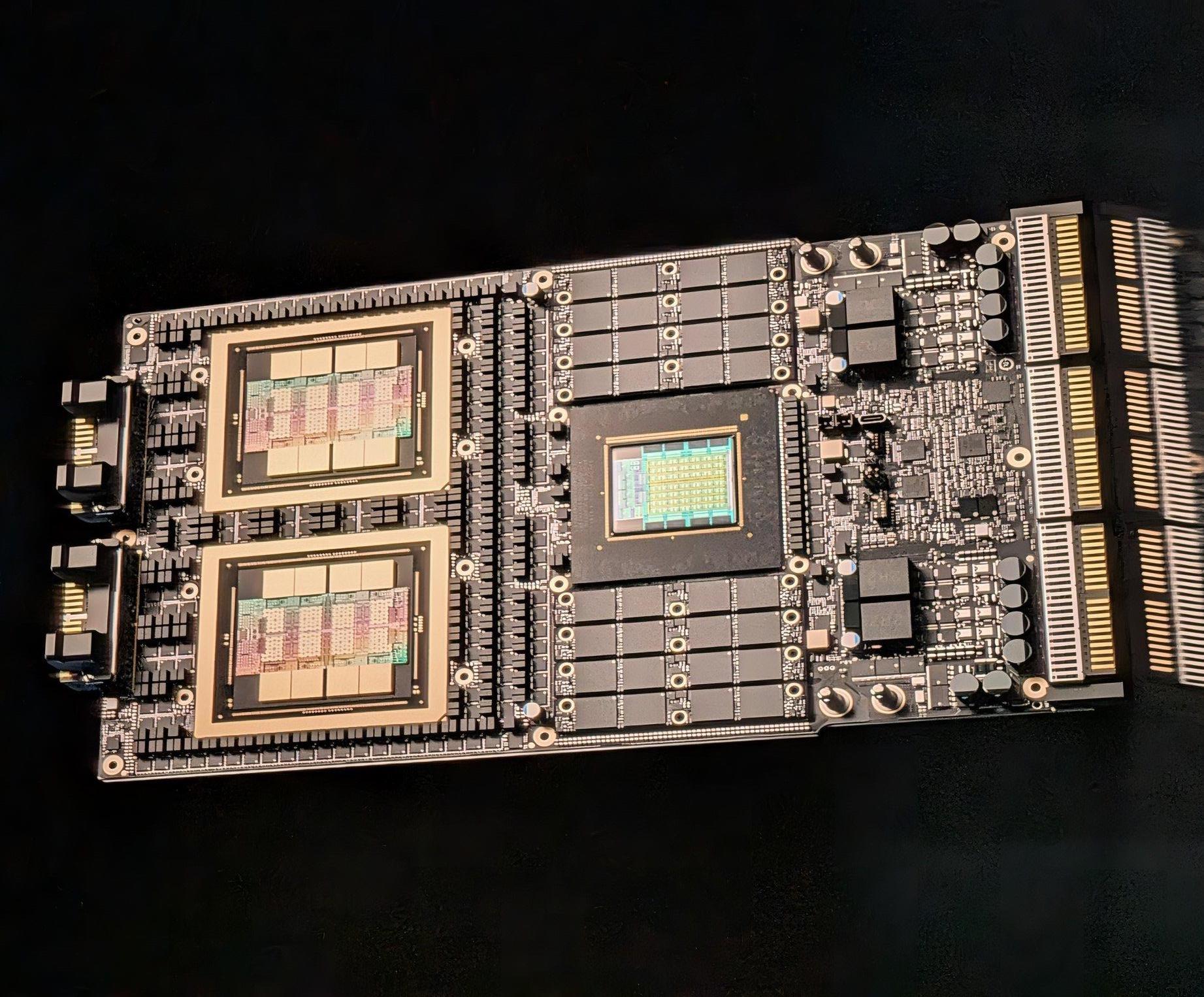









评论