晶圆级CSP封装技术趋势与展望
当隔离层更厚(>5um)、线路图形更厚(>5um)、线路阻抗更低(铝的60%)时,电感通常比SoC中使用铝线路的电感更优越。WLCSP技术中制作铜电感可以实现芯片更低的功耗,使应用扩张到移动产品中。线宽和空间分布L/S是实现高性能电路的重要指标,因此光刻和电镀也成为整个工艺流程中最重要的技术。
未来的线路再分布技术
生成电路图形是上文提到的基本技术的重复。它生成UBM层,涂上光刻胶并生成所需的图形,然后进行电镀,最后再去除不再需要的光刻胶和UBM层。可以说,这个工艺还是所谓的“浪费材料的技术”。
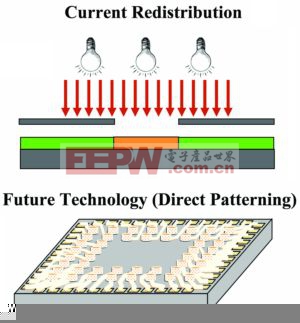
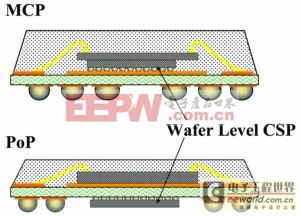
目前业界已经开发出了一种不会“浪费材料”的技术,它可以直接实现图形制作(图4),以替代现有的“浪费材料的技术”。该技术采用纳米胶(nano-paste)和刻印喷?SPANlang=EN-US>(inkjetprinting)技术。这种技术的L/S指标目前还不能达到现在采用光刻、电镀技术实现的精细间距水平,然而,它是有益生态的技术,通过进一步的开发,这种技术可能会使用在更多的应用中。
WLCSP技术的展望
WLCSP在2000年应用在电子手表中之后,已经应用在手机、存储卡、汽车导航仪、数码设备中。未来几年中,在手机这样的高性能移动市场中,会更多采用WLCSP技术的芯片。
电子终端产品市场需要各种不同的系统级封装(SiP,SystemInPackage),已有的形式包括在一个多芯片模块(MCP,MultiChipPackage)封装,以及封装体堆叠(PoP,PackageOnPackage)等SiP的不同形式。手机设备中“SRAM+Flash”的封装是推动SiP技术实现高性能电子设备的重要动力。
WLCSP技术为实现生产轻薄和小巧电子设备带来了更多的可能性。WLCSP已经应用在电路板组装上,近来它也成为SiP的重要组成部分,结合WLCSP和常规引线键合技术的MCP也已经进入量产(图5)。
集成电路通常通过回流焊贴装在PCB板上。使用常规的表面贴装技术,PCB的组装密度将接近极限。将芯片嵌入到PCB板中的技术可以实现更高的功能,并已经有量产。将WLCSP技术和芯片嵌入PCB工艺结合,可以确保PCB组装质量的稳定,这是因为WLCSP不仅易于进行PCB板贴装,而且具有“已知优良芯片(KGD,KnownGoodDie)”的特性。
结论
WLCSP不仅是实现高密度、高性能封装和SiP的重要技术,同时也将在器件嵌入PCB技术中起关键作用。尽管引线键合技术非常灵活和成熟,但是WLCSP技术的多层电路、精细线路图形、以及能与引线键合结合的特点,表明它将具有更广泛的应用和新的机遇。
回流焊相关文章:回流焊原理






评论