EUV将在7纳米节点发威?
核心提示:荷兰半导体设备大厂 ASML 现在勉为其难地承认了其客户私底下悄悄流传了好一阵子的情况:大多数半导体厂商仍将采用传统浸润式微影技术来生产10奈米制程晶片,而非延迟许久的超紫外光微影(EUV)技术;不过这恐怕将使得10奈米节点因为无法压低每电晶体成本,而成为不受欢迎的制程。
本文引用地址:https://www.eepw.com.cn/article/263125.htm荷兰半导体设备大厂 ASML 现在勉为其难地承认了其客户私底下悄悄流传了好一阵子的情况:大多数半导体厂商仍将采用传统浸润式微影技术来生产10奈米制程晶片,而非延迟许久的超紫外光微影(EUV)技术;不过这恐怕将使得10奈米节点因为无法压低每电晶体成本,而成为不受欢迎的制程。
ASML总裁暨技术长Martin Van den Brink在接受EETimes美国版编辑访问时表示,若传统继续采用浸润式微影, 10奈米节点以下的许多关键电路层将会需要三重甚至四重曝光:“因为无法充分降低成本,10奈米制程节点将会陷入成为没人喜欢的窘境;但其成本应该还是下降至足以让它继续前进的一天。”而他坚持,针对10奈米之后的 7奈米节点,晶片制造商会需要采用EUV技术才能以具成本效益的方式生产晶片,若继续采用浸润式微影,有些电路层可能会需要用到13道曝光程序。
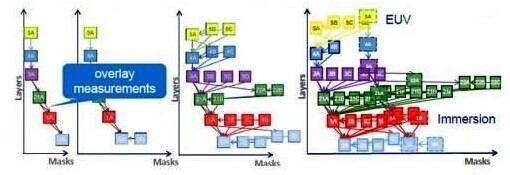
ASML总裁暨技术长Martin Van den Brink表示,若不采用EUV技术,7奈米节点的某些电路层会需要13次曝光(最右边);而10奈米节点则需要使用三重或四重曝光(右二)
不久前,ASML的大客户英特尔(Intel)院士Mark Bohr才表示已经找到不需要采用EUV来生产7奈米晶片的方法;他透露:“我现在全力投入7奈米节点技术研发,我很想用EUV,但我不能拿自己的职业生涯或是英特尔的未来下赌注…而我认为7奈米节点不需要EUV是可行的。”
而对此Van den Brink指出,英特尔的7奈米节点实际上就是产业界所认为的10奈米节点,该公司在制程技术命名上总是比其他业者往前跳一个世代,但基本上与竞争同业所采用的微影解析度是相同的,因为他们用的是同样的微影设备。他强调,随着基础半导体制程技术日益复杂,厂商对制程技术的命名方式也变得越来越不容易看透: “这在今天来说都是市场行销策略的一部分,太难以理解。”
EUV技术进展脚步缓慢
当2016年多数晶片业者开始在10奈米制程节点评估采用EUV系统,光罩业者也需要支援EUV;不过Van den Brink表示,晶圆厂虽会在10奈米节点进行EUV测试,并不会着手进行量产,而是会等到7奈米制程节点,而相关工具的生命周期至少长达10年:“光罩的产量比晶圆片低得多,所以光罩业者在产业界主流技术变化时比较脆弱、态度也会更保守,因此EUV技术要向前进,鼓励光罩业者们投入研发是很重要的。”
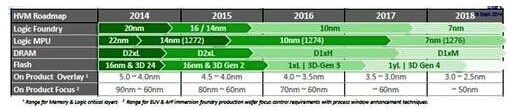
ASML致力使微影技术赶上半导体技术发展蓝图
除了需要光罩业者支持,EUV还面临许多挑战,最大的一个就是可靠、高功率的光源,以支援该技术达到一日1,000片晶圆的产量;Van den Brink表示,目前ASML研发中的EUV系统采用77W光源。预计到今年底,该公司可达到80W光源,是该公司客户目前采用之40W光源的两倍;而 80W光源也会是该公司将在明年出货之3350B系统的关键功能。
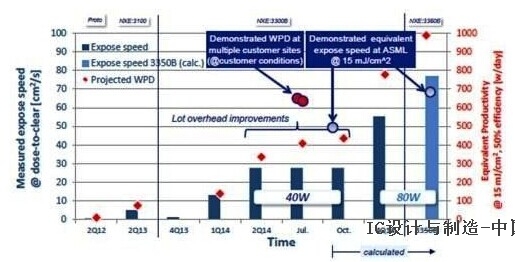
ASML预计在2015年推出80W光源EUV系统
3350B的终极目标是达到每日1,000片晶圆产能──这是商用微影设备的基本性能──不过一开始出货给客户的系统每日产能可能实际上为800片晶圆;ASML计划透过光学组件与软体方面的多次升级,让EUV能支援7奈米节点晶片日益精细化的电路制作需求。
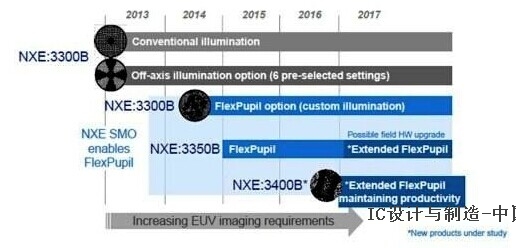
ASML预计在2015年之后,EUV将在光学技术以及支援软体方面持续升级
而在9月初于台北举行的2014年度 SEMICON Taiwan 国际半导体展上,ASML亚太策略行销总监郑国伟则表示,该公司的EUV系统已经在几个客户端进行测试,确认可以满足10奈米及7奈米制程中对 imaging (成像) 和overlay (制程影像叠对)的需求。在加强曝光机效能的同时,ASML也持续强化 EUV 的source power (光源功率) 和availability (可用性),目前都有达到客户期望的阶段性目标。
而在生产力方面,ASML的目标是在2014年底达到每天曝光500片晶圆,而2016年底前达到每天曝光1,500片晶圆,才能符合客户的量产需求;在最近几项客户端的测试中,已经证明其EUV系统在晶圆曝光的速度上,已经具备每天曝光600片晶圆的能力。
一台支援7奈米制程节点的可量产EUV系统,要价达1~1.2亿美元(9,000万欧元),是传统浸润式微影机台的两倍;不过Van den Brink表示,该公司的设备是采用模组化设计,拥有早期原型设备的客户能获得分阶段的设备升级支援。郑国伟则在SEMICON Taiwan 2014时指出,ASML第三代EUV机台3300B已在全球出货6台,其中包括台湾地区客户,出货时除了与货运业者协商最大空运货柜尺寸,还出动了11 架次的747等级货机才把完整机台全部运载完毕。3300B在今年底、明年初还将出货5台。
其他EUV技术挑战

EUV须将光罩缺陷降至0
EUV 系统还需克服的技术挑战是减少光罩缺陷(mask defects),空白光罩上的缺陷需降低至0 (如上图);Van den Brink表示:“只要在光罩上有一个缺陷粒子都是隐忧,所以我们已经开始着手研发光罩护膜(pellicles)。”浸润式微影一直是仰赖保护层 (protective layer),不过EUV专用的保护层还在研发阶段;ASML已经证实,把85%穿透率的护膜装在一半的EUV光罩上,不会对晶圆成像造成显着影响(下图)。
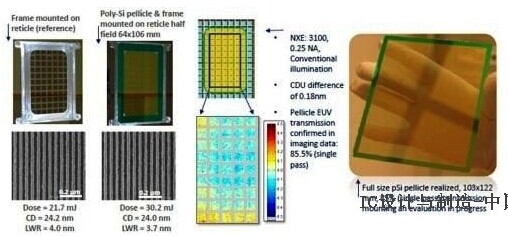
ASML着手为EUV开发光罩护膜以降低缺陷
现在ASML正在测试覆盖整个光罩的护膜,不过Van den Brink强调,该公司的目标是达到不采用护膜的零缺陷光罩;如果产业界需要保护层,应该是由光罩业者提供:“我们会持续开发护膜,也愿意将相关技术转移给第三方供应商。”可惜到目前为止还没有人表示兴趣。此外Van den Brink也报告了针对EUV应用的化学放大光阻剂(chemically amplified resists)研发进展,表示该公司正在测试各种化学光阻剂,其中有一些会侵蚀EUV影像,但他乐观认为将会有创新解决方案出现。
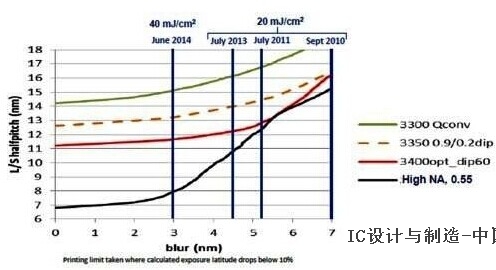
ASML正在测试各种EUV应用化学放大光阻剂
可控硅相关文章:可控硅工作原理




评论