日月光推出业界首创FOCoS扇出型封装技术
11月4日,日月光半导体宣布,日月光先进封装VIPack平台推出业界首创的FOCoS(Fan Out Chip on Substrate)扇出型封装技术,主要分为Chip First(FOCoS-CF))以及Chip Last(FOCoS-CL)两种解决方案,可以更有效提升高性能计算的性能。
本文引用地址:https://www.eepw.com.cn/article/202211/440084.htm日月光表示,随着芯片互连的高密度、高速和低延迟需求不断增长,FOCoS-CF和FOCoS-CL解决方案是更高层级的创新封装技术。FOCoS-CF和FOCoS-CL方案解决传统覆晶封装将系统单芯片(SoC)组装在基板上的局限性,将两个或多个芯片重组为扇出模组(fan out module),再置于基板上实现多芯片以及小芯片(Chiplet)的整合。封胶体分隔重布线层(Encapsulant-separated RDL)是一种Chip First技术,有助于解决传统重组晶圆制程技术中的芯片放置和设计规则的相关问题。
据悉,FOCoS-CF利用封胶体分隔重布线层改善芯片封装交互作用(Chip Package Interaction , CPI),在RDL制造阶段减低芯片应力上的风险以及提供更好的高频信号完整性。还可改善高阶芯片设计规则,通过减少焊垫间距提高到现有10倍的I/O密度,同时可整合不同节点和不同晶圆厂的芯片。
数据显示,FOCoS-CL对于整合高频宽存储(High Bandwidth Memory,HBM)特别有效益,这也是极其重要的技术领域,能够优化功率效率并节省空间。随着HPC、服务和网络市场对HBM 的需求持续增长,FOCoS-CL提供关键的性能和空间优势。



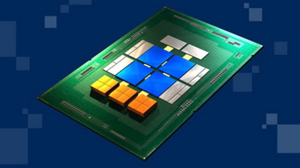
评论