3D封装TSV技术仍面临三个难题
高通(Qualcomm)先进工程部资深总监Matt Nowak日前指出,在使用高密度的硅穿孔(TSV)来实现芯片堆叠的量产以前,这项技术还必须再降低成本才能走入市场。他同时指出,业界对该技术价格和商业模式的争论,将成为这项技术未来发展的阻碍。
本文引用地址:https://www.eepw.com.cn/article/124296.htm“如果我们无法解决价格问题,那么TSV的发展道路将更加漫长,”Nowak说。他同时指出,在价格与成本之间仍然存在的极大障碍,加上新技术的不确定性所隐含的风险,以及实际的量产需求,形成了三个TSV技术所面临的难题。
部份业界人士认为,到2014年,智能手机用的移动应用处理器可能会采用TSV技术,成为率先应用TSV量产的产品。JEDEC正在拟订一个支持TSV的Wide I/O存储器介面,其目标是成为下一代采用层叠封装(PoP)的低功耗DDR3链接的继任技术。
“可提供12.8GB/s的LPDDR3主要针对下一代层叠封装元件应用,但Wide I/O也具有其市场潜力,”Nowak说,他同时负责高通的TSV技术部份。“技术上来说,Wide I/O可自2014年起进入应用,然而,价格和商业模式仍将是该技术发展的阻碍。”
TSV技术承诺将提升性能,同时也将降低功耗及缩小元件尺寸,以因应包括移动处理器在内的各种应用需求。
TSV的致命弱点仍然是它的成本,Nowak说。“Wide I/O DRAM的价格较现有的PoP配置高出许多,而PoP也不断改良,甚至未来有可能设法再开发出一个新世代的产品,”他表示。
Nowak指出,一个名为EMC-3D的业界组织最近表示,以目前用于量产的工具模型为基础来推估,TSV将使每片晶圆增加约120美元的成本。
目前该技术仍然缺乏明确的商业模式,而且定价问题也颇为复杂,Nowak说。例如,当晶圆厂制作完成,以及在完成封装后,哪个环节该为良率负责?
“一些公司可以扮演整合者的角色,但未来整个商业模式可能会有稍许改变,”他同时指出,目前业界已经初步形成了一些TSV供应链的伙伴关系。
动机和进展
高通已经设计出一款28nm TSV元件的原型。“我们针对这项技术进行了大量的开发工作,”Nowak说。
更广泛的说,TSV可协助半导体产业延续其每年降低30%晶体管成本的传统。Nowak也表示,在不使用TSV技术的情况下,由于超紫外光(EUV)延迟而不断上升的光刻成本,也对半导体产业维持光刻和进展的步伐提出严峻挑战。
好消息是工程师们在解决TSV堆叠所面临的挑战方面时有进展。“虽然挑战仍然很多,但至少目前我们已经建立了一些基础和所需的专有知识,”他表示。
他同时指出,台积电(TSMC)今年度在VLSI Symposium上报告已建构出一种更好的TSV介电质衬底(dielectric liner)。工程师展示了高度深宽比(aspect ratios)为10:1的试制过孔,并减轻了外部铜材料挤压过孔的问题。



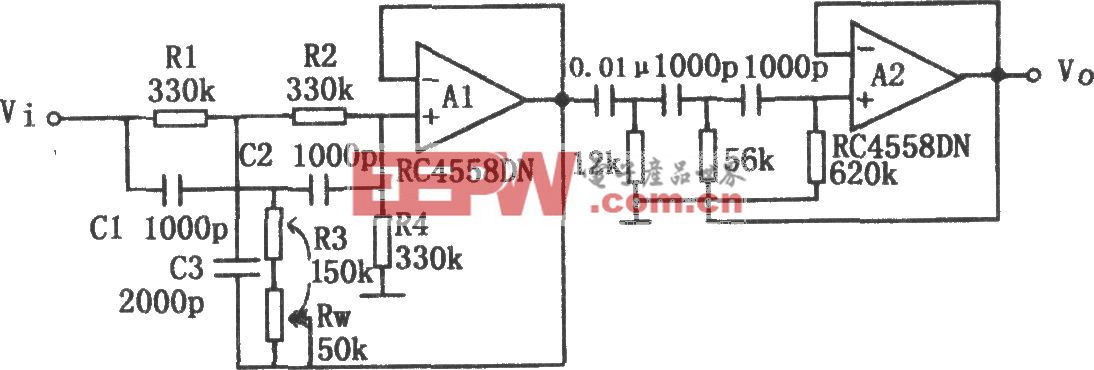




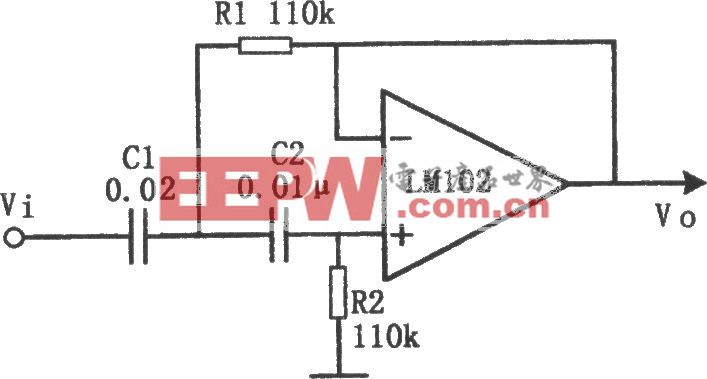
评论