Intel欲将193nm沉浸式光刻技术延用至11nm制程节点
在本月21日举办的LithoVision2010大会上,Intel公司公布了其未来几年的光刻技术发展计划,按这份惊人的计划显示,Intel计划将 193nm波长沉浸式光刻技术延用至11nm制程节点,这表明他们再次后延了其极紫外光刻(EUV)技术的启用日期。
本文引用地址:https://www.eepw.com.cn/article/106179.htm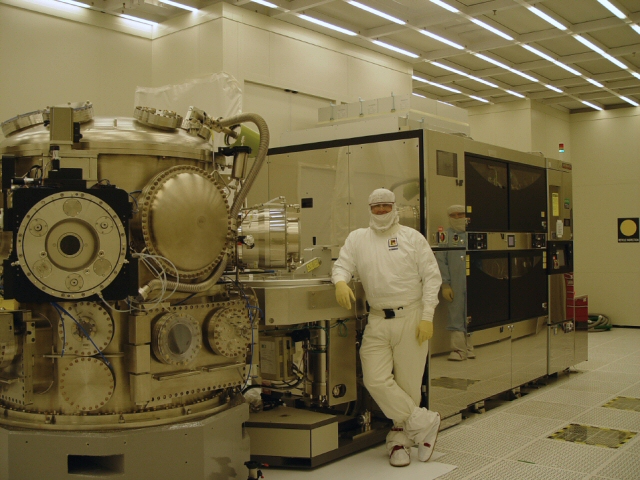
Intel实验室中的EUV曝光设备
根据会上Intel展示的光刻技术发展路线图显示,目前Intel 45nm制程工艺中使用的仍是193nm干式光刻技术,而32nm制程工艺则使用的是193nm沉浸式光刻技术,沉浸式光刻工具方面,Intel从去年开始便独家使用尼康公司的193nm沉浸式光刻机制造32nm制程产品。(此前曾有传言称台积电最近也购买了尼康公司的193nm沉浸式光刻设备,不过双方后来矢口否认了这一传言.)
过去Intel曾计划在22nm制程节点转向EUV技术,并计划明年开始采用这种技术。不过据Intel负责高级光刻技术的高管Yan Borodovsky表示,Intel目前还没有做好在22/15nm制程节点引入EUV技术的准备。他并表示Intel将在22nm制程节点继续使用193nm沉浸式光刻技术。
Intel还在会上表示他们有能力将193nm沉浸式光刻技术延用至15nm制程节点,也就是说这项技术的寿命可望延续到2013年左右,Borodovsky并认为,按照目前的情况看来,193nm沉浸式光刻+pitch division的工艺组合才是实现15nm制程产品量产的“唯一选择”。
不过他表示,在15nm节点制程处,Intel将“首先采用EUV技术进行试产,假如届时无掩模技术已经成熟,那么我们还会采用这种技术进行试产。”
在接下来的11nm制程节点中,Intel仍有计划想在五重掩模技术(five mask)的配合下继续延用193nm沉浸式光刻技术,Borodovsky称:“193nm沉浸式光刻技术应可在五重掩模技术的配合下满足11nm制程的要求。”
据Intel表示,11nm制程节点上该公司的光刻技术将采用多种光刻工艺互补混搭的策略,将193nm沉浸式光刻技术与EUV,无掩模光刻(maskless)等技术混合在一起来满足11nm制程的需求。
目前还不清楚Intel最终会采用EUV或无掩模光刻技术中的哪一种,Intel表示留给EUV技术最终成熟的时间点是在2011/2012年前;而留给无掩模技术的时间点则是在2012年以前。而其EUV领域的主要竞争对手三星公司将EUV技术投入实用的时间点也同样定在了2012年前。








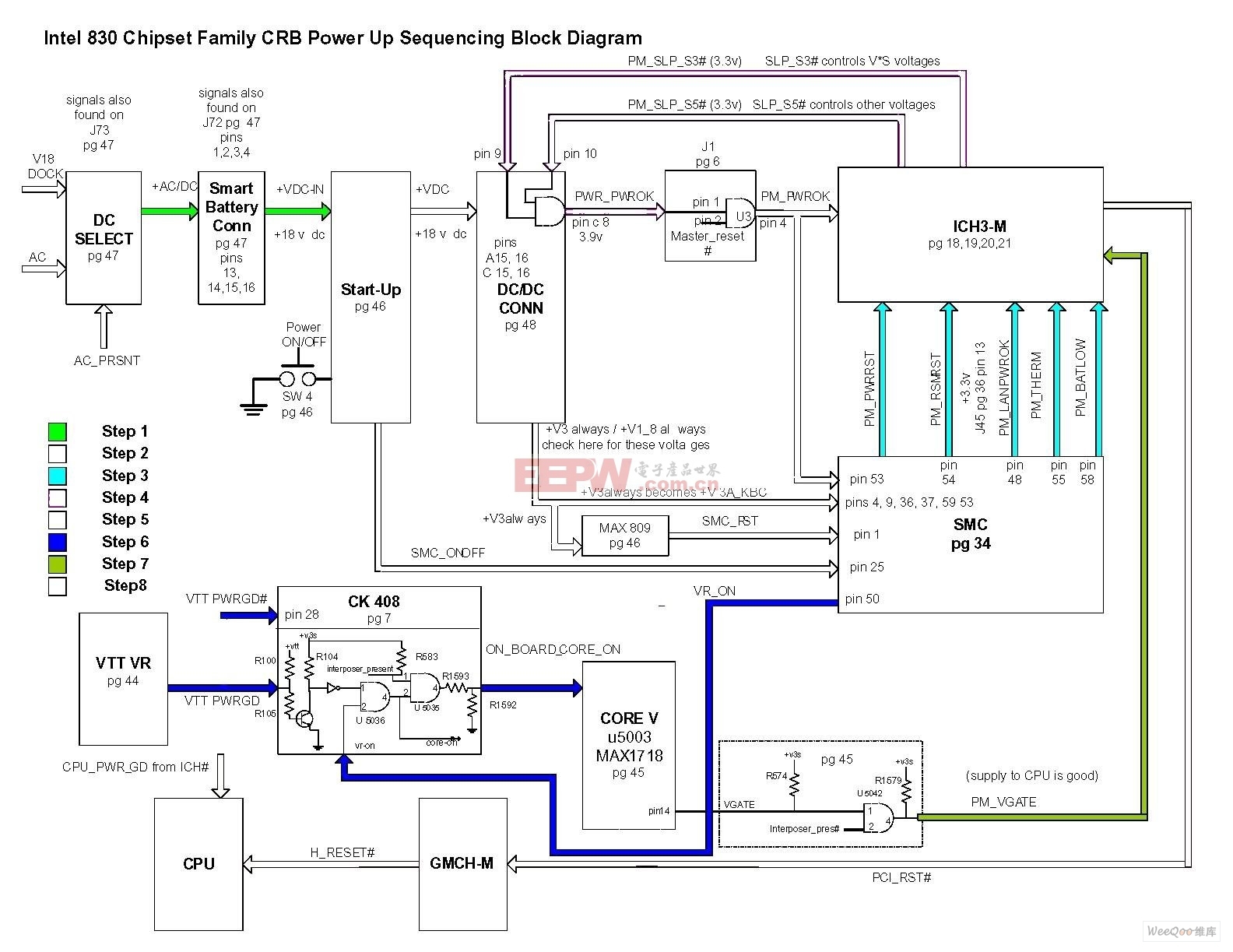






评论