KLA-TENCOR推出面向光刻设计检测方案
——
DesignScan 可对 post-RET 掩膜版设计进行在线检测,以发现光刻制程工艺窗口中的错误。通过与 LithoView 配合使用,具有的新功能可加强代工厂和无工厂芯片生产商之间的协作,DesignScan 能识别影响性能和成品率的图形,并将这些信息向上反馈到无工厂的设计机构。LithoView 允许无工厂设计机构能查看由 DesignScan 检测到的结果。DesignScan 可为晶片光刻制程工艺优化设计,为光刻制程工艺优化 post-RET 掩膜版版面,以及为设计优化光刻制程工艺,进而提高光刻制程工艺窗口的设计性能。
“由于掩膜版版面总是不断偏离设计目标,因此为生产而设计 (DFM) 显得非常重要,”KLA-Tencor 掩膜版和光掩膜检测事业部 (RAPID) 总经理 Harold Lehon 指出。“作为一家致力于成品率管理的公司,KLA-Tencor 始终专注于使半导体生产公司能更好地进行决策,并在半导体价值链的所有层次上提高成品率。通过 DesignScan 等方案,我们可以将我们的成品率知识和专业技术向上延伸到 post-RET 设计阶段。”
今天的光刻工艺要求对掩膜版版面采用极其复杂的 RET,例如 OPC 功能,以便获得成功的图形。在设计中加入 OPC 之后,必须通过检测以确保没有任何可能导致图形缺陷的设计错误,并确保能在掩膜版生产之前为给定工艺设计提供合理的光刻制程工艺窗口。尽早地检测到这些错误是非常关键的,因为在掩膜版生产之前发现的设计错误可能只需几天或一周就能加以纠正,但是如果等到在代工厂才检测到错误,则会导致数个月的时间延误。DesignScan 为检测和优化工艺窗口提供了最快的周转时间。
“由于新一代芯片的设计复杂性不断增加,系统性的成品率损失正在逐渐升高,”KLA-Tencor 负责光刻的副总裁 Chris Mack 认为,他也是 DesignScan 计划的最初负责经理。“成品率提高的最大可能存在于光刻部分,这是因为由于聚焦和曝光偏差,设计版面和 RET/OPC 已经无法继续优化。对芯片生产商而言,仅仅弄清最佳聚焦和曝光情况下的设计成品率是不够的。要获得最严格的参数化成品率分布,需要在整个光刻工艺窗口中进行设计检测。”
KLA-Tencor 现已开始接受 DesignScan 的订单。




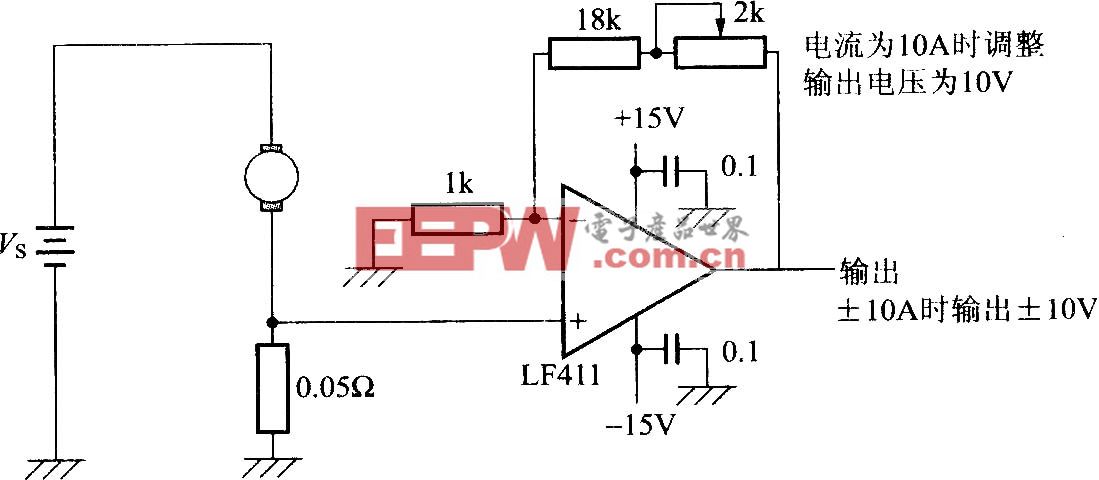




评论