3D封装TSV技术仍面临三个难题
—— TSV的发展道路或将更加漫长
Nowak还引用了一些背面晶圆加工、薄化晶圆的临时托盘开发情况,并展示了有时用于取代过孔的连接微凸块。EDA供应商也在架构工具和2D建构工具方面取得了进展。
本文引用地址:https://www.eepw.com.cn/article/124296.htm“你可以设计一个设备来使用这些工具,”他说。
然而,目前这些工具仍然缺乏有关机械应力、封装和芯片水准的交换数据标准。业界仍需为在TSV应用中“大幅减少”的静电放电水平容差定义标准,他说。
另外,业界也正在开发测试程序。“目前仍不清楚在量产时是否会使用到微探针(micro-probing)”他指出,重点是要削减成本,但“我们仍在增加测试步骤。”




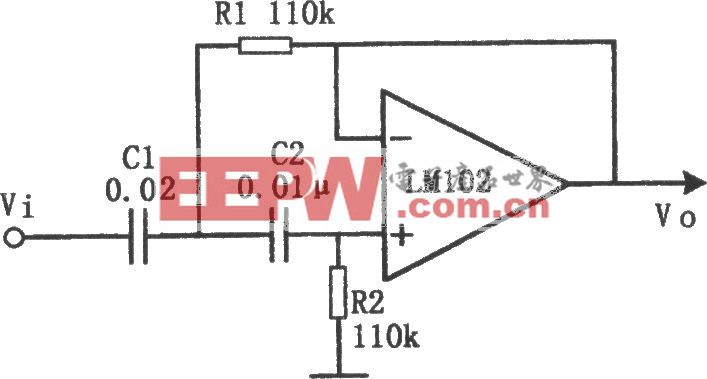
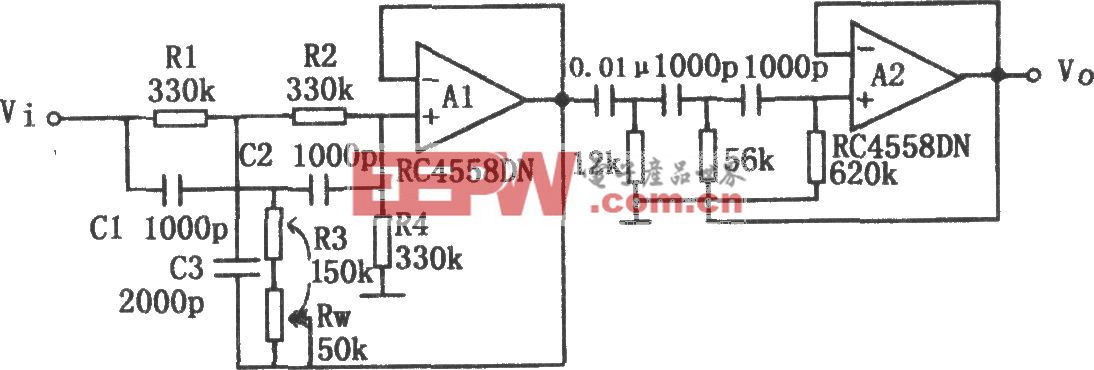



评论