半导体C-V测量基础
—— C-V测量为人们提供了有关器件和材料特征的大量信息
通用测试
本文引用地址:https://www.eepw.com.cn/article/96649.htm电容-电压(C-V)测试广泛用于测量半导体参数,尤其是MOSCAP和MOSFET结构。此外,利用C-V测量还可以对其他类型的半导体器件和工艺进行特征分析,包括双极结型晶体管(BJT)、JFET、III-V族化合物器件、光伏电池、MEMS器件、有机TFT显示器、光电二极管、碳纳米管(CNT)和多种其他半导体器件。
这类测量的基本特征非常适用于各种应用和培训。大学的研究实验室和半导体厂商利用这类测量评测新材料、新工艺、新器件和新电路。C-V测量对于产品和良率增强工程师也是极其重要的,他们负责提高工艺和器件的性能。可靠性工程师利用这类测量评估材料供货,监测工艺参数,分析失效机制。
采用一定的方法、仪器和软件,可以得到多种半导体器件和材料的参数。从评测外延生长的多晶开始,这些信息在整个生产链中都会用到,包括诸如平均掺杂浓度、掺杂分布和载流子寿命等参数。在圆片工艺中,C-V测量可用于分析栅氧厚度、栅氧电荷、游离子(杂质)和界面阱密度。在后续的工艺步骤中也会用到这类测量,例如光刻、刻蚀、清洗、电介质和多晶硅沉积、金属化等。当在圆片上完全制造出器件之后,在可靠性和基本器件测试过程中可以利用C-V测量对阈值电压和其他一些参数进行特征分析,对器件性能进行建模。
半导体电容的物理特性
MOSCAP结构是在半导体制造过程中形成的一种基本器件结构(如图1所示)。尽管这类器件可以用于真实电路中,但是人们通常将其作为一种测试结构集成在制造工艺中。由于这种结构比较简单而且制造过程容易控制,因此它们是评测底层工艺的一种方便的方法。
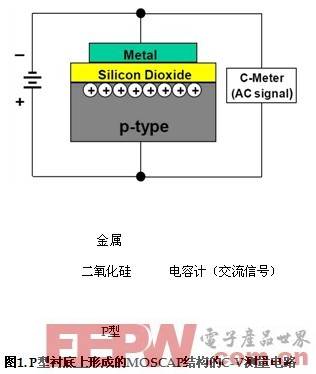

















评论