IGBT等功率器件:芯片更薄,封装散热更好,集成度更高
近日,三菱电机功率半导体制作所参加了上海2014年PCIM亚洲展,总工程师佐藤克己介绍了IGBT等功率器件的发展趋势。
本文引用地址:https://www.eepw.com.cn/article/256794.htmIGBT芯片发展进程
IGBT芯片始于19世纪80年代中期。30年以来,就FOM(优点指数)来说,今日的IGBT芯片比第一代性能提升了20倍左右,其中改良技术包括:精细化加工工艺、栅式IGBT的开发(如三菱电机的CSTBT),以及薄晶圆的开发等等。如今,三菱电机的IGBT芯片已经踏入第7代,正朝第8代迈进。
随着产品的更新换代,功耗越来越低,尺寸越来越小。从80年代中期至今,芯片尺寸只是原来的1/4。

根据IGBT电流容量和市场需求,功率器件分成四大类,包括用于家电变频器的小功率器件,用于工业的较大功率器件,应用在电动汽车的中功率器件,用于电力和牵引的大功率器件。今后都将朝高电流密度、小型化封装及低损耗方向演进。
具体改良措施
三菱电机第7代IGBT模块,功耗降低了约15%~20%,分NX(通用)系列和STD(标准)系列两种封装,取消了绝缘基板,提高了散热性,使产品变得更轻,效率提升了35%。为了降低反复开关造成的噪音,三菱电机增强了通过栅极电阻调节dv/dt的可控性。
● 晶圆片更薄。芯片变薄,使功耗得以降低,但变薄后耐压特性会变差,所以要适度逐层调整,才能使之更耐用和更有效。第7代IGBT芯片涵盖的电压等级有600V、1200V和1700V。 在晶圆尺寸方面,从2000年开始的5英寸,发展至今日的8英寸,最薄达到50微米。晶圆还会继续朝12英寸发展,产品变得更薄,电阻更低。
目前之所以8英寸晶圆是主流,除了晶圆尺寸外,还要考虑基板问题。现在还没有供应商能提供12英寸稳定高压IGBT使用的基板;反观8英寸单晶硅的硅板基板供货稳定,价格比12英寸低很多。
● 封装。功率器件的封装技术决定其散热性能。为了保护裸晶圆不受外界干扰,所有IGBT及IPM模块都要封装起来,甚至把功能集成起来,这样使用起来更方便及安全,也缩短客户产品开发周期。在最新一代的封装技术中,三菱电机采用了针型散热器,结合到铜基板或铝基板上,系统将更小型化。
● 应用。需要根据一些特殊应用调整产品。例如电动汽车IGBT与一般工业用的IGBT在技术工艺性能上的主要区别在生产工序,因为是车载产品,需要实现超高品质车载级模块。在IGBT加工工序的开始,每个生产工序都需要管理,对生产过程进行精细控制,产品出货时要有档案管理。如果有一个产品出问题,马上可以查到数据。目前,日系混合动力车基本上使用三菱电机的模块。
未来方向
*第8代IGBT。1200V第7代IGBT芯片100微米厚,但通过理论计算,要达到1200V耐压值,芯片厚度可以减少到80微米。第8代IGBT将朝芯片晶圆超薄化,并提升加工工艺的方向发展,不仅提升晶圆性能,同时达到降低损耗的效果。
*SiC/混合SiC。目前碳化硅(SiC)价格较高,适合高性价比的场合。对于一般的家用或低压变频器产品,就算是混合碳化硅的价格也没法接受。在研发混合碳化硅产品时,目标是价格不超过同等电流等级单晶硅产品的两倍。在生产中,由于碳化硅本身的基板上坏点比单晶硅多,成品率低,造成价格居高不下。估计至少5至8年碳化硅/混合碳化硅才能商品化。
三菱电机已开始引入混合碳化硅产品,即IGBT芯片用传统单晶硅,续流二极管用碳化硅,恢复特性特别好,开关频率越高,节能效果更好。例如,在30kHz开关的应用条件下,混合碳化硅产品的功耗可以降低50%,非常适合应用于医疗设备,如核磁共振和CT彩超等应用中。
可控硅相关文章:可控硅工作原理
比较器相关文章:比较器工作原理






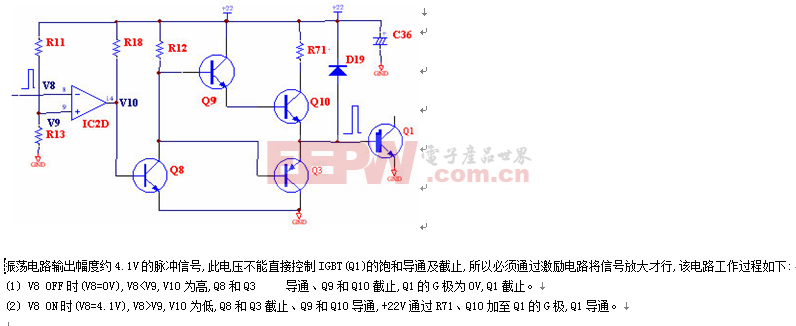



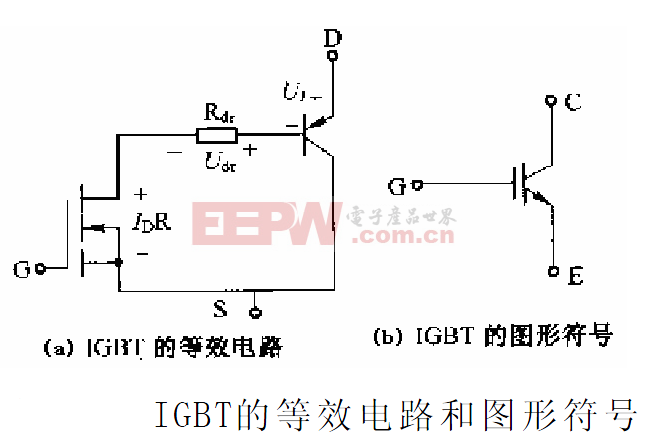
评论