用新型极紫外光刻胶材料推进半导体工艺
更快、更小、更高效的电子设备的需求不断增长,推动了半导体行业对创新的不懈追求。半导体制造的核心技术之一是极紫外光刻 (EUVL),它可以以更高的分辨率实现更小的特征尺寸,从而实现器件的小型化。全球的研究人员和公司正在专注于开发新型极紫外 (EUV) 光刻胶材料,以支持纳米级分辨率的 EUVL 图案化并提高半导体器件的性能。
本文引用地址:https://www.eepw.com.cn/article/202310/451172.htm光刻是半导体制造中的关键步骤,其中图案被转移到晶圆上以创建集成电路和其他微结构。传统光刻依赖于深紫外光,但随着集成电路达到个位数纳米尺度,EUV 光刻变得势在必行。EUV 光的工作波长约为 13.5 纳米,能够以高精度打印更小的特征。EUV 光刻胶是半导体制造工艺中使用的光敏材料,特别是先进的光刻技术。这些材料必须能够承受高能 EUV 光子并提供高分辨率图案化能力。开发 EUV 光刻胶材料的一些挑战是它们需要对短波长高度敏感。
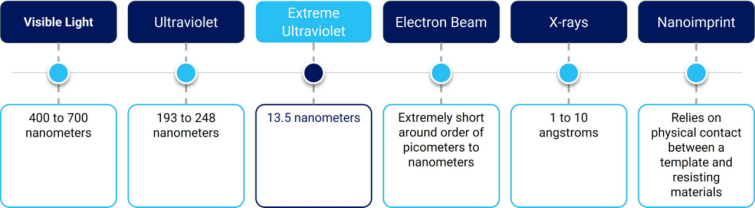
这些创新材料通常根据其配方或成分分为化学放大光刻胶 (CAR)、非化学放大光刻胶、无机 EUV 光刻胶和混合 EUV 光刻胶。当暴露在 EUV 光下时,它们会发生化学或物理变化,从而能够将图案准确转移到表面上。
了解极紫外光刻胶材料
EUV 光刻胶材料是光敏物质,当暴露于高能 EUV 光子时会发生化学变化。EUV 光子从光敏化合物产生光酸。这种酸催化抗蚀剂聚合物中的脱保护反应,使其更易溶于显影剂溶液。放大的反应提高了灵敏度并实现高分辨率图案化。随着半导体节点的尺寸越来越小,保持分辨率、灵敏度和图案保真度变得更加复杂和具有挑战性。目前正在进行研究开发新材料、机制和加工技术,以应对这些挑战并实现进一步的小型化。
极紫外光刻胶材料种类

化学放大光刻胶:化学放大光刻胶是最常用的 EUV 光刻胶。他们采用光致产酸剂 (PAG),在暴露于 EUV 光子时产生酸。这种酸会催化抗蚀剂中的化学反应,导致曝光区域在显影过程中溶解。CAR 以其高灵敏度而闻名,使其适合低剂量 EUV 曝光并提高半导体制造过程中的产量。它们可能会在光学设备、显示器和先进封装中找到应用。
无机 EUV 光刻胶:具有不同 EUV 吸收系数和高蚀刻能力的无机光刻胶材料对于解决一些现有问题具有重要意义。因此,许多研究人员开始研究无机材料在光刻胶领域的使用。这些材料与有机 CAR 不同,因为它们由无机材料组成,例如金属氧化物或含金属化合物。他们的工作原理是将丙烯酸作为有机配体的金属氧化物系统应用于 EUV 光刻。与有机光刻胶相比,无机光刻胶有望提供更高的热稳定性并减少释气。他们可能会在极端环境或专门的半导体工艺中找到应用。
非化学放大光刻胶:与 CAR 不同,非化学放大光刻胶不依赖于酸催化反应。相反,它们在 EUV 曝光后直接发生光解反应,导致溶解度发生变化。这些材料通常需要更高剂量的 EUV 光来进行图案化,并且正在针对特定应用和工艺要求进行探索。
混合 EUV 光刻胶:混合 EUV 光刻胶结合了有机和无机元素,充分利用了两种材料类型的优势。这些材料通过在配体交换反应后选择用于纯化步骤的树脂作为用叔胺、哌啶和二甲胺官能化的聚苯乙烯树脂来发挥作用。这些材料旨在提供增强的灵敏度、分辨率和热稳定性,解决纯有机或无机光刻胶的一些局限性。
极紫外光刻胶材料:过去 5 年发展趋势

EUV 光刻胶开发的主要挑战
EUV 灵敏度:灵敏度是 EUV 光刻的关键挑战之一;开发和优化能够有效吸收 EUV 光并与之反应以在半导体晶圆上产生精确图案的光刻胶材料非常困难。EUV 光子稀缺且昂贵,需要具有高灵敏度的光刻胶材料,以在制造过程中实现每小时 100 至 120 片晶圆的足够吞吐量。
分辨率和 LER:随着特征尺寸的减小,保持高分辨率而不产生过大的线边缘粗糙度 (LER) 就成为问题。EUV 光刻胶 LER 的一个重要潜在来源是由于高光子能量而产生的光子散粒噪声。LER 挑战涉及最大限度地减少形成晶体管特征的已开发光刻胶线边缘的不规则性或粗糙度。过多的 LER 会导致晶体管性能变化并降低芯片产量。制造商需要优化光刻胶配方和工艺条件,以实现 2 nm 的 LER,但灵敏度仅为 70 mJ/cm,并且晶体管特征的边缘更平滑、更精确。
脱气:EUV 光刻中的脱气问题是指在 EUV 光曝光期间从光刻胶中释放挥发性有机化合物 (VOC) 或其他材料。这些脱气材料可能会污染周围环境,包括 EUV 光刻设备中使用的光学器件。污染会降低设备性能和产量,同时增加维护要求。控制和最大限度地减少排气对于维持整个 EUV 光刻工艺的可靠性和效率至关重要。
热稳定性:EUV 曝光会产生大量热量,需要在高能条件下保持稳定的光刻胶材料。许多应用需要具有优异热稳定性的涂层。大多数市售去除剂在热负荷高达 130°C 后会迅速溶解抗蚀剂层。
新型 EUV 光刻胶材料的进步前景广阔
高灵敏度、低剂量材料:研究人员正在探索创新的化学放大光刻胶,即使在较低剂量下也能对 EUV 光子产生强烈反应,从而将吞吐量提高到每小时 100 片晶圆并降低制造成本。
改进的分辨率和 LER 控制:化学放大和无机抗蚀剂等新型材料旨在减轻 LER,同时保持高分辨率图案化能力。先进的化学原子抗蚀剂成分和独特的聚合物结构在实现更高的 EUV 光灵敏度、提高对比度以及将 LER 降低到 2nm 以下方面发挥着至关重要的作用。
减少释气:低释气光刻胶的开发可确保更清洁的 EUV 曝光,从而提高产量并提高半导体器件的可靠性。减少排气对于保持 EUV 光刻工艺的清洁度和完整性至关重要,因为 EUV 光刻工艺对污染物高度敏感。半导体制造商与材料供应商和设备制造商密切合作,确保 EUV 光刻工艺中使用的光刻胶和其他材料满足严格的除气要求,并有助于生产高质量的半导体器件。
热稳定性解决方案:为了解决 EUV 光刻的热挑战,研究人员正在开发具有增强热稳定性的工程材料,从而在不影响性能的情况下延长曝光时间。

合作与未来展望
开发和优化新型 EUV 光刻胶材料需要半导体制造商、材料供应商和研究机构之间的合作。半导体行业对下一代器件的追求依赖于 EUV 光刻技术的不断进步和完善。
新型 EUV 光刻胶材料的成功应用将为半导体技术带来无数的可能性。更小、更强大的设备将彻底改变各个领域,包括数据中心、医疗保健、汽车和人工智能。影响不仅限于传统计算,使半导体制造商能够生产具有更小特征尺寸的芯片。这使得电子设备的晶体管密度更高、性能更高、功耗更低。它还增强了半导体器件的功能,从而能够生产先进的处理器、存储器件和传感器,从而推动各个行业的技术创新。
结论
新型极紫外光刻胶材料是不断增强半导体技术的重要基石。在半导体晶圆上打印更小、更精确的特征的能力对于满足数字时代的需求至关重要。该领域的协作研发为半导体行业带来了光明的未来,确保电子设备的不断发展,为我们的生活赋能和丰富。
开发新型 EUV 光刻胶材料需要材料科学家、化学家、物理学家和工程师之间的合作。材料供应商、半导体制造商和研究机构携手合作,在严苛的 EUV 曝光条件下设计、表征和测试这些材料。
EUV 光刻和光刻胶开发领域正在不断发展。研究人员正在探索广泛的材料创新,包括无机抗蚀剂、纳米结构材料和混合聚合物。随着半导体行业追求更高水平的小型化和性能,对新型 EUV 光刻胶材料的追求仍然是一个活跃的研究和创新领域。




评论