关于芯片的计算机辅助设计热仿真平台搭建
0 引言
为了在芯片设计之初就对总体设计进行较好的热性能评估,借助于热建模和热仿真的工具软件,本文整合出了一套完整的芯片热仿真流程。
1 原理
1.1 软件原理
对芯片进行热建模和热仿真需要用到开源软件HotSpot[1]以及GEM5[2],McPAT[3]。其中3个软件之间的关系可以使用图1进行描述。
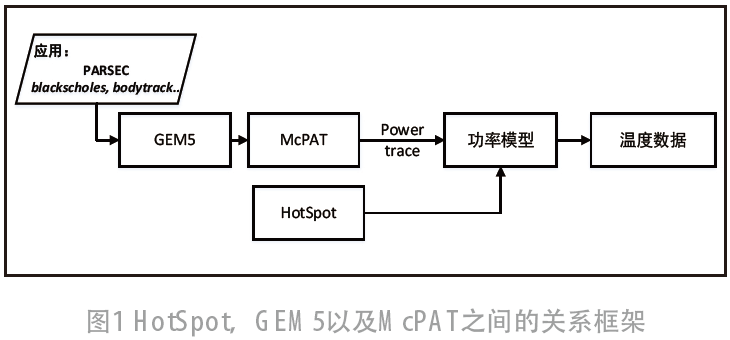
HotSpot是一种适用于计算机体系结构研究,精确而快速的热建模软件。它基于微架构模块和热封装对应的电阻和电容等效电路来进行仿真迭代求解。该工具基于有限元仿真的求解原理,可以得出设计芯片的体系结构模型。此模型可以对输入的power进行稳态和瞬态的热仿真,得出芯片某一时刻温度数据的输出。
GEM5是一款模块化的离散事件驱动全系统模拟器,可在模拟加载的系统镜像中运行应用程序,从而输出相对应的统计数据。
McPAT是1个功耗、面积和时序建模的框架,可以接在GEM5输出的统计数据后面计算出power的数值,作为模拟实际应用运行状态的功耗数据。
最后,McPAT输出的power数据作为功率数据输入到HotSpot生成的功率模型中,从而将3个工具有效地结合起来。整个流程可以有效地对芯片模型进行仿真,检测芯片体系结构的性能特性和热特性,并且可以给后续对芯片进行类似于Turbo Boost[4]等的热管理提供模型支持。
1.2 芯片架构
随着各种新材料和新技术的出现,芯片上晶体管数量的规模在近几十年不断增长。
为了获得更好性能,更多的芯片体系结构被提出来,但是随着芯片的性能不断被压榨出来。多核结构和三维结构在近些年被专家提了出来,然而现如今多核结构[5]和三维结构[6]在工业设计中仍然具有一定的难度,主要原因在于堆积结构造成了芯片难以解决的散热问题[7]。
常规的芯片结构包括封装和散热模块[8],如图2所示。
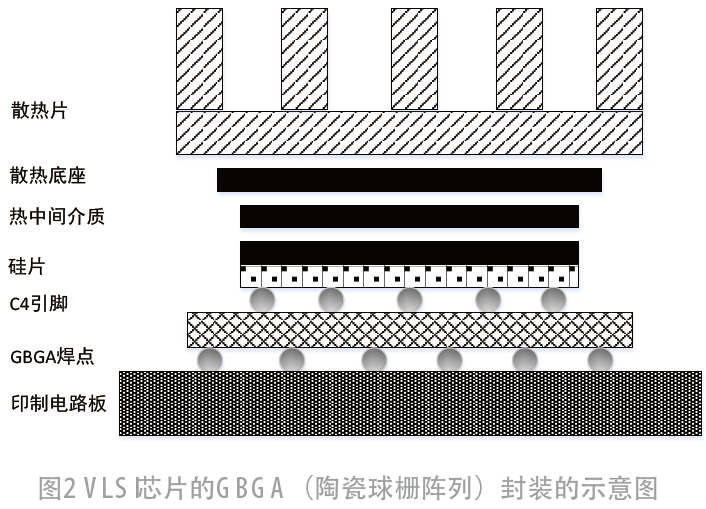
多核结构是硅片上的二维结构,三维芯片在结构上是多个二维结构的堆叠。如图3所示:
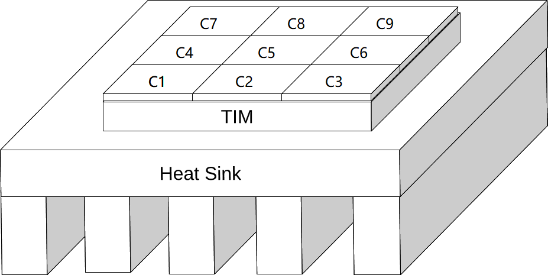
(a)
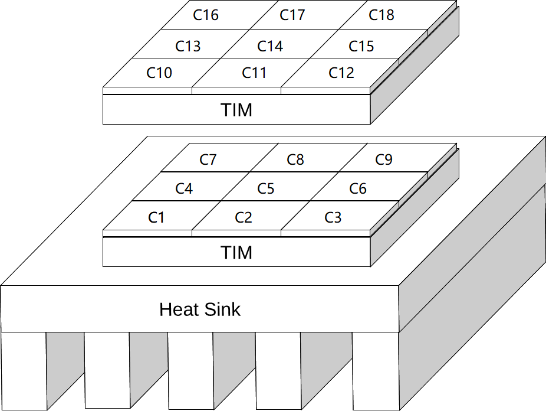
(b)
图3 二维的多核结构(a)和三维的多核结构(b)
2 方法
2.1 HotSpot热建模
在第二部分芯片结构的介绍中,对于2种芯片结构都需要使用HotSpot进行热建模。HotSpot可以将芯片抽象成网格的模型,并且得出每个格点之间的关系(包括热阻和热容)。
接下来芯片热模型就转换成了电路网络,在这个网络中,功率被看作电流,温度被视作电压。因此输入功耗求解芯片相应温度就成为了简单的矩阵求解电路问题。
在HotSpot中,编译完成之后需要关注修改几个文件,完成对芯片的描述,详见表1。

其中,core.flp定义了需要进行模拟仿真的芯片结构,这里使用坐标和宽高定义芯片中的每个模块。在三维芯片中,ic.lcf定义了二维芯片之间的堆叠关系,例如图3(b)是2层二维芯片的堆叠,并且使用TIM(热中间介质)进行隔绝。而core.ptrace是芯片的输入功耗,这个文件中的功耗数据是从GEM5和McPAT输出得来的。功耗数据可以按照固定的时间间隔输入,相应的时间间隔可以在hotspot.config中进行定义,最终通过HotSpot进行迭代计算芯片的瞬态温度数据。
2.2 GEM5和McPAT生成功率输入
G E M 5 可以模拟挂载系统镜像运行相应的Benchmark,从而输出模拟系统架构的运行统计数据。GEM5支持包括Alpha、ARM和X86在内的多种系统体系结构,并且支持多个线程和多核的设置,因此在仿真二维多核结构和三维多核的芯片中是非常有效的。在输出统计数据之后,为了根据数据计算出芯片的面积和功耗,此时使用脚本文件将统计数据映射到对应McPAT中进行计算,最终可以输出对应体系结构每个模块的功耗数据(功耗数据是按照应用运行的时间顺序输出的)。功耗数据输入到HotSpot建立的热模型中,从而完成仿真得到温度数据。
2.3 计算温度数据
将GEM5和McPAT输出的功耗数据加入core.ptrace中作为输入功耗,再根据实际中需要仿真芯片的参数,修改HotSpot中的配置文件,接下来在终端中执行仿真代码,在HotSpot完成仿真之后,就可以在core.ttrace的文件中读取瞬态仿真结果。
3 实验结果
考虑到当前芯片的前沿课题,本文对二维多核芯片结构和三维芯片结构进行了热建模和热仿真。仿真平台的搭建方法使用了前述几章涉及的内容,输入的应用程序是从PARSEC[9]提取出来的Benchmark。仿真时间间隔是0.000 1 s。实验结果包括二维和三维芯片的温度分布展示图,以及二维和三维芯片的仿真温度曲线。
3.1 二维多核结构
在二维结构中,每个核输入相应的功耗,此时使用HotSpot可以仿真出每个核心的温度变化曲线,如图4(a)所示。并且展示出瞬态温度曲线第三秒时刻的整个芯片温度分布图,如图4(b)所示。
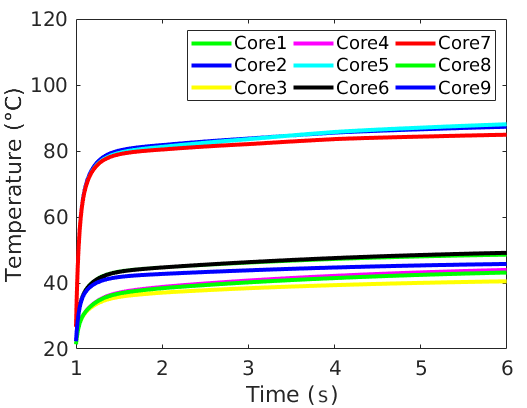
(a)二维多核结构的瞬态温度曲线
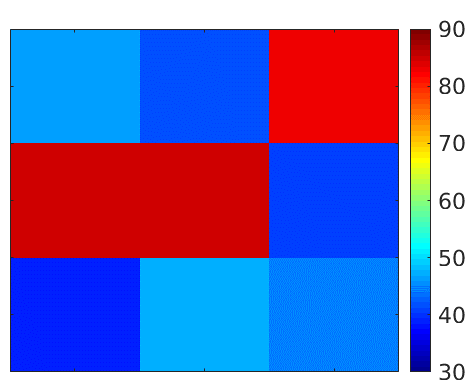
(b)二维多核结构(3 s)时刻的芯片温度分布图
图4 二维多核结构的输出结果
3.2 三维多核结构
同样地,在三维多核结构中,每个核输入功耗后,使用HotSpot可以仿真出每个核心的温度变化曲线,如图5(a)所示。并且展示出瞬态温度曲线第3 s时刻的整个芯片温度分布图,如图5(b)所示。
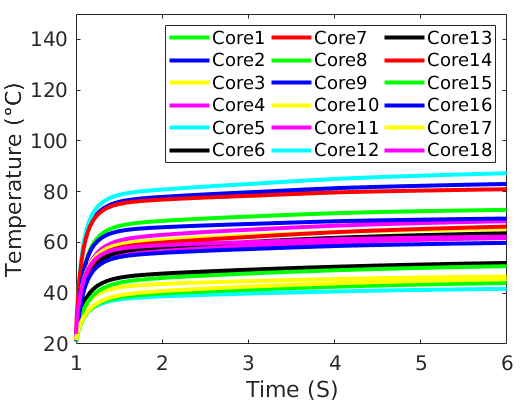
(a)三维多核结构的瞬态温度曲线
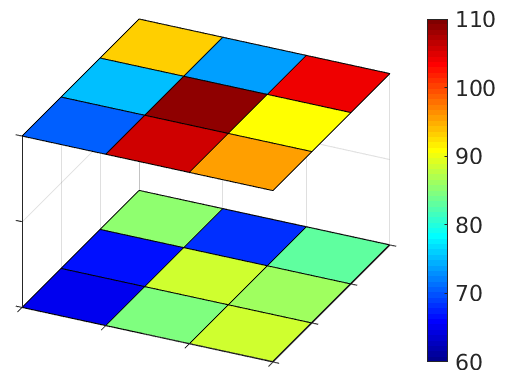
(b)三维多核结构(3 s)时刻的芯片温度分布图
图5 二维多核结构的输出结果
从实验结果中可以得出,使用本文的仿真平台可以对二维多核结构芯片和三维多核结构芯片进行有效的热仿真,通过瞬态温度数据和任意时刻的温度分布的结果,研究人员可以在设计初期对热模块的位置进行合理规划,以及在后期芯片中加入适宜的管理程序从而有效的提升系统性能和减少热风险。
4 结语
随着芯片发展到多核芯片和三维结构芯片,芯片中的热问题变得越来越严重,因此在设计初期,借助计算机辅助设计进行热仿真,可以有效地避免最终电路的设计失败。本文完整搭建了芯片的计算机辅助设计热仿真平台,并且使用该平台完成了对二维多核芯片和三维多核芯片的热建模和热仿真。本文建立的热仿真流程,可以通过调整芯片的设计布局从而降低芯片工作时的整体平均温度,从而有效地解决芯片中热密度过大的问题,并且可以通过模型热管理来最大化系统性能。文中的热仿真平台上在指导未来芯片设计和芯片热管理研究工作中具有重要的意义。
参考文献:
[1] HUANG W,GHOSH S,VELUSAMY S,et al.HotSpot: A compact thermal modeling methodology for early-stage VLSI design[J].IEEE Transactions on very large scale integration (VLSI) systems,2006,14(5):501-513.
[2] QURESHI Y M,SIMON W A,ZAPATER M,et al.Gem5-X: A Gem5-based system level simulation framework to optimize many-core platforms[C].2019 Spring Simulation Conference (SpringSim),IEEE,2019:1-12.
[ 3 ] D U E N H A L , M A D A L O Z Z O G , M O R A E S F G , e t al.Exploiting performance, dynamic power and energy scaling in full‐system simulators[J].Concurrency and Computation: Practice and Experience,2017,29(22):e4034.
[ 4 ] ACUN B , M I L L E R P , K A L E L V . V a r i a t i o n a m o n g p r o c e s s o r s u n d e r t u r b o b o o s t i n h p c s y s t e m s [C] .Proceedings of the 2016 International Conference on Supercomputing,2016:1-12.
[5] ETIEMBLE D.45-year CPU evolution: one law and two equations[J].arXiv preprint arXiv:1803.00254,2018.
[ 6 ] Z H A N G D K , H U A N G C , SON G G Z . S u r v e y o n t h r e e - d i m e n s i o n a l n e t w o r k - o n - c h i p [ J ] . J o u r n a l o f Software,2016,27(1): 155-187.
[7] CAO K,ZHOU J,WEI T,et al.A survey of optimization techniques for thermal-aware 3D processors[J].Journal of Systems Architecture,2019,97:397-415.
[8] 张明.众核芯片热建模与功耗管理技术研究[D].成都:电子科技大学,2016.
[9] BIENIA C,LI K.Benchmarking modern multiprocessors[M].Princeton,NJ:Princeton University, 2011.
(本文来源于《电子产品世界》杂志2020年9月期)













评论