IC封装供不应求,这四大因素都能要了封测厂的命?
IC需求的意外爆发正在波及半导体封测供应链。
本文引用地址:https://www.eepw.com.cn/article/201712/373051.htm对芯片需求的不断上升正在冲击IC封装供应链,导致某些类型的封装、制造能力、引线框和一些设备的短缺。
IC封装供不应求的局面今年早些时候就开始出现了,自那时起,问题愈演愈烈,到了第三季度和第四季度,供求严重失衡,现在看来,这种局面将持续到2018年。
出现这种局面有若干原因,最主要原因在于IC需求意外爆发,因此客户需要更多的IC封装产能,但是,IC封装工厂已经满负荷运转,无法满足多种封装类型的需求。

除了IC封装之外,电子板块的其它产品品类也在这次所谓的“繁荣或超级周期”中面临供应短缺局面。全球最大的半导体封装与测试(OSAT)巨头先进半导体工程公司(ASE)首席运营官Tien Wu表示:“这次究竟是一次超级周期,还是我们之前从未见过的内在扩展?在这个超级周期中,供应不足的情况不绝于耳,包括存储、OLED、被动元件等等。甚至在贴片机等半导体设备方面也存在交付时间拉长的问题。之所以出现这种情形,一方面是由于产能供应有限,另一反面是需求将在很长的一段时间内维持强劲。”
大多数元件出现缺货的原因显而易见。比如OLED,苹果和三星两家智能手机巨头几乎吞噬了OLED屏幕的所有产能。尽管需求不断上升,DRAM供应商却一直不愿增加产能,导致DRAM成为今年涨价的急先锋。NAND产品则是由于供应商生产工艺正从平面型NAND向3D NAND转型,良率问题导致供应不足。
相比之下,集成电路封装的问题更为复杂,而且涉及多个产品市场。
集成电路封装行业的工厂利用率很高,但全球200毫米晶圆bumping制程的产能存在严重短缺。在晶圆bumping工艺中,焊球或铜柱在晶圆上形成,在晶粒与基板之间提供电互连。
200mm晶圆bumping产能不足影响了智能手机芯片级封装(CSP)和射频前端模块等产品的供应。
而且,由于其他原因,四扁平无引脚(QFN)封装和晶圆级封装需求量大增,导致供应紧张。
对QFN的需求导致引线框(leadframes)的交付时间更长,引线框是用于QFN封装类型的关键组件。而且,封装设备需求也比预期的要强。
当然,并不是所有封装类型都供不应求。但是总体来说,整个2017年半导体封测的需求一直很强劲,并且将一直持续到2018年。TechSearch International总裁Jan Vardaman表示:”每家封测工厂都处于满产状态,这段时期是封测工厂产能利用率最高的一段时间。”
不消说,供不应求会影响向客户的交付时间。 “这也会影响那些试图向市场推出新产品的公司,如果他们的供应受到限制,可能会损害他们的收入,”Vardaman说: “现在最大的问题是,供不应求的局面会持续多久?我想,谁都无法给出正确的答案。”
这些趋势令客户担忧。提供IC封装和测试服务的封测厂正面临巨大压力。这些封测厂多年来资本不足,大多数供应商没有足够的资源来满足苛刻的客户群的各种需求。
本文主要研究了IC封装行业面临的主要短缺问题,如bumping产能、封装类型、引线框和设备等。
Bumping产能
2017年突然出现的繁荣周期让整个业界大吃一惊。比如,2016年年末,世界半导体贸易统计组织(WSTS)预测,2017年集成电路行业规模将比2016年温和增长3%。但是,这一年来,随着DRAM和3D NAND销售额的激增,WSTS已经多次上调IC市场销售的预测。根据最新的预测,该组织预计2017年半导体市场规模将达到4090亿美元,同比2016年大幅度增长20.6%,2018年,IC市场将继续将增长7%。
IC封装供应链的情况反映了芯片行业的需求前景。在这次超级周期中,封测厂们在2017年上半年目睹了传统的增长模式。
但是到了第三季度和第四季度,若干个板块的需求开始超预期增长。 STATS ChipPAC公司产品和技术营销副总裁Vinayak Pandey说:“当然,智能手机的需求一直都在。除了移动设备,汽车和网络的需求超出了我们的预期。”
需求大增导致封测厂商订单的激增。目前,封测厂商的工厂利用率平均都在80%以上,当然有很多类型的封测产能正在满负荷运转。 “封测厂商正在全负荷运转,”Pandey说。“如果有任何额外的需求,交货时间就会越来越长。”
产能的紧张表现在好几个方面,其中,最大的瓶颈是一种被称为晶圆bumping的成熟制造工艺,尤其是在200mm晶圆上。目前,Amkor、ASE、STATS ChipPAC等公司都提供晶圆bumping服务。
作为交钥匙服务的一部分,晶圆bumping直接在200mm或300mm晶圆上进行。bumping本身不是一种封装类型,它是一种在晶圆上形成微小的焊球或铜柱的制造工艺。
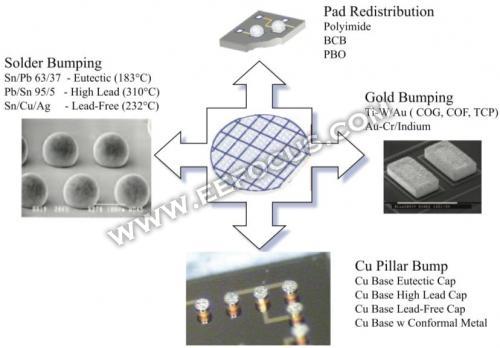
图1. 通用bumping技术
通过bumping,封测厂商可以开发出各种封装类型,比如CSP、扇出和Flip-chip BGA。CSP、扇入式和扇出式都属于晶圆级封装(WLP)。WLP是当IC还在晶圆上时就对其进行封装的一种工艺。
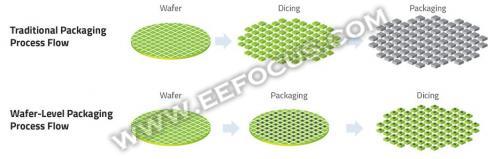
图2. 传统封装与晶圆级封装的流程对比
Flip-chip是一种互连方案,而不是一种封装类型。它广泛应用在应用处理器、图形芯片和微处理器中。
在Flip-chip中,在硅片上形成微小的凸块或铜柱。然后,将器件翻转并安装在一个单独的硅片或电路板上。硅片或电路板包括一些铜焊盘。 凸块或铜柱落在焊盘上,形成电气连接。
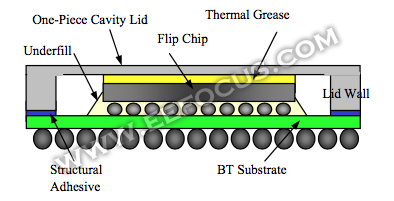
图3. Flip-Chip BGA封装
目前,OSAT厂商已经具备了充足的300mm bumping产能,但是令人惊讶的是,市场上200mm bumping的成熟产能严重短缺。











评论