苹果A10之后 高通海思开始导入FOWLP封装
台积电推出整合扇出型晶圆级封装(InFO WLP)今年第二季开始量产,成功为苹果打造应用在iPhone 7的A10处理器。看好未来高阶手机晶片采用扇出型晶圆级封装(Fan-Out WLP,FOWLP)将成主流趋势,封测大厂日月光经过多年研发布局,年底前可望开始量产,并成功夺下高通、海思大单。
本文引用地址:https://www.eepw.com.cn/article/201610/311676.htm台积电成功跨入InFO WLP高阶封装市场,虽然现在只有苹果一家客户进入量产,但已确立功能强大且高接脚数的手机晶片或应用处理器,未来将转向采用FOWLP封装技术的发展趋势。
台积电InFO WLP第二季进入量产,第三季开始出货,第四季可望挹注逾1亿美元营收,且明年中可望完成10奈米晶片InFO WLP封装产能认证并进入量产。
苹果A10应用处理器采用台积电16奈米制程及InFO WLP封装技术,打造史上最薄的处理器晶片,自然带动其它手机晶片厂纷纷跟进。相较于传统手机晶片采用的封装内搭封装(PoP)制程,FOWLP的确可以有效降低成本,但考量台积电InFO WLP价格太高,包括高通、联发科、海思等手机晶片厂找上了封测代工龙头日月光,合作开发更具成本优势的FOWLP技术。
日月光2014年起跟随台积电脚步投入FOWLP封装技术研发,原本采用面板级(Panel Level)扇出型技术,但今年已转向晶圆级(Wafer Level)技术发展,并在下半年完成研发并导入试产。据了解,日月光已建置2万片月产能的FOWLP封装生产线,并成功拿下高通及海思大单,成为继台积电之后、全球第二家可以为客户量产FOWLP封装的半导体代工厂。
日月光不评论单一客户接单情况,但表示FOWLP封装的确是未来一大主流。日月光营运长吴田玉日前提及,日月光今年在系统级封装(SiP)及FOWLP的投资项目很多,主要是客户对这方面技术要求积极,预期今年相关业务就会有新成就。
台积电已开始在中科厂区建立新的InFO WLP产能,但共同执行长刘德音日前参加台湾半导体协会年会时表示,台积电真正想做的是3D IC的整合,还是要靠台湾半导体产业链共相盛举。对此,日月光认为,未来FOWLP市场上,与台积电的合作会大于竞争,可望共同在台湾建立完整FOWLP生态系统,也可争取更多客户采用及释出代工订单。




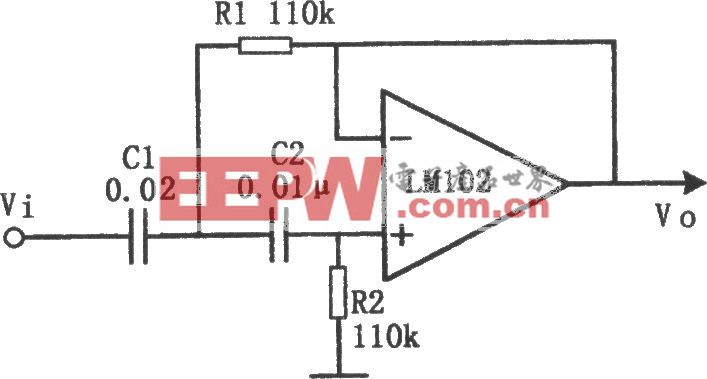



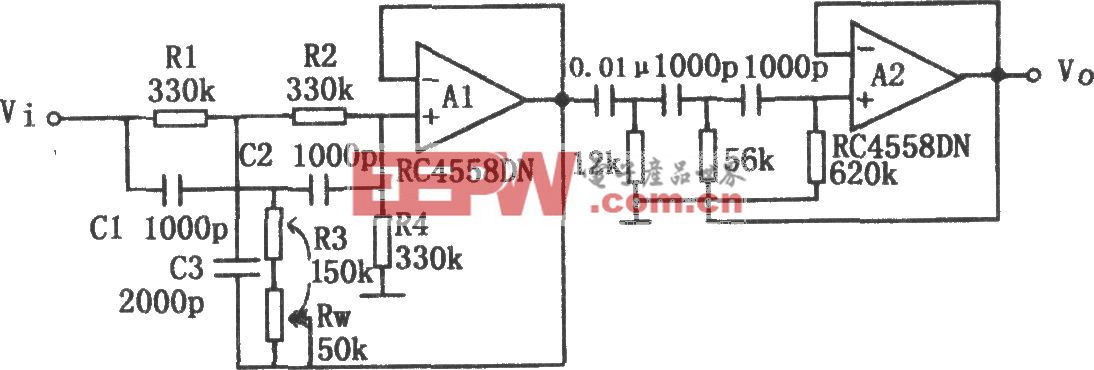
评论