争抢高通订单 封测厂力扩FOWLP封装产能
全球主要封测厂正积极扩充散出型晶圆级封装(Fanout WaferLevel Package,FOWLP)产能。为满足中低价智慧型手机市场日益严苛的成本要求,手机晶片大厂高通(Qualcomm)正积极导入更省材料、厚度更薄的新一代FOWLP封装技术,以进一步降低晶片制造成本,促使日月光、矽品等封测业者加紧扩大相关产线建置。
本文引用地址:https://www.eepw.com.cn/article/174357.htm工研院IEK系统IC与制程研究部/电子与系统研究组产业分析师陈玲君表示,平价高规智慧型手机兴起,促使应用处理器(AP)与基频处理器(BP)等关键零组件开发商戮力降低生产成本,以吸引原始设备制造商(OEM)青睐。其中,高通为抢食中低价智慧型手机市场,已要求封测厂商须尽快建置低成本封测产线,以提升其晶片价格竞争力。
陈玲君进一步指出,目前包括日月光、矽品、Amkor与STATSChipPAC等封装业者为争食高通庞大的订单,都已开始积极研发FOWLP技术。相较于现今常见的堆叠式封装层叠(PackageonPackage,PoP),FOWLP由于毋须使用载板材料,因此可节省近30%的封装成本,且封装厚度也更加轻薄,将有助于提升晶片商产品竞争力。
事实上,FOWLP封装技术的矽智财(IP)专利已被英飞凌(Infineon)所掌握,且此一技术已率先应用在该公司各式电源晶片产品线。不过,随着技术持续改良,未来FOWLP可望用于封装应用处理器与基频晶片等数位逻辑元件,遂成为各家专业封测代工厂争相竞逐的技术。
据了解,目前各家专业封测代工厂可透过自行改良FOWLP技术或者直接付IP授权金给英飞凌等两种方式取得相关技术;其中,日月光、矽品与Amkor仍在测试此一制程技术中,而STATSChipPAC则已选择与英飞凌直接进行技术合作。
值得注意的是,由于FOWLP技术可视为晶圆级封装的延伸,需要许多如沉积、曝光与布植等前端晶圆级设备,因此建置一条FOWLP封装产线将动辄新台币10几亿元,对封装测试厂而言是相当钜额的投资,若晶片客户本身的出货量不够大,则此一技术经济效益恐将无法彰显。
陈玲君分析,现今高通已是全球最大的行动装置晶片供应商,因此确实有能力要求封测厂投入此一技术研发,并藉此慢慢汰除成本较高的PoP制程技术,以最低的封装测试成本提升该公司解决方案竞争力,进而大举抢占中低价智慧型手机市场。
然而,FOWLP封装产线何时能开始量产数位逻辑晶片,仍须观察日月光与矽品等业者研发进度。陈玲君认为,封装业者目前正在努力精进FOWLP制程在打线、植球与重分布层(RDL)等技术,以因应数位逻辑晶片大面积与多脚位的挑战,预估2014年可望开始量产。
高通滤波器相关文章:高通滤波器原理


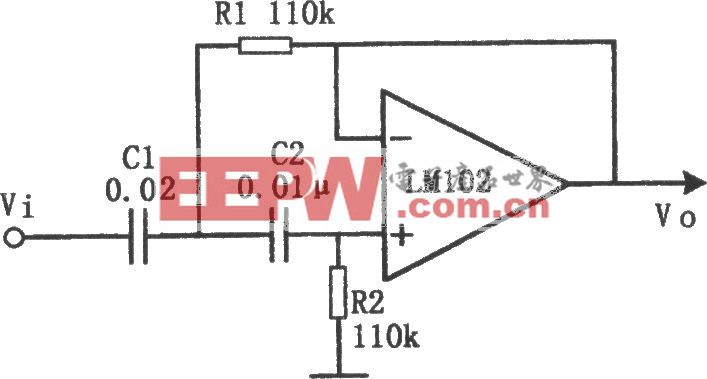


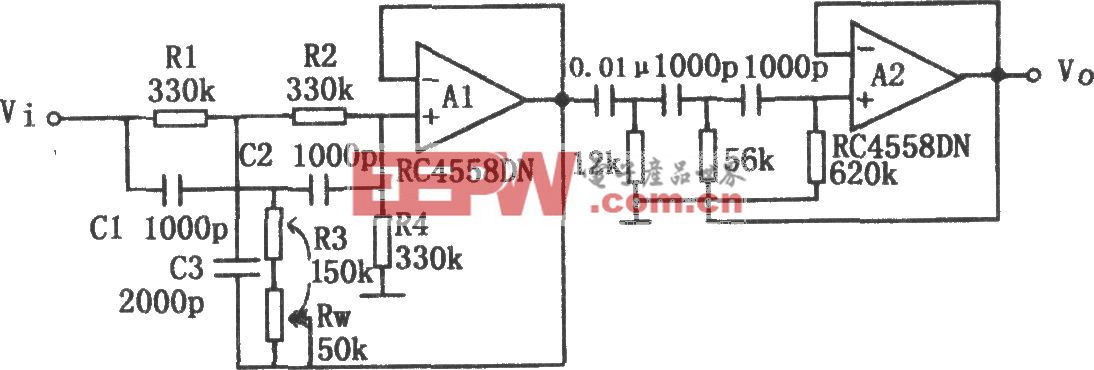


评论