IC封装供不应求,这四大因素都能要了封测厂的命?
这个短缺有几个原因。 一段时间以来,集成电路产业对200mm晶圆的芯片需求巨大,导致200mm晶圆厂产能严重短缺。
200mm晶圆业务的爆发拖累了整个供应链,当然也影响了OSAT。但200mm bumping产能不足主要是由于模拟和射频器件的巨大需求。Amkor公司bump业务高级副总裁Kevin Engel表示:“RF前端模块需要更多的凸块以及越来越多产品从其他封装类型迁移到WLCSP导致了对200mm晶圆bumping产能的激增。”
实际上,200mm bumping产能的短缺已经导致了CSP和RF前端模块的供应短缺。射频前端模块由手机中使用的关键射频元件组成。

图4. 标准CSP
模拟/射频芯片制造商正在争夺200mm晶圆bumping产能。以前,这些供应商选择了一种使用了被称为球滴的传统技术的封装类型,这种工艺是在芯片的I/O上形成焊球,焊球的尺寸大小为从150μm到200μm。
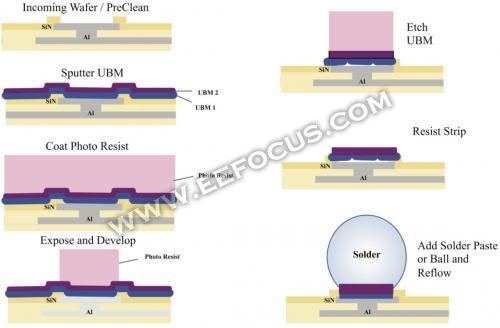
图5. 球滴工艺
“当你缩小管脚时,你需要同步缩减焊球的大小。焊球的尺寸有一定限制,“STATS ChipPAC的Pandey说。“所以模拟芯片供应商都想缩小封装,并把更多I/O集成在器件上。突然之间,他们再也不能用焊球了,他们需要一个更小的凸块。。”
结果,许多模拟/射频芯片制造商都从球滴技术转移到电镀bumping工艺上,这样可以形成更小的管脚,但是需要更多的工艺步骤,比如电镀。Pandey说:“工艺转换带来的挑战在于,球滴工艺是一个相当快的过程,但电镀工艺却比较耗时。所以就对产能产生了挑战。”
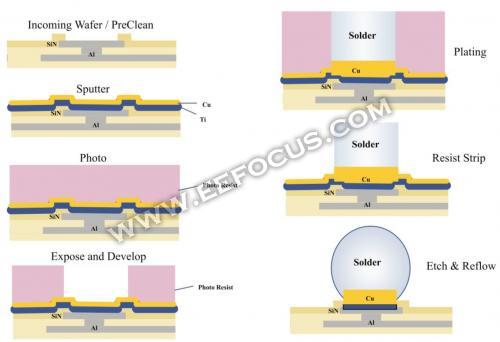
图6. 电镀凸点工艺
未来一段时间内,200mm晶圆bumping的产能预计仍将供不应求。过去,OSAT厂商一直不愿增加200mm bumping的产能,但是现在,有些厂商正在改变方向,并计划在2018年增加更多产能。
在2019年,模拟/射频芯片制造商可能会从电镀凸块迁移到铜柱凸块。今天许多数字芯片也在使用铜柱凸块,这意味着未来这种技术可能会面临疯狂的争夺。
某些封装类型供不应求
如上所述,当前市场上的CSP和RF模块供应紧张。其它封装类型的需求也很高。TechSearch的Vardaman表示:“晶圆级封装的强劲增长仍在持续,我们还看到系统级封装的增长,以及汽车IC封装的增长。”
扇入和扇出型等WLP封装的需求非常强劲。 Amkor公司的Engel说:“晶圆级封装与bumping的情况类似。 行业内200mm和300mm的整体产能紧张。目前稍有缓和,但供求关系失衡将在2018年达到顶峰,到时挑战性会更大。”
大部分需求都集中在传统扇出封装,即嵌入式晶圆级BGA(eWLB)上。 新一代高密度扇出型封装的需求也在不断攀升中。目前,台积电的扇出型封装技术已经被苹果采用。日月光、Amkor、STATS ChipPAC等公司也正在推出新一代扇出工艺。
令人惊讶的是,QFN-一种较旧但可靠的封装类型-需求也很火爆。分析师认为,英飞凌、恩智浦、Microchip、Silicon Labs、意法半导体和TI是推动QFN需求的主要动力。
QFN和四方扁平封装(QFP)属于引线框封装类型。引线框是由封装引线和外框的金属框架。硅片被绑定在框架上,引线通过细线连接到管脚上。
STATS ChipPAC公司的Pandey表示:“QFN是目前最便宜的封装类型,QFN虽然便宜,但它仍然允许你做一些布线工作。”

图7. QFN封装
QFN的驱动力主要来自两个市场 - 汽车和物联网(IoT)。 他说:“我们现在开始发现,QFN正在逐渐走向供需失衡,QFN的需求无处不在。”
更加雪上加霜的是,三星在最新的智能手机上大量采用了QFN封装。此外,三星智能手机更多采用了WLP封装,但是由于上一代智能手机出现了各种各样的问题,三星决定选择更加可靠稳定的QFN取代WLP封装,以保证手机的可靠性。








评论