三星宣布新一代封装技术I-Cube4已完成开发,将面向高性能应用领域
三星宣布,其下一代2.5D封装技术Interposer-Cube4(I-Cube4)已完成开发,将再次引领了芯片封装技术的发展。三星的I-CubeTM是一种异构集成技术,可将一个或多个逻辑管芯(Logic Chip)和多个高带宽内存芯片(HBM,High Bandwidth Memory)使用硅中介层,从而使多个芯片排列封装在一个芯片里。I-Cube4是I-Cube2的继任者,从高性能计算(HPC)到AI、5G、云和大型数据中心等地方,有望带来更高效率。
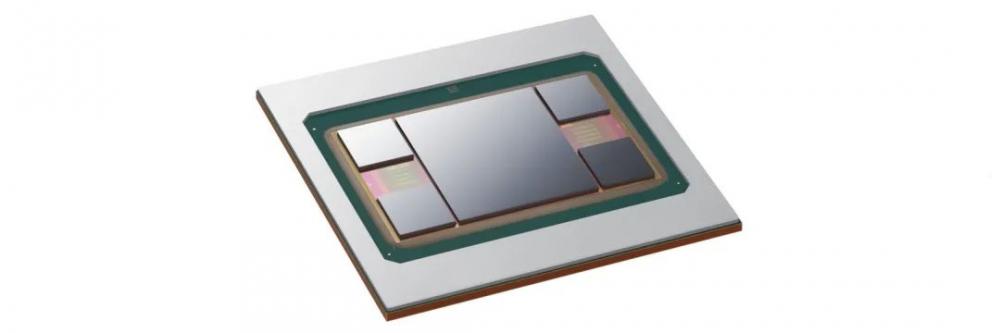
在2018年,三星展示了将逻辑芯片和2个HBM集成一体的“I-Cube2”解决方案。到了2020年,三星发布了新一代的“X-Cube”技术,可以将逻辑芯片和SRAM进行垂直3D堆叠。三星市场战略部负责人Moonsoo Kang表示:
“随着高性能应用的爆炸式增长,必须提供具有异构集成技术的整体代工解决方案,以提高芯片的整体性能和电源效率。凭借I-Cube2的生产经验以及I-Cube4的商业竞争力,我们还将开发配置了6个和8个HBM芯片的新技术,并将其推向市场。下一代封装技术的重要性正在增强,我们会将重点放在高性能计算领域。”
硅中介层(Interposer)是指在高性能芯片和低速运行的PCB板之间,插入的微电路板。硅中介层和放在它上面的逻辑芯片、HBM通过硅通孔(TSV,Through Silicon Via)微电极连接。使用这种技术,不仅能提升性能,而且还能减小封装面积。通常硅中介层面积成比例增加,可以容纳更多的逻辑芯片和HBM芯片。由于I-Cube中的硅中介层比纸更薄(约100μm),因此较大的中介层就很容易出现弯曲或翘曲,这会对产品的品质产生影响。

凭借在半导体领域的专业知识和丰富经验,三星通过改变材料和厚度来控制中介层的翘曲和热膨胀,从而成功实现了I-Cube4的商业化。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。










