- 一座全新的价值160万英镑的先进设施正式在威尔士南部的新波特 (Newport) 开设,旨在加速英国的电气化进程。这座设施位于复合半导体应用 (CSA) Catapult,在英国开放环境中首次引入了先进设备,将用于帮助企业提升其半导体和复合半导体技术的性能。作为 “推动电动革命产业化中心” (DER-IC) 南西部和威尔士的一部分,该设施由威尔士国务大臣 David TC Davies 在一个由工业、学术界和政府参与的活动上正式开幕。DER-IC 南西部和威尔士是更广泛 DER-IC 网络的一部分,该网络
- 关键字:
半导体DER 封装
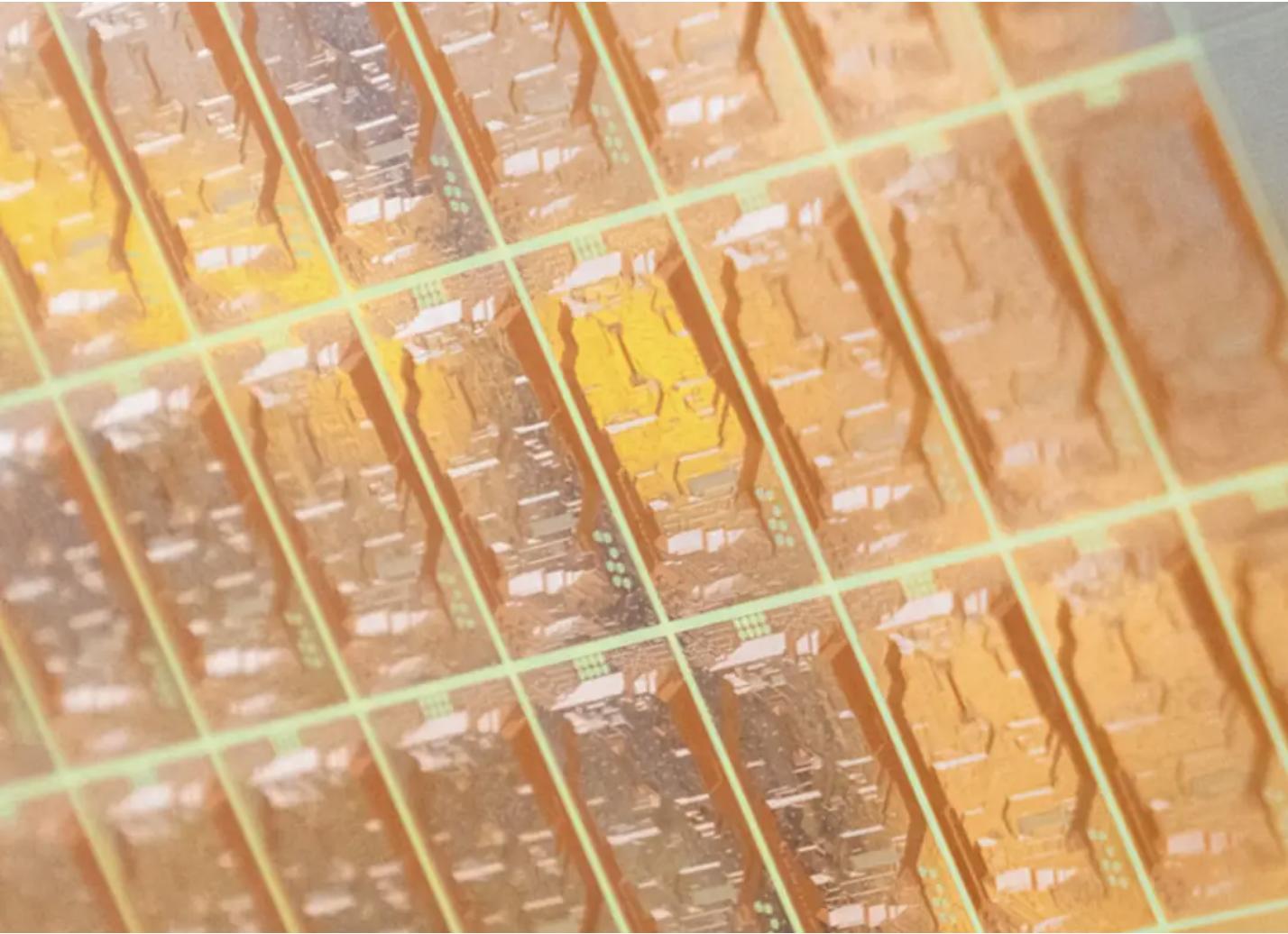
- 根据最新市场消息,苹果正积极与多家供应商商讨将玻璃基板技术应用于芯片开发,以提供更好散热性能,使芯片在更长时间内保持峰值性能。同时,玻璃基板的超平整特性使其可以进行更精密的蚀刻,从而使元器件能够更加紧密地排列在一起,提升单位面积内的电路密度。
- 关键字:
芯片 玻璃 基板 封装
- 目前英伟达的H100等数据中心GPU都是由台积电(TSMC)负责制造及封装,SK海力士则供应HBM3芯片。不过人工智能(AI)的火热程度显然超出了大家的预期,导致台积电的先进封装产能吃紧。虽然台积电不断扩大2.5D封装产能,以满足英伟达不断增长的需求,但是英伟达在过去数个月里,与多个供应商就2.5D封装产能和价格进行谈判,希望能够分担部分工作量。据The Elec报道,三星已经获得了英伟达的2.5D封装订单。其高级封装(AVP)团队将向英伟达提供中间层,以及I-Cube封装。I-Cube属于三星自己开发的
- 关键字:
三星 英伟达 封装 2.5D
- 月 8 日消息,据韩国电子行业媒体 TheElec 报道,三星电子成功拿下了英伟达的 2.5D
封装订单。消息人士透露,三星的先进封装 (AVP) 团队将为英伟达提供 Interposer(中间层)和 I-Cube,这是其自主研发的
2.5D 封装技术,高带宽内存 (HBM) 和 GPU 晶圆的生产将由其他公司负责。据IT之家了解,2.5D
封装技术可以将多个芯片,例如 CPU、GPU、I / O 接口、HBM 等,水平放置于中间层上。台积电将这种封装技术称为
CoWoS,而三星则称之为
- 关键字:
三星 英伟达 AI 芯片 2.5D 封装 订单
- 3月27日,美国半导体公司美光(Micron)科技总裁兼首席执行官桑杰·梅赫罗特拉(Sanjay Mehrotra)现身中国西安,出席美光封装和测试新厂房的奠基仪式,该厂房是其去年6月宣布追加43亿元新投资计划的一部分。此外,美光还将在西安工厂投资多个工程实验室,提升产品可靠性认证、监测、故障分析和调试的效率,从而帮助客户加快产品上市时间。美光CEO Sanjay Mehrotra(图片来源:美光)桑杰·梅赫罗特拉现场发表演讲表示,中国是美光开展全球业务的重要市场,2005年至今,美光累计在中国市场投入超
- 关键字:
美光 西安 封装 测试
- 3月27日,美光宣布其位于西安的封装和测试新厂房已正式破土动工。资料显示,美光在中国运营版图包括北京、上海、深圳与西安等地。2023年6月美光宣布在西安追加投资43亿元人民币,其中包括加建这座新厂房,引入全新产线,制造更广泛的产品解决方案,包括但不限于移动DRAM、NAND及SSD,从而拓展西安工厂现有的DRAM封装和测试能力。新厂房预计将于2025年下半年投产,后续根据市场需求逐步投产。美光表示新厂房落成后,西安工厂总面积将超过13.2万平方米。同时,美光亦在推进收购力成半导体(西安)有限公司(力成西安
- 关键字:
美光 测试 封装
- 美光首个可持续发展卓越中心彰显了公司对中国运营及本地社区的不懈承诺2024年3月27日,中国西安 —— 全球领先的半导体企业 Micron Technology Inc.(美光科技股份有限公司,纳斯达克股票代码:MU)今日宣布其位于西安的封装和测试新厂房已正式破土动工,进一步强化了公司对中国运营、客户及社区的不懈承诺。美光还在奠基仪式上宣布,公司将在西安建立美光首个封装和测试制造可持续发展卓越中心(CoE),推动公司在环境、社会和治理(ESG)方面的合作伙伴关系,实现全球可持续发展目标。 美光于
- 关键字:
美光 封装 工厂 西安
- 3 月 20 日消息,在 AI 芯片浪潮推动下,先进封装成为了半导体行业最炙手可热的核心技术。台积电、英特尔在夯实自身基础、积累丰富经验的同时,也正积极地拉拢供应链、制定标准、建构生态,从而增强自身的话语权。英特尔力推 UCIe(Universal Chiplet Interconnect Express)产业联盟UCIe
产业联盟是一个由诸多半导体、科技、互联网巨头所建立的组织,由英特尔牵头,联合了台积电、三星、日月光(ASE)、AMD、ARM、高通、谷歌、Meta(Facebook)、微软等十
- 关键字:
英特尔 台积电 封装 AI
- 在过去几十年里,电子芯片在商用设备中的集成方式显著发展,工程师们设计出了各种集成策略和解决方案。最初,计算机包含一个中央处理器或中央处理单元(CPU),通过传统的通信路径,即前端总线(FSB)接口,连接到内存单元和其他组件。然而,技术进步使得开发依赖于多个芯片组和更复杂的电子元件的新集成电路(IC)架构成为可能。英特尔公司在这些发展中发挥了关键作用,通过引入用于设计具有多个封装芯片组系统的新架构和规范。英特尔公司圣克拉拉的研究人员最近概述了一种新的愿景,旨在进一步提高遵循通用芯片组互连表达(UCIe)的系
- 关键字:
芯粒 封装 英特尔
- 不同市场的需求需要建立额外的芯粒标准,涵盖的范围远远超出目前用于接口的标准。
- 关键字:
芯粒 封装
- 公开了用于改善集成电路封装的無性能的系颇方法。本发明的方面包括改进的雄封装结构以没通过在封装中应带一个或多个散热器来生产核结构的方法。在实施例中,散热器被结合在半导体管芯和其管芯焊盘之间的半导体芯片封装中。与没有散热器的封装相比,通过在集成电路封装中包括散热器,封装可以处理更高的功率水平,同时保持封装的大致相同的温度,或者可以在相同的功率水平下损作时降低封装的温度。介绍本文涉及集成电路(IC)封装的系统和方法。并且,本发明更特别地涉及于提高集成电路封装解决方案的热性能的系统和方法。还涉及集成背景电路,也称
- 关键字:
封装 热增强 散热器
- 半导体封装技术已经从最初的1D PCB水平发展到最尖端的3D混合键合封装技术在晶圆级别。这一进步实现了一位数微米的互连间距,以高能效实现超过1000 GB/s的带宽。四个关键参数塑造了先进半导体封装:功耗、性能、面积和成本:功耗:通过创新的封装技术提高功耗效率。性能:通过缩短互连间距以增加输入/输出(I/O)点,提高带宽并减少通信长度,从而提高性能。面积:在用于高性能计算领域的芯片中需要较大的封装面积,而在3D集成中需要较小的z形状因子。成本:通过采用替代材料或提高制造设备效率,持续降低封装成本。2.5D
- 关键字:
封装
- 新加坡,12月18日 - 越来越多的中国半导体设计公司正在寻求与马来西亚公司合作组装部分高端芯片,以在美国对中国芯片行业扩大制裁的情况下分散风险,知情人士表示。据了解讨论情况的三人称,这些公司正在要求马来西亚芯片封装公司组装一种称为图形处理单元(GPU)的芯片。他们说,这些请求仅涵盖组装——不违反任何美国限制——而不是芯片晶圆的制造。其中两人补充说,一些合同已经达成。由于华盛顿对其销售以及先进芯片制造设备的制裁愈演愈烈,以限制中国获取可能推动人工智能突破或为超级计算机和军事应用提供动力的高端GPU的访问,
- 关键字:
封装,国际
- 本文介绍已获专利的适用于机电接触应用的1-Wire®接触封装解决方案,并对比传统的封装解决方案以展示1-Wire接触封装解决方案的优越性。本文还就如何将该解决方案安装到配件或耗材提供了建议,并作了机械规格和可靠性分析。越来越多的系统要求为传统的非电子外设或耗材添加电子功能,包括存储校准数据或制造信息,或者存储外设、配件或耗材的OEM认证。这就要求系统需要添加存储和安全功能,还必须在主机和外设之间添加机电连接功能。已获专利的1-Wire接触封装(以前称为SFN封装)专为机电接触环境而设计,典型应用包括对象识
- 关键字:
1-Wire 封装 机电
封装介绍
程序 封装 (encapsulation)
隐藏对象的属性和实现细节,仅对外公开接口,控制在程序中属性的读和修改的访问级别.
封装 (encapsulation)
封装就是将抽象得到的数据和行为(或功能)相结合,形成一个有机的整体,也就是将数据与操作数据的源代码进行有机的结合,形成“类”,其中数据和函数都是类的成员。
封装的目的是增强安全性和简化编程,使用者不必了解具体的 [
查看详细 ]
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473