3D集成电路将如何同时实现?
三维集成电路的第一代商业应用,CMOS图像传感器和叠层存储器,将在完整的基础设施建立之前就开始。在第一部分,我们将回顾三维集成背后强大的推动因素以及支撑该技术的基础设施的现状,而在第二部分(下期),我们将探索一下三维集成电路技术的商业化。
本文引用地址:https://www.eepw.com.cn/article/92517.htm不论是在需要考虑栅极和互连延迟的器件级别,还是在需要考虑带宽和时序问题的系统级别,都无法避免一场正在发生的完美风暴,它要求业界在如何实现微电子功能方面做出转变。影响这一转变的关键因素包括国际半导体技术蓝图(ITRS)的推迟,以及由难于集成多孔低k材料所带来的铜和低k线尺寸持续缩减的问题。与此同时,高达50%的功耗用在芯片的互连线上,即使对于65nm工艺节点的铜互连线来说,引线电阻和寄生电容也已经成为问题。
最早认识到这些问题是在2001年,当时IEEE院士Saraswat、Rief和Meindl预测,“芯片互连恐怕会使半导体工业的历史发展减速或者止步……”,并提出应该探索电路的3D集成技术。
2007年9月,半导体工业协会(SIA)宣称:“在未来大约10-15年内,缩小晶体管尺寸的能力将受到物理极限的限制”,因此3D集成的需求变得更加明显。全新的器件结构,比如碳纳米管、自旋电子或者分子开关等,在10-15年内还不能准备好。5新型组装方法,如3D集成技术再次被提了出来。
存储器速度滞后问题是3D集成的另一个推动因素,众所周知,相对于处理器速度,存储器存取速度的发展较慢,导致处理器在等待存储器获取数据的过程中被拖延。在多核处理器中,这一问题更加严重,可能需要将存储器与处理器直接键合在一起。
3DIC集成技术的拯救
2005年2月,当《ICsGoingVertical》发表时,几乎没有读者认识到发生在3DIC集成中的技术进步,他们认为该技术只是叠层和引线键合,是一种后端封装技术。
今天,3D集成被定义为一种系统级集成结构,在这一结构中,多层平面器件被堆叠起来,并经由穿透硅通孔(TSV)在Z方向连接起来(图1)。
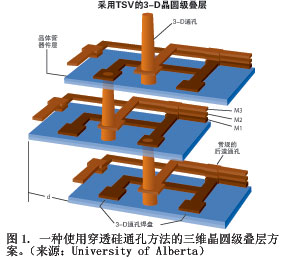
为制造这样的叠层结构,已经开发了很多工艺,下面所列的正是其中的关键技术:
■TSV制作:Z轴互连是穿透衬底(硅或者其他半导体材料)而且相互电隔离的连接,TSV的尺寸取决于在单层上需要的数据获取带宽;
■层减薄技术:初步应用需减薄到大约75~50μm,而在将来需减薄到约25~1μm;
■对准和键合技术:或者芯片与晶圆(D2W)之间,或者晶圆与晶圆(W2W)之间。
通过插入TSV、减薄和键合,3DIC集成可以省去很大一部分封装和互连工艺。然而,目前还未完全明确,这些在整个制造工艺中需要集成在什么位置。似乎对于TSV工艺,可以在IC制造和减薄过程中,经由IDM或晶圆厂获得,而键合可以由IDM实现,也可以在封装操作中由外部的半导体组装和测试提供商(OSATS)实现,但这有可能在技术成熟时发生变化。
在将来很有可能发生的是,3DIC集成技术会从IC制造与封装之间的发展路线发生交叠时开始。
3D工艺选择
TSV可以在IC制造过程中制作(先制作通孔,viafirst),也可以在IC制造完成之后制作(后制作通孔,vialast)。在前一种情况下,前道互连(FEOL)型TSV是在IC布线工艺开始之前制作的,而后道互连(BEOL)型TSV则是在金属布线工艺过程中在IC制造厂中实现的。








评论