IC封测业新时代到来
近日,日月光研发中心的首席运行官何明东在接受媒体采访时表示,随着许多新的封装技术导入以满足市场需要,日月光(ASE)相信全球IC封装测试业的新时代已经到来,各种IC封装型式的呈现将更加促使产业间加强合作。
本文引用地址:https://www.eepw.com.cn/article/82384.htm随着摩尔定律缓慢地于2014年向16纳米工艺过渡,与之前5至10年相比较,由于终端电子产品市场的需求,IC封装的型式急剧增加,在过去的5年中己有4至5倍数量的增加,相信未来的5年将继续增长达10倍。随着IC封装业的新时代到来肯定会给工业带来巨大的商机。
2000年ASE认为倒装技术(flipchip)是主流,现在来看穿透硅通孔技术(TSV)可能是下一代封装的主流技术。自从业界开创硅片级封装(WLCSP)的核心技术以来,意味着技术本身仅需要加进些新的设备到现有生产线中即能成功。目前,ASE的WLCSP和凸点封装能力己是全球第一,通过构建ASE的WLCSP能力使ASE的硅通孔技术领先于竞争对手1至2年。因为整个ASE集团有能力支持测试和封装技术,如ASE的测试系统可支持各种衬底材料的发展,以及获得通用科学工业园(USI)的帮助来支持系统集成。对于穿透硅通孔技术,ASE有望在今明两年成形,2010年开始有真正的销售额。
当各种新的封装形式刚进入研发阶段时,成本上无法同技术合作者如IDM、设备制造商和供应商来分担,而自己也不可能来承担如此高额的费用。ASE的策略是转向与研究所和对此项技术有兴趣的客户合作,通过合作开发扩大视野及分担费用,因而ASE能保持研发费用控制在年销售额的2至3%。
随着工业的特征尺寸越来越小,材料和设备的重要性急剧上升,以及工业的人才资源越来越精,所以工业的发展总是趋于“大者恒大”,意味着新入门者的机会变小。12年前台湾大约总计有60至70家后道封装测试公司,但现在已经减小到只有个位数的公司仍在运行及有收益。
尽管倒装芯片封装目前仍是主流技术,但这并不意味着如引线框架及球栅阵列等封装型式将消失。因为工业己出现很大的改变,可以看到在裸管芯和材料方面的成本压力仍继续存在。在如此严峻的环境下,对于那些小公司,由于缺乏支持,所以未来的工业兼并步伐将加快,这是总的趋势。






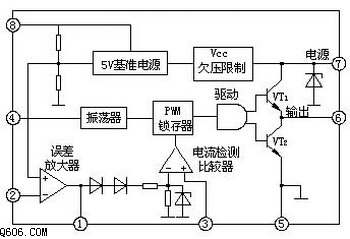

评论