半导体封装用环氧模塑料面临绿色考验
用(EMC/Epoxy Molding Compound,通常又叫环氧塑封料),上世纪60年代中期起源于美国(Hysol),后发扬光大于日本,现在中国是快速崛起的世界EMC制造大国。环氧塑封料不仅可靠性高,而且生产工艺简单、适合大规模生产,同时成本较低,目前已占整个微电子封装材料97%以上市场。我国大陆EMC产能已超过7万吨,2008年能将超过8万吨。随着环氧塑封行业的快速发展,对环氧塑封材料提出了更高的要求,除了提高性能、控制成本等要求外,主要集中在环境保护方面。具体体现在两个发展趋势上:一是要化,要经得起260℃无铅工艺条件考验;二是要从非环保向绿色环保过渡,要无溴、无锑等。现在世界各大EMC生产厂商加快绿色环保型EMC的推广与研发改进工作,这是一个重新洗牌的过程,机遇与挑战并存,特别是对中国内资EMC中小生产企业,挑战多于机遇。先进封装技术的快速发展,为环氧塑封料发展提供巨大空间,也给环氧塑封料的发展提出了很大的挑战。
本文引用地址:https://www.eepw.com.cn/article/81491.htm首先是来自阻燃方面的挑战。目前业内所使用的阻燃剂绝大多数是卤素衍生物或含锑阻燃剂等,卤系阻燃剂的存在会导致很多问题,例如当其燃烧时会产生对人体和环境危害的有毒气体,如二嗯英(dioxin)、苯并呋喃(benzofuran)等,这些有毒气体可能引起人体新陈代谢失常,从而造成紧张、失眠、头痛、眼疾、动脉硬化、肝脏肿瘤等病状,动物实验发现会导致癌症;另一方面处理或回收这些含卤废料也相当困难。因此含卤阻燃剂的使用受到了很大限制。欧盟早在2000年6月就已完成了电气及电子设备废弃物处理法第5版修正草案,对无卤环保电子材料加以规范,明确规定多溴联苯(PBB)以及多溴联苯醚(PBDE)等化学物质2008年1月1日禁止使用。燃剂从含卤型转变到无卤型,这将对环氧塑封料的物理性能产生影响,其中包括:流动长度、胶化时间、粘度、飞边/溢料、硬度、玻璃化温度、热膨胀系数、弯曲模量及弯曲强度。目前用在绿色环氧塑封料主要有磷型阻燃剂、金属氢氧化物型阻燃剂、多芳烃环氧/固化体系阻燃剂。
其次是来自无铅焊料的挑战。自然界中的酸雨会把焊锡中的含铅材质溶解出来,经由食物及饮水铅会在人体内积累,引起重金属污染、进而危害到人体健康。因此含铅助剂也成为欧盟WEEE严禁使用的品种。在符合环保需求下,无铅焊料的开发 已成为必然趋势。目前开发的无铅焊料的熔点相对较高,因此再流焊峰值温度也从目前含铅焊料的230~245℃升高到250~265℃。无铅化是电子封装业的必然趋势,然而要真正实现封装的无铅化,使其从研发走向工业生产、从小批量生产转向大批量生产,在电子工业领域彻底取代锡铅焊接,需要考虑各方面的相容性问题,这主要包括:材料相容性(焊料及其他辅助材料)、工艺相容性(回流、检测、返修工艺)、设计相容性、可靠性相容性(热疲劳、机械应力)、设备相容性及成本问题。综合考虑各因素,处理好各方面的相容性,才能顺利实现电子封装向无铅化的转变。
最后是来自封装工艺的挑战,近年来半导体封装技术领域内正经历着2次重大变革,并蕴藏着第3次变革。第1次变革出现在20世纪70年代初期,其典型特征在于封装形式从插入式(如DIP)向表面贴装式(如QFP)转变;第2次变革出现在20世纪90年代中期,其典型特征在于从四边引脚型表面贴装(如QFP),向平面 阵列型表面贴装(如BGA)的转变。而出现于21世纪初期的第3次变革已初露端倪,其以芯片尺寸封装(CSP)、三维叠层封装以及全硅圆片型封装为典型特征。
在这3次变革过程中,封装材料所扮演的角色将越来越重要,其已被视为挖掘集成电路极限(最优)性能的决定性因素。新型封装技术的发展对于环氧塑封料提出了如下基本性能要求:高耐热性、低吸潮性、低应力以及低成本。同许多其它有机高分子材料一样,环氧树脂也易于燃烧,因此在使用过程中通常都要加入阻燃剂,传统环氧塑封料很难同时满足上述要求,因此研制开发高性能环氧塑封料已势在必行。
![]()
![]()
![]()



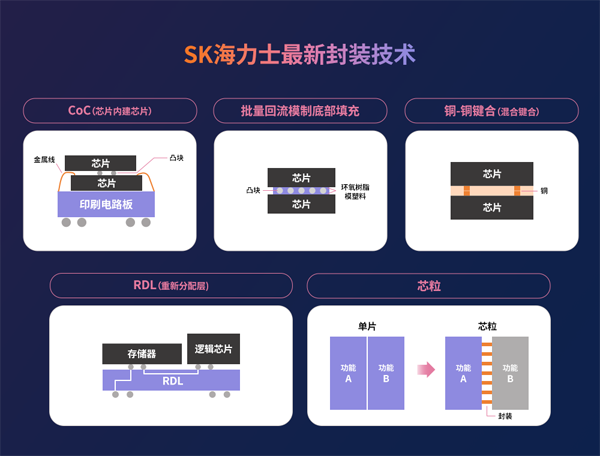


评论