英飞凌在DRAM沟槽技术中取得重大突破
英飞凌科技公司在2004年IEEE(电子和电气工程师学会 2004年12月13~15日于美国旧金山举行)国际电子器件会议(IEDM)上,展示了该公司具有高生产性的、适合未来DRAM产品的70 nm工艺技术,此技术以在300 mm晶圆上的深沟(DT)单元为基础。目前全球25%的DRAM生产都是以沟槽技术为基础的。在其报告中,英飞凌阐述了全部集成计划和主要技术特征――包括首次在基于沟槽技术的DRAM生产流程中使用高介电常数物质。英飞凌70 nm DRAM程序堪称重大技术突破,显示了沟槽技术的可伸缩性。
英飞凌希望能将其在70 nm工艺技术上的突破,转变成在300 mm晶圆上DRAM的生产率及产量的提高。较小的工艺结构可使芯片尺寸减小约30%,从而提高每片晶圆的芯片产量。根据Gartner Dataquest 公司的最新预测,2003至2008年,全球对DRAM比特数的需求将以平均每年51%的速度高速增长,从而最终实现从计算设备到数据存储器再到消费电子产品的多种应用。
英飞凌展示的70 nm沟槽技术首次在沟槽电容中使用了高介电常数物质(Al2O3)。在各个电容板之间使用高介电常数物质可以极大提高电容容量,从而实现电容器的成功瘦身。此外,该技术还融入了在采用90 nm DRAM技术的高效内存组件中也已成功使用的诸多技术创新,包括利于光刻和高纵横比蚀刻工艺的全新对称“棋盘”(CKB)式布局。
半球硅颗粒(HSG)和瓶状沟槽的结合使用增大了沟槽电容的表面积,从而提升了沟槽存储电容的容量。
在缩小内存单元几何尺寸时,为了克服短信道效应,不得不提高基板掺杂水平,这就使DRAM技术面临着巨大的挑战。另一方面,与DRAM存储电容交接处的电场也对数据保持产生了很大的影响。有关数据保持时间与增强型电场之间的紧密关系已有过多方报道,这主要是由于掺杂浓度越高,交界处泄漏就越严重。目前已提出了多种解决方案,如采用深沟技术纵型晶体管、采用堆叠式电容技术的凹槽装置等。这些方法背后的想法都是通过将阵列晶体管通道延长至硅表面,从而降低掺杂浓度,增加通道长度,但这要以牺牲装置驱动电流为代价。
与其他方法不同的是,英飞凌开发的全新DRAM芯片的可伸缩性是以一种极不对称、不均一的掺杂分布为基础的。有了这种理念,英飞凌研发人员就能够进一步缩小平板DRAM芯片制造装置,同时保证装置的驱动电流。保证DRAM数据保持的另一关键因素就是对因外形尺寸骤减而导致的存储电容的损失进行有效补偿。深沟技术可使纵横比(沟槽深度与宽度之比)达到70:1,这样,尽管工艺结构相对较小,也可以获得充足电容。
英飞凌目前的大部分生产中都采用110 nm工艺技术,这种技术是以代表DRAM生产行业最高面积效率的沟槽电容单元为基础的。面积效率的优势意味着靠模尺寸更小,每片晶圆出产的芯片更多,以及生产成本更低。








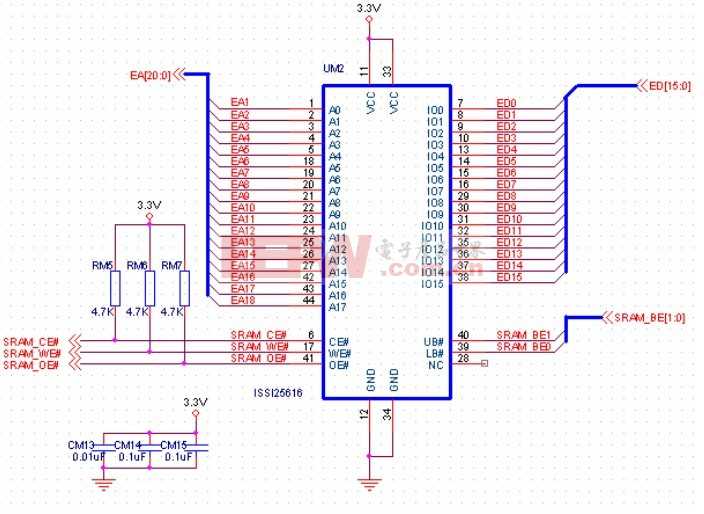




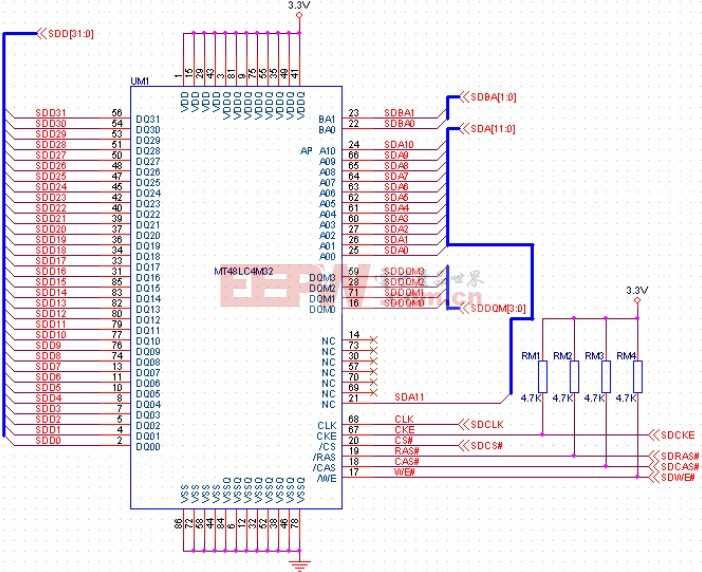

评论