DRAM掀起新一轮热潮,封装技术发挥关键作用
处理器,无论是 CPU、GPU、FPGA,还是 NPU,要想正常运行,都离不开 RAM,特别是 DRAM(动态随机存取存储器),它已经成为各种系统(PC,手机,数据中心等)中内存的代名词。
本文引用地址:https://www.eepw.com.cn/article/202312/453760.htm根据应用不同,系统对芯片面积和功耗有不同要求,因此,DRAM 被分成标准 DDR(双倍数据速率)、LPDDR、GDDR 等,当然,主要就是这三类。其中,DDR 是相对于 SDR(单数据速率)而言的,将 I/O 时钟加倍了,主要为 PC 和数据中心的 CPU 服务,目前已经发展到 DDR5;LPDDR 是低功耗的 DDR,主要用于手机等便携式设备;GDDR 则是 GPU 专用 DRAM。
在高性能计算(HPC)和 AI 发展如火如荼的当下,一个很大的瓶颈就是处理器与 DRAM 之间的通信速度,越来越跟不上应用需求的前进脚步。对此,人们想出了多种方法,以提升通信带宽,如不断提升 DRAM 本身的接口性能,以及存算一体等,但从实际应用情况来看,只提升接口性能是不够用的,而存算一体短期内还无法实现。在这种情况下,推出更好的 DRAM 与 CPU、GPU 等处理器的结合形式,也就是不断让封装技术进步,成为了业界提升通信带宽的普遍共识。
DRAM 的常用封装技术
DRAM 封装技术几经变迁,从双列直插封装 DIP、J 型引脚小外形封装 SOJ、薄型小尺寸封装 TSOP、底部引线塑料封装 BLP、焊球阵列封装 BGA(F-BGA、W-BGA),发展到芯片级封装 CSP、堆叠封装等高性能封装方式。在成本允许的条件下,可尽量采用先进的封装技术,以提升 DRAM 性能。
目前,堆叠封装技术,特别是系统级封装(SiP),可以在有限的空间内成倍提高存储器容量,或实现电子设计功能,解决空间、互连受限等问题。此外,由于封装设计的变化,引线键合封装因具有灵活性、可靠性和低成本的优点而备受青睐。倒装(Flip Chip,FC)芯片于 2016 年开始进军 DRAM 封装,由于高带宽需求的推动,倒装芯片在 PC、服务器中的采用率不断增加。目前,系统对高带宽、高性能、低延迟的综合要求很高,硅通孔(TSV)很适合高带宽内存封装需求。
在便携式电子设备应用中(如手机),DRAM 的封装尺寸会直接影响到产品的体积大小,所以,封装技术要向轻、薄、短、小方向发展。
不同应用的产品尺寸、性能、形态等存在差异,采用的封装形式也不同。其中,移动终端 DRAM(LPDDR)多以 WB-FBGA 为主,PC 和服务器用的标准型 DDR 则以 FBGA、FC 为主。
以 DDR 为例,FBGA 线长较短,信号传输好且成本较低,曾经被三星、SK 海力士和美光等主流厂商广泛采用,随着内存条产品发展到 DDR4,三星、SK 海力士的很多产品开始转向 FC 封装,其传输路径更短,电性能表现更好。尽管 FC 的成本比 FBGA 高,但得益于规模效应,两者成本基本持平。现在的高端产品,如 DDR5,性能要求很高,目前多采用 TSV 堆叠封装。TSV 采用纵向穿越结构,通过导线将不同层的芯片相互连接起来,这种连接方式不仅提供了更高的信号带宽,还减少了电阻和电感,提高了芯片的整体性能。通过 TSV 把多芯片的 I/O 连接,同时实现多芯片堆叠来扩容并实现更小的信号损失。
LPDDR 与处理器紧密集成在一起,或者焊接在主板上,靠近 CPU,或者直接在处理器(在这种情况下,通常是 SoC)的顶部以 package-on-package 封装的形式出现,这种形式越来越常见。紧密的集成可减少将内存连接到处理器的长导线中的电阻,从而降低功耗。
总体来看,引线键合是主要的封装方法,广泛应用于移动存储器,其次是倒装芯片封装,其在 DRAM 市场不断拓展。
HBM 带动封装技术再创新
目前,AI 服务器对 HBM(高带宽内存)的需求量越来越大,因为 HBM 大大缩短了走线距离,从而大幅提升了 AI 处理器运算速度。
HBM 经历了几代产品,包括 HBM、HBM2、HBM2e 和 HMB3,最新的 HBM3e 刚出样品。HBM 是一种应用于 CPU 和 GPU 的新型内存,它将多个 DDR 芯片堆叠在一起后和 GPU 封装在一起,主要通过 TSV 技术进行芯片堆叠,通过贯通所有芯片层的柱状通道传输信号、指令和电流,以增加吞吐量并克服单一封装内带宽的限制,实现了大容量、高带宽的 DDR 组合阵列。HBM3 带宽可以达到 819GB/s。
目前,全球三大存储芯片厂商都在开发 HBM 技术和产品,其中,三星和 SK 海力士已经量产了 HBM3,主要用于英伟达的 H100、H800 和 AMD 的 MI300 系列 GPU,三星预计于 2024 年第一季度送样 HBM3e,下半年量产,SK 海力士则于近期给英伟达送去了 HBM3e 样品,其最新的 GPU 芯片 H200 已经标配了 HBM3e。美光(Micron)则相对落后,该公司选择跳过 HBM3,直接开发 HBM3e。
传统封装技术已经难以满足 HBM 的需求,而台积电的 CoWoS(chip-on-wafer-on-substrate)封装则是较为理想的方案。
CoWoS 是一种集成逻辑和 HBM 芯片的 2.5D 封装技术,在这种封装中,处理器和 HBM 在硅中介层上并排键合,以形成具有细间距和器件之间高密度互连布线的晶圆上芯片(CoW)。每个 HBM 都由带有微凸块的 DRAM 和一个带有 TSV 的逻辑基座组成,然后完成在基板上具有较大凸块的 TSV 中介层的组装。

多年来,CoWoS 一直在追求不断增加硅中介层尺寸,以支持封装中的处理器和 HBM 堆栈。目前,CoW 是倒装芯片键合最常用的组装方法,它采用了一种称为混合键合方法的无凹凸技术。
CoWoS 产能不足是近期 AI 芯片出货量的主要瓶颈,以台积电为代表的厂商正在扩充相关产能,以满足市场需求。
先进封装大战
台积电在 2011 年就开始布局 CoWoS 了,并陆续获得多个客户订单,但由于报价昂贵,加上相应的需求有限,因此,前些年的产能没有明显增加,但是,进入 2023 年以来,特别是 AIGC 需求爆发,台积电开始大幅扩建 CoWoS 产线。
目前,除了台积电,英特尔、三星等芯片制造大厂也在加大先进封装投入力度。
英特尔方面,预计该公司最新先进封装服务将在 2026 年投入量产。不同于其它竞争对手主要采用硅制程的中间层技术,英特尔选择用玻璃基板,其成本会相对较高,业界采用该方案的厂商较少。
对于赶超台积电 HBM 先进封装技术最为积极的是三星。
2021 年,三星推出了 2.5D 封装技术 H-Cube。今年 9 月,据 Etnews 报道,为了追上台积电 AI 芯片的先进封装,三星将推出名为 FO-PLP 的 2.5D 封装技术。据悉,FO-PLP 可将处理器和 HBM 整合到硅中介层。
据悉,FO-PLP 的基板是方形,而台积电的 CoWoS 是圆形基板,FO-PLP 不会有边缘基板损耗问题,但由于要将芯片由晶圆移植到方形基板,其作业较为复杂。
近期,三星还推出了最新的封装技术 SAINT,包括 SAINT S(垂直堆叠内存和 CPU),SAINT D(用于 CPU、GPU 和内存的垂直封装),SAINT L(用于堆叠应用处理器)。
消息人士称,SAINT S 已经通过了验证测试,在与客户进行进一步测试后,三星将于 2024 年推出相应的商业服务。
最近,三星 HBM3 及其封装服务通过了 AMD 的质量测试,后者计划将这些芯片和服务用于其最新的 GPU 芯片 Instinct MI300X。
此前,AMD 曾考虑使用台积电的封装服务,但由于后者的 CoWoS 产能严重供不应求,AMD 不得不改变计划。
据韩国消息人士透露,三星还在与英伟达进行 HBM3 芯片技术验证,并提供封装服务。一旦工作完成,预计三星将负责英伟达 H100 与 HBM3 的封装,据悉,这两家公司签署了一项服务和供应协议。
今年 6 月,三星成立了多芯片集成联盟,目的是与存储芯片公司、外包半导体封装和测试公司(OSAT),以及芯片设计公司共同推进封装技术。
在先进封装技术研发方面,没有芯片工厂的 AMD 也是不遗余力,特别是在 HBM 和 GPU、CPU 封装方面。
在 ISSCC 2023 国际固态电路大会上,AMD 提出了多种新的封装设想,其中之一是在服务器 CPU 模块内部,直接堆叠内存,而且是多层堆叠。一种方式是将 CPU 模块和内存模块并排封装在硅中介层上,另一种方式是在计算模块上方直接堆叠内存,有点像手机 SoC。
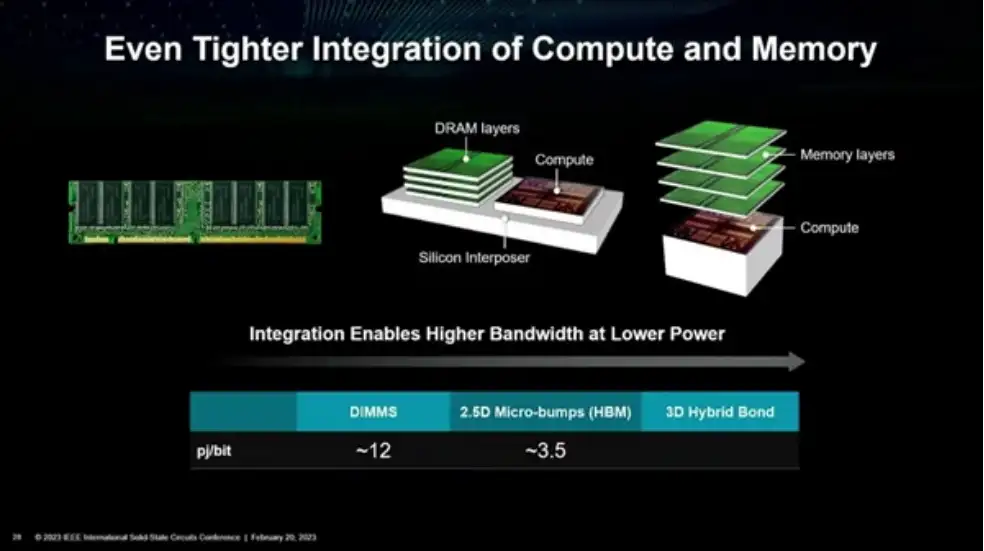
AMD 表示,这种设计可以让计算核心以更短的距离、更高的带宽、更低的延迟访问内存,还能降低功耗。
如果堆叠内存容量足够大,主板上的 DIMM 插槽都可以省了。
AMD 甚至考虑在 Instinct 系列 GPU 已经整合封装 HBM 的基础上,继续堆叠 DRAM,但只有一层,容量不会太大。这样做的最大好处是一些关键算法可以直接在此 DRAM 内执行,不必在 CPU 和独立内存之间往复通信,从而提升性能、降低功耗。
AMD 还设想在 2D/2.5D/3D 封装内部,集成更多模块,包括内存、统一封装光网络通道物理层、特定域加速器等,并引入高速标准化的芯片间接口通道(UCIe)。
结语
3D 封装是未来发展方向,这种多层结构有很多优点:一、它通过增加芯片层次和连接方式,实现了更高的芯片集成度和功能密度;二、多层堆叠结构减小了整个芯片的体积,使得电子设备变得更加轻薄便携;三、多层堆叠提供了更高的性能和效率,可进一步优化电子设备的处理速度和能耗。
HBM 所涉及的封装已经是当下最先进的内存封装技术了,不过,技术进步的脚步一直没有停歇,在扩充现有先进技术产线的基础上,各大厂商还在研发更具前瞻性的技术。
据悉,三星电子先进封装(AVP)事业组正在研发新一代内存技术「Cache DRAM」,目标是在 2025 年开始量产。与 HBM 相比,Cache DRAM 功耗效率可改善 60%,延迟将减少 50%。
封装技术方面,Cache DRAM 与 HBM 也有很大区别,HBM 是水平连接至 GPU,Cache DRAM 则是与 GPU 垂直连接。
当然,不止三星,英特尔、台积电、日月光等大厂都在开发新的内存封装技术,但具体情况还不得而知。
在研发先进封装技术的道路上,需要解决的难题也很多,例如,随着堆叠层数的增加,热量的管理问题越来越凸出,因为在紧密堆叠的芯片中,热量散发变得更加困难。对此,科学家们正在不断寻找解决方案,以保持芯片高性能工作状态的稳定性和可靠性。










评论