新型面向汽车通孔应用的高性能功率半导体封装
能效十分重要。事实上,能效是很多新型汽车功率电子系统设计的主要考核指标之一。浪费的每瓦电力都可以换算为本应留在油箱中的一滴汽油,或者是从排气管中额外排放的一克二氧化碳。如今,油耗和碳排放都面临着日益提高的税收。汽车半导体供应商如何帮助客户实现更高的能效?在大学毕业设计中,我选择了8mΩ 30V Dpak来驱动一个H桥——这在当时被认为是一种“尖端”器件,但如今这样一种器件却十分平常。这种进步在很大程度上应归功于半导体技术的巨大进步,但封装技术发展如何呢?
本文引用地址:https://www.eepw.com.cn/article/197283.htm应当牢记的是,半导体封装是将一系列元件组合在电路中,电流必须不受限制地流过封装,热量必须导入冷却系统。因此,系统的鲁棒性取决于整个链条中最薄弱的环节。如果一只典型MOSFET的导通电阻RDS(ON)约为8毫欧,那么比这个数值高出大约1毫欧的封装电阻是可以接受的。但是,当芯片的电阻低于封装电阻时,显然须要改善封装。表面贴装器件封装已经较好地解决了这个问题:典型 D2Pak封装的导通电阻仅比芯片高出0.5毫欧左右,而诸如DirectFET等封装技术对导通电阻的贡献值仅为150微欧。但通孔封装的导通电阻是多少?这是一个迄今为止人们较少关注的问题,也是一个创新不足的领域。
汽车应用普遍采用的封装技术之一是TO-262,即D2Pak的长引线变体。大功率器件经常选择这一封装技术。在这些应用中,为了取得良好的冷却效果,功率组件被放置在一个单独的基片上,从该基片可以更轻松地导出热量。具有讽刺意味的是,虽然被广泛用于大功率系统,但就封装电阻而言,TO-262的性能不尽如人意。主要的局限并非在于引线键合,而在于引线本身。通常,仅源极引线和漏极引线的总电阻就高达1微欧左右!
现在,我们考虑数据表上描述的导通电阻为2毫欧的40V TO-262 MOSFET。数据表上的导通电阻值是MOSFET芯片和封装的电阻之和,但不包含引线本身的电阻。所以,在系统中使用全长引线这一最差情况下,引线从头至尾的总电阻事实上可达3毫欧。在实际应用中,这会产生几种结果,其中之一是,较高的引线电阻导致引线自热,进而“加热”MOSFET的其他组件,结果增加了冷却成本。较高的封装电阻还会导致较高的传导损耗和较低的能效。
为此,业界对标准TO-262进行了一个简单的改善,从而产生了WideLead TO-262(见图2)。
比较图1和图2就会发现,WideLead TO-262的引线宽度被显著加大。结果,与标准TO-262封装相比,引线的电阻被降低了大约50%。业界还借此机会改善了这一封装的内部技术,结果,即使在不考虑引线电阻降低的情况下,WideLead TO-262的导通电阻也比TO-262低20%之多。更低的引线电阻,加上该封装内部技术的改善,将采用WideLead TO-262封装的器件的最大额定电流提高至240A,远远高于市场上现有的领先TO-262封装的195A。WideLead TO-262的外形与“身材”和传统TO-262一样,因此,从TO-262转换至WideLead封装时,不用大幅改变机械设计。

图1:传统TO-262封装

图2:新型WideLead TO-262封装。
从图3中可以看到WideLead TO-262封装的系统级优势。该图比较了标准TO-262和WideLead TO-262封装引线的温度随直流电流变化而转变的情况(两种封装内部的芯片相同)。在电流为60A时,WideLead封装的温度要比标准TO-262封装低39%。这可带来多重系统级利益,包括降低热量,进而提高器件可靠性等不一而足。由于产生的热量相对较少,需要散去的热量相应减少,结果就可能减小冷却装置的尺寸,也许还有可能使用级别更低的印刷电路板(PCB材料)——也就是额定工作温度更低的材料。
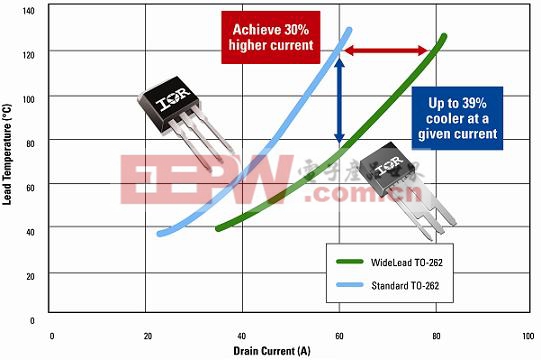
图3:标准TO-262封装和新型WideLead TO-262封装在不同电流下的引线温度差异。
在给定工作温度下,最多可以将器件的电流提高30%——也就是说,让相同的芯片实现更高的电流。由于封装性能对内部芯片的制约作用减弱,不管是哪种方式,都可在降低成本的同事提高器件的性能。
数十年来,能源一直是一种丰富的资源,但如今其供应日益紧张。现在不缺的是二氧化碳,事实上,其数量过多,以至各国政府纷纷出台相应法规,为实现减排对二氧化碳排放课以重税。这一挑战推动了汽车工程的发展,而电力半导体也必须在芯片和封装两个方面应对这一挑战。目前,通孔封装正在迎头赶上这一发展浪潮,但随着诸如WideLead这样的创新成果问世,封装和芯片的性能差异日益缩小。












评论