道康宁加盟EV集团开放平台
全球MEMS(微电子机械系统)、纳米技术和半导体市场晶圆键合及光刻设备的领先供应商EV集团(EVG)日前宣布,道康宁公司已加入该集团的“顶尖技术供应商”网络,为其室温晶圆键合及键合分离平台——LowTemp™平台的开发提供大力支持。道康宁是全球领先的有机硅及硅技术创新企业,此次加盟EVG这个业内领先的合作伙伴网络堪称此前双方紧密合作的延续,之前的合作包括对道康宁的简便创新双层临时键合技术进行严格的测试。今年7月,EVG推出全新的LowTemp公开平台,并宣布扩大其全球材料供应链,以加速其高端三维集成电路 (3D-IC)封装业务的发展。
本文引用地址:https://www.eepw.com.cn/article/164620.htmEV集团业务开发总监Thorsten Matthias博士表示:“道康宁是全球先进有机硅技术及专业技能方面的领导者,他们的加入无疑将使我们的这个临时晶圆键合/键合分离材料开放平台锦上添花。他们的合作方式和优秀原材料能帮助我们开发出创新而又具有成本效益的临时键合解决方案,为我们的客户在室温下采用传统生产方式进行活性及载体晶圆的键合与键合分离提供了更多选择。
EVG的LowTemp™临时键合/键合分离(TB/DB)平台具有三种不同的室温下晶圆键合分离工艺——紫外(UV)激光分离、多层粘合剂分离以及ZoneBOND®技术——它们都可用于大批量生产。
道康宁的双层TB/DB有机硅技术包含一个粘合剂层和一个脱离层,从而能够在室温下实现简单的临时键合与键合分离,并在总体厚度变化较小的情况下表现出最佳的使用性能,因此非常适合EV集团的平台。此外,当工艺要求在300° C的高温下,它还具有出色的耐化学性和热稳定性。
通过此次将道康宁列为其开放材料平台的合格供应商,EV集团的TB/DB技术实力将大大增强,全球供应链也将得到大大拓展。此非独占协议的签订将使双方得以联手为先进半导体封装行业提供经济实惠的TB/DB解决方案,为3D-IC封装应用的大规模生产提供支持。
道康宁先进半导体材料全球行业总监Andrew Ho表示:“此次双方在3D-IC封装和穿透硅通孔(TSV)开发领域达成合作,无论对于道康宁,对EV集团,还是整个半导体行业来说都是一个重要的里程碑。这不仅是对道康宁简便室温TB/DB技术的一次重要验证,更将进一步实现EV集团业内领先的规模生产开放平台的商业化。不仅如此,这项技术也是新一代微电子应用实现3D-IC封装工艺集成的一项重大进步。”
3D-IC集成技术通过将水平芯片结构叠层组装到垂直架构中,可大大提高微型电子设备的形状因数(芯片尺寸)、带宽(芯片晶体管密度)以及功能性。但是,要实现这项革命性的新技术首先需要简便经济的TB/DB解决方案将活性晶圆片键合到更厚的载体晶圆上,该技术能使活性晶圆的厚度减少到50 µm甚至更低,并通过穿透硅通孔(TSV)技术实现垂直方向芯片之间的相互连接。
EV集团将参加本周在台北举行的“国际半导体展(SEMICON Taiwan)”,届时欢迎对EVG最新晶圆键合以及其他加工解决方案感兴趣的媒体朋友和业内分析师前往台北世界贸易中心南港展览馆416号展位,或参加公司在展会期间的技术推介活动。9月4日15:30~ 16:00,公司技术开发及IP总监Markus Wimplinger先生将在TechXPOT作题为“如何使用LowTemp™键合分离技术低成本地处理晶圆薄片” 的论文演讲。Wimplinger先生还将于9月5日15:10~ 15:40在展会期间的MEMS论坛上发表题为“晶圆键合技术在大规模消费MEMS应用领域的发展趋势”的演讲。














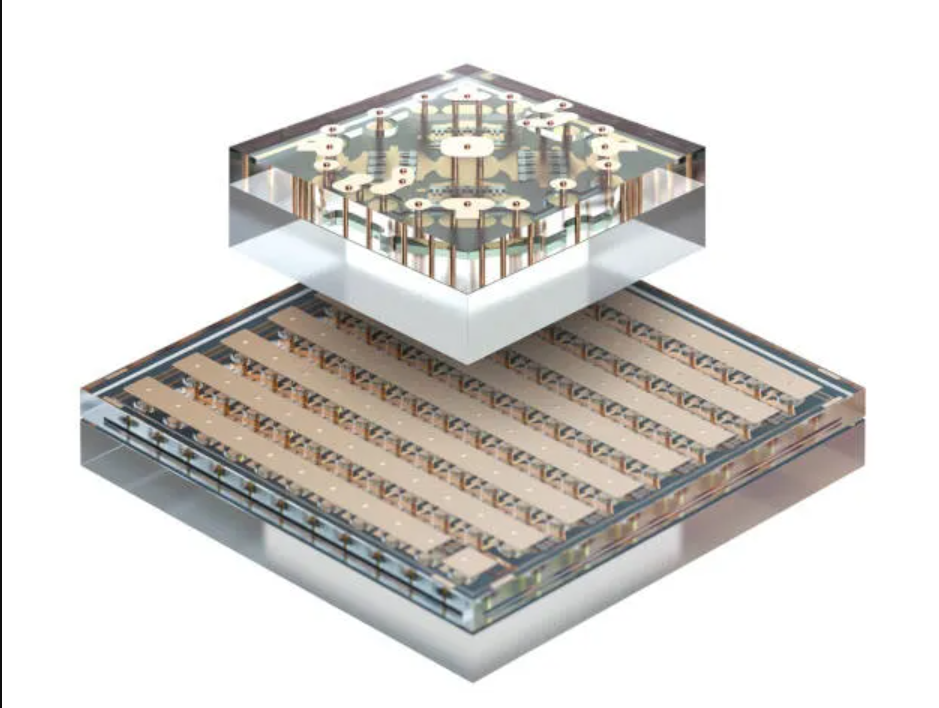

评论