N2 Purge在LPCVD炉管氮化硅工艺中的应用
对反应腔体的材质,试验了生产当中常用的两种反应腔体的材质:石英和碳化硅。使用相同的机台和制程连续生长40次,每次生长的氮化硅薄膜厚度为2000埃。记录每次试验生产中增加的particle颗数(particle size>0.2μm, 本文中所有particle都是大于0.2μm以上的),最终求其40次记录的平均值,结果如图6所示。当氮化硅薄膜的累积厚度大于4μm时,生产中增加的particle有明显的上升趋势,而在石英材质的反应腔内,particle增加量则保持相对平稳的水平。
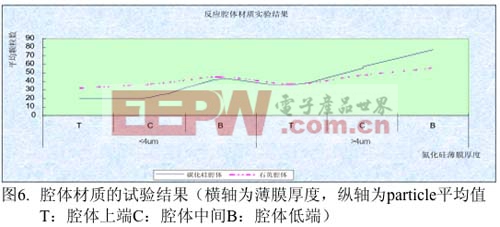
在生产过程中还发现了一个有趣的现象(表1):在石英材腔体的机台上,当particle增加较多的时候,利用机台本身的N2来做一次purge这样的清洗动作,机台的下一次生产会有较低的particle数目增加。而在碳化硅材质腔体的机台上,N2 purge却并不能收到这样的效果。针对这种现象,认为这是由于石英材质内壁上沉积的氮化硅薄膜随着淀积厚度的增加,一直以一种比较稳定的速度剥落,每次剥落的氮化硅薄膜数量不会像碳化硅内壁机台那样多,所以N2 purge比较容易将剥落的氮化硅薄膜清除走。







评论