N2 Purge在LPCVD炉管氮化硅工艺中的应用
根据对氮化硅薄膜的沉积过程分析,认为这是由于在LPCVD的炉管在生产过程反应中,氮化硅薄膜会逐渐沉积在反应腔的内壁上。这些沉积的氮化硅薄膜必然会受到应力的影响,这里的应力包括外应力和内应力。外应力指环境对薄膜本身施加的应力,如生产使用的气体的气流变化导致的干扰。内应力是薄膜沉积过程中,内部产生的应力。内应力包含热应力和本质应力两部分。氮化硅薄膜的热应力来源于薄膜和反应腔体内壁材料的热膨胀系数以及温度的影响。本质应力是氮化硅薄膜的本征张应力。随着氮化硅薄膜厚度的逐渐增加,应力必然逐渐增大。薄膜在内外应力的作用下必然会从反应壁上剥落下来,这些剥落的氮化硅薄膜就是氮化硅工艺中主要的particle来源(如图4所示)。
实际的生产经验也可以证明上面的理论:观察了一台生产机台氮化硅薄膜的厚度从0μm累计到8μm之间的particle的情况。当氮化硅的薄膜厚度累积大于4μm的时候,生产机台的particle就明显的增加。这说明氮化硅LPCVD炉管工艺的particle数量和氮化硅薄膜的累积厚度相关(图5)。

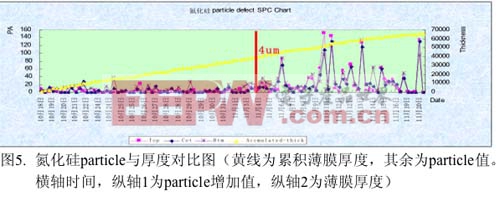
根据以上的氮化硅工艺中particle的分析中可以得知:为了解决氮化硅生产过程中的particle问题,必须要解决的是如何避免腔体内壁上的氮化硅薄膜的剥落的问题。而为了避免氮化硅薄膜的剥落,不但要减少腔体内壁上的薄膜沉积厚度,也要降低氮化硅薄膜所受到应力作用。
反应腔内壁上沉积的氮化硅薄膜必须及时的清除,常规的做法就是通过周期性的维护来去除反应腔体上的氮化硅薄膜。但经常性的清理会导致机台的生产效率降低,维护成本增加。应力方面,由于无法改变氮化硅薄膜的本质应力,所以只能降低氮化硅薄膜内在应力中的热应力和外在应力。根据上面的分析,对于热应力,需要考虑薄膜和反应腔体内壁材料的热膨胀系数以及温度等因素的影响。对于外在应力,就要优化在生产过程中的一些工艺参数来改善,如温度,压力和流量等方面的优化。






评论