半导体业界的HKMG攻防战:详解两大工艺流派之争
本文引用地址:https://www.eepw.com.cn/article/107122.htm
耶鲁大学的T.P. Ma教授表示,ZIL技术虽然非常吸引人,但通常需要使用高温工步来消除SiO2界面层,而gate-first工艺制作的栅极则正好能够承受这种高温,所以这项技术对采用gate-first工艺的厂商比较有利。他认为,按照他的理解,ZIL技术的实现需要使用“高温化学反应”来有效地去除栅极结构中残留的SiO2界面层,这样这项工艺对使用gate-first工艺的厂家而言实现起来难度更小一些,而使用gate-last工艺的厂商则会尽量避免使用高温工步。他还表示,IBM和Sematech公司所制出的ZIL结构已经能够在5埃的等效氧化层厚度条件下达到较好的防漏电性能。
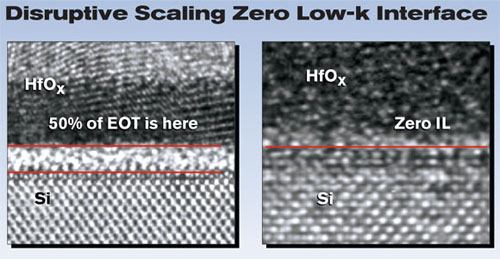
不过据Sematech公司的材料与新兴科技研发副总裁Raj Jammy表示,尽管Sematech公司早期的ZIL结构确实是在gatefirst工艺的基础上制造出来的,但是“要制出ZIL未必需要依靠高温处理工步,而主要是要去掉界面层中的氧离子。”他还强调不同的情况需要采用不同的热处理方式来进行处理,才能得到较好的管子参数。
而另外一篇IMEC的研究报告则指出,“我们制作ZIF的方法是需要进行高温热处理的,不过要生成理想的无界面层栅极结构的方法有很多种,因此未必说gatelast工艺就不利于ZIL的制作。”他还表示应该可以找到一种方案来兼顾ZIL与gatelast工艺的优点。
另外,在被问及对ZIL技术的看法时,Intel高管Bohr回答称,“在我的印象中这种技术并不是很有效,这主要是由于ZIL结构对沟道的载流子迁移率有一定的不良影响,而如果我们能够很好地控制界面层的材料和厚度,管子的性能一样也可以达到要求”,他还表示“相比之下,我认为我们应该努力去改善High-K绝缘层的材料,并想办法减小金属电极的电容.”
Gartner 市调公司的Freeman则表示,从28nm制程节点开始,台积电公司与GlobalFoundries之间的HKMG产品由于所用的工艺不同,因此将存在比较明显的区别。按照这样的差别趋势发展下去,一种最终的可能就是IBM和GlobalFoundries会在22nm制程节点马上转向gate- last工艺,而另外一种可能就是由于gatefirst在ZIL方面的优势被实际的应用证明,而将慢慢处于领先的位置。Freeman还表示:“在 16nm制程节点,如何控制好管子的界面层,将是至关重要的。”
















评论