梭特科技混合键合设备为异质整合芯片开发提供助力
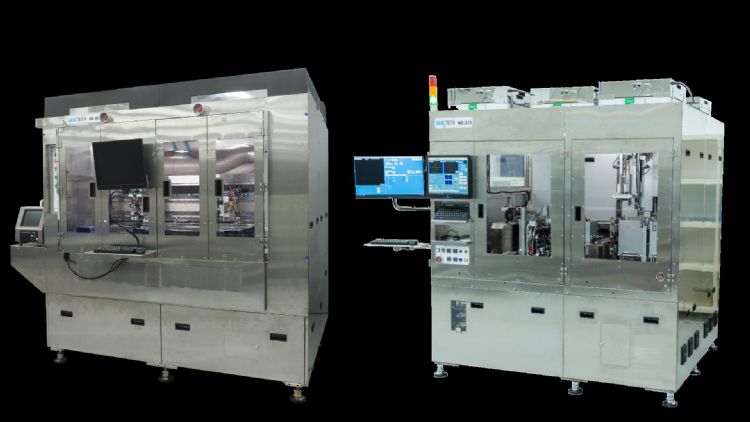
半导体封装发展历程从导线架封装,发展至BGA、Flip Chip、2.5D及3.D封装,及至最新的Hybrid Bonding。梭特科技(6812)为台湾先进半导体设备商,也正积极布局研发Hybrid Bonding制程相关设备。
梭特CEO卢彦豪表示,半导体技术发展已近极限,次时代CPU或存储器改采小芯片堆叠方式,发展Pad对Pad直接连结,改善Chip间的信号沟通效率及品质。Hybrid Bonding应运而生,无论AMD的CPU、NVIDIA的GPU或先进的AI芯片,都可以看到其身影。
梭特与工研院于两年前共同合作,投入纳米级Hybrid Bond技术研发,自力开发贴合波(Bonding wave)及六面清洁等关键技术,并且部署专利,筑高产业门槛。业务副总谢金谷解释,贴合波可避免制程中产生气泡及微粒污染,透过参数设定可调控晶粒黏合的方向及速度,提升产品良率。Hybrid bonding之后进化到多层堆叠制程后,晶粒六面清洁就很重要,透过CMP平整化及电浆表面活化,提升铜质Pad的接着性。
Hybrid Bond技术尚在发展初期,据了解,晶圆与封装大厂正在建置产线,还未正式进入量产。梭特看好后市发展,积极卡位供应链。谢金谷表示,梭特Hybrid Bonder设备于2022年半导体展实机展出后,旋即获得客户探询合作,2023年已进入验证阶段。有望于次时代半导体封装技术沿革中,为关键设备在地化做出贡献。
梭特2010年成立,以LED Sorter起家,研发垂直式式挑拣机,这项新型专利风靡市场10年,将营收推上巅峰。多年前转进半导体,在FanOut市场一战成名,如今以Hybrid Bonder技术,推出小型Wafer Level及 Chip Level二种机型,作业精度达0.2um。改版优化后,速度提升,产能增至每小时3K以上,产能超越国际大厂。
梭特为创新研发型企业,六成人力投入研发,以晶粒取放技术(Pick & Place)及独家垂直取放技术二大核心技术,开发少量多样的定制化设备,运用于IC半导体及LED分选机,分选精度及速度优于同业,至今已取得200余项各类专利,巩固在高端封装, Fanout, mini LED及分选设备的领先地位。
梭特目前以预排式巨量转移固晶设备为主,用在扇出型晶圆级封装(FOWLP)及扇出型面板级封装 (FOPLP)等高整合度制程,近年精进半导体先进制程设备,在3D封装及Chiplets封装显现成果。2023年景气面临挑战,预期市场回温的时间延后,所幸Fanout渐有起色,梭特科技先进封装解决方案广受到两岸高度关注。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。



