英飞凌有铅小信号分立器件全部在无锡封装
1996年在无锡设厂的英飞凌科技(无锡)有限公司,一直以承接成熟工艺进行批量封装测试定位,主要从事英飞凌科技小型化分立器件和智能卡芯片后道封装。但到2011年,英飞凌通过在资金、技术和制造设备上投入约1.5亿美元,将使其成为英飞凌科技有铅小信号分立器件和智能卡芯片全球制造基地,并同时兼具创新工艺开发功能。
本文引用地址:https://www.eepw.com.cn/article/95950.htm据英飞凌董事负责运营的会成员Reinhard Ploss介绍,根据英飞凌最新的业务整合实施方案,目前位于马来西亚的英飞凌马六甲功率半导体装配与测试生产厂内约55多条有铅小信号分立器件生产线全部转至无锡工厂,马六甲厂将专职于大高端/多管脚型产品器件,并继续作为其他产品的量产基地,同时发展封装、测试及生产工艺方面的研发,而拥有一条中试线的英飞凌新加坡公司则专注于测试工艺的研发。到2011年,英飞凌无锡工厂将形成80亿片分立器件年生产能力,员工总数将达到2000人。目前,无锡工厂约有830名员工,主要封装、测试接触式和非接触式芯片卡和安全IC,以及用于消费、工业和汽车电子领域的分立器件,特别在车用分立器件上,无锡厂已是英飞凌主要供货基地。截至2008年12月,分立器件年产能已达27亿片、智能卡模块年产能为10亿片。
Reinhard表示,目前最为迫切的事是尽快启动项目的实施,把马来厂有铅小信号件生产线及相关工艺IP转到无锡来,“在危机过程中做好危机过去后满足市场需求的准备是非常重要的策略,分立器件的产能、技术转到无锡,就是为英飞凌下一阶段发展做好辅垫。”据悉,在生产设备完全到位后,无锡厂将满足中国本地及海外的汽车电子、无线通信市场对分立器件的需求。Reinhard说,“我们制定的目标计划是在市场不景气时完成项目的实施,而市场的需求特别是中国市场的需求已开始好转,所以搬迁工厂的事更显迫切。”不过,无锡中行、交行的信贷支持,也是英飞凌本次产能转移的重要推力,毕竟在全球金融危机的大背景下,有实力和勇气大额放贷的银行除中国外已不多见了。
英飞凌科技无锡厂目前主要采用SOT-232/8/16(未来以8/16为主)up、SOD-323封装形式。在先进塑封工艺上,目前拥有5条8up和2条16upSOT-23生产线、3条SOD323生产线,今年内将新增2条8upSOT-23生产线,从0.23×0.23mm到0.7×0.7mm的小尺寸热塑封SOT工艺良率,已从原先追求低PPM值提升至采用单条全测方案以保证零缺陷的实现。特别在2条16upSOT-23生产线机台配置上,分别采取了4台和2台生产线搭配方式,以适应客户需求灵活进行8up和16up塑封。据了解,为了减轻员工的工作强度,英飞凌无锡厂现实行的三班制将通过增加员工数实施四班制。
英飞凌无锡厂在发展的过程中不断引进最新的生产工艺和技术,7条FCOS工艺智能卡模块封装生产线,是英飞凌科技无锡厂另一支柱业务。FCOS(Flip Chip on Substrate)是英飞凌在业界率先采用的智能卡倒装封装技术,采用非卤素材料的FCOS工艺,通过导电触点与模块连接节省了原先所需的金属线。Reinhard表示,通过英飞凌全球制造资源的重新布局,无锡工厂在规模生产、物流供应、成本控制等重要环节将为公司制造业务设立起一个新的基准。
Reinhard指出,与其他半导体供应商一样英飞凌也在实施制造业务的Fab-lite策略,但外包业务并不包括后道封装。Reinhard说,在成熟的前道COMS技术领域,制造技术并不是决定性的因素,更多的有竞争性因素来自于芯片的设计。可在分立器件领域,产品的竞争优势却主要依赖于工艺技术,如FCOS(板上倒装芯片)和Chip Sandwich(芯片三明治)工艺,都是公司在工艺领域技术创新取胜的成功案例。所以,英飞凌对工艺的研发只会加强而不会削弱。未来两年,无锡工厂除生产制造外,通过与中国本地高校合作在生产工艺方面的创新也会有极大的增强。
通过更专注、更具规模化生产、更多本地化采购实现年降低成本20%,是英飞凌无锡厂要实现的目标,而寻求本地供应商合作也是英飞凌无锡厂努力的方向。Reinhard表示,在当地政府大力支持下,把公司其它地方的生产线转到中国不会是英飞凌投资无锡最后一个项目,公司正在评估其它一些投资项目,但目前尚无定论。据英飞凌亚太区总裁潘先弟介绍,本次英飞凌无锡增资计划从提出到协议的签署只用了3个月不到时间。




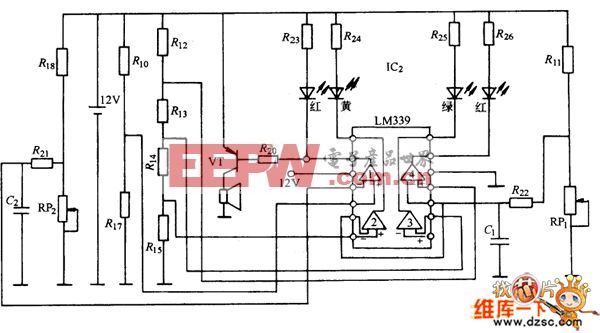




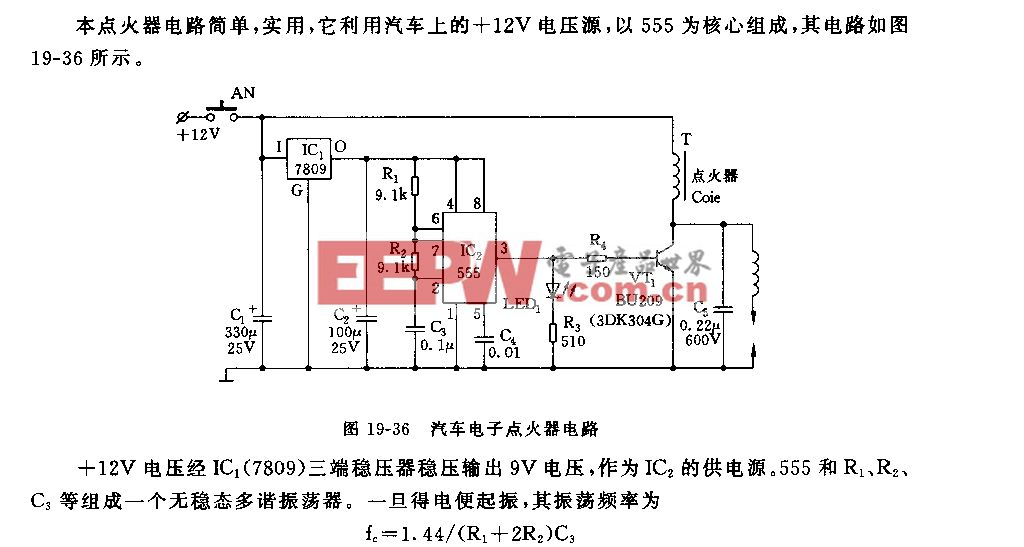
评论