WLR测试中所面临的新挑战
就像摩尔定律驱动半导体几何尺寸的缩小一样,有关解决半导体可靠性问题的活动也遵循一个似乎有点可以预测的周期。例如,技术演进到VLSI时,为了保持导线的电路速度,引入了铝线连接。此时,很快就发现了电子迁移这类的可靠性问题。一旦发现了问题所在,就会通过实验来对退化机制进行建模。利用这些模型,工艺工程师努力使新技术的可靠性指标达到最佳。随着技术的进一步成熟,焦点转移到缺陷的降低上面。而随着ULSI的引入,由于使用了应力硅、铜和低K介电材料等,又开始一轮新周期。
本文引用地址:https://www.eepw.com.cn/article/84509.htm随着引入的化合物材料的增加,可靠性方面的挑战继续加大。这些新挑战意味着可靠性测试日趋艰难,目前的测试设备已无法满足。在现有设备的能力与尚未满足的测试需求之间,可靠性和质保方面的工程师和研究人员正在面临日见扩大的差距。这种情况下要求测试仪器提供商和处于可靠性测试技术前沿的客户之间进一步通力合作。
可靠性测试发展趋势
目前业界正在寻求新型的半导体门介质材料,来解决超薄门所导致的漏电流增加。随着一些非常规的介电材料的引入,例如二氧化铪,此时众所周知的偏置温度不稳定(BTI)这类退化机制就变成非常严重的问题。固然,这些新材料可以降低门泄漏,从而降低静态工作点,但也导致门限电压和基带电压不稳定的问题。
除BTI之外,新一代的门堆叠(特别是高K金属门)显示时间取决于介质击穿(TDDB)特性,这与传统的SiO2材料极大不同。先前用于硬击穿和软击穿的模型比较好理解,然而这些新材料则呈现“渐进击穿(progressive breakdown)”。眼下的迫切任务就是要探索失效机制背后的物理特性的具体细节,随着这些材料进入工艺兼容性正在被优化的工程阶段,这一任务显得日益迫切。这些都要求一类新的测试设备,这些设备不仅要具有较好的测试功能,还要有丰富的处理功率(processing power),以适应创新的测试序列。
许多退化机制都是由阱电荷导致的结果。因此,需要对相对于器件的诱捕和释放(trapping and de-trapping)速率的参数退化量进行测量。测量必须在电应力去掉后迅速完成,而且应力条件还必须在测量完成后尽可能快地恢复。故绝大多数的老式仪器都无法满足这些要求。
此外,很明显,各种晶体管性能增强技术导致了器件可靠性和电路可靠性方面复杂的相互作用。例如,用来提高通道迁移率的应力硅工艺会恶化BTI性能。进一步说,门限电压的不稳定将会导致迁出电流提高,从而导致较高的结温。结温的升高将会加速介质泄漏和击穿。这些高级别的交互作用难以建模,并随机地导致失效。研发可靠的模型就需要相应的测试仪器,以便能够捕获大量的、具备统计意义的带有快速测试序列的测试样本。
电路中的晶体管间的交互作用甚至比单个晶体管内部的工作机制更复杂,故对其建模来说,大的数据集是尤其重要的。例如,P-MOS和N-MOS晶体管的退化方式就不一样。N-MOS容易导致BTI。结果,一个具有互补晶体管的电路来传送时钟信号时,在一个负载周期内或信号转换周期内会产生变化。此外,在不同的退化机制之间也会产生复杂的交互作用。例如,软介质击穿通常会导致泄露增加。尽管这不会导致晶体管彻底失效,但可以加速BTI。由于这些原因,需要捕获大量的具有统计意义的样本数,这意味着征集的数据点多达40000个或更多。
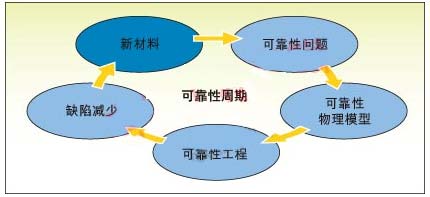
图1:半导体缺陷减少/可靠性改善周期。
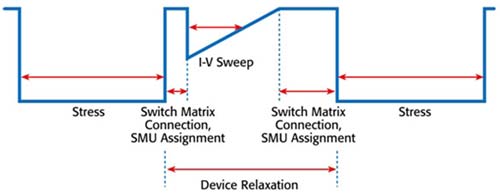
图2:多路的MSU不适合控制器件的弛豫时间。
旧式测试设备存在的问题
这些新挑战意味着可靠性测试正在变得更加困难,已经超出了现有测试硬件的能力。必须对BTI和渐进击穿这类的机制进行快速和精确的测量。利用架构间的多路技术这种老方法速度不够快。为了达到具有统计意义的样本量,并满足关键的定时要求,通常需要对每一个架构使用专用的源和测量硬件。
利用一般的传统测量系统来进行可靠性测试将会产生下列问题:
1. 低成本单通道系统通常依赖开关来减少所需的SMU的数量;这意味着应力测量转换很慢。利用多路技术来连续监控每个测试架构也是不可能的。这也就意味着真正的并联测试是不可能的;
2. 由于较差的定时和响应时间通常也无法捕获重要的瞬变事件,也会导致不好控制驰豫时间;
3. 仪器中的处理器可编程和判决能力受到限制。这也意味着像数据稀释之类的更有潜在价值的处理器的利用也是不可能的;
4. 许多传统系统的缓冲容量大约只有5,000;这对于像捕获一个完整的低K金属门失效数据这类的绝大多数可靠性测试的需求来说实在太小。
传统测试系统的软件架构如图3所示。通常,中央控制器是一台运行SMU控制库的计算机。这些库中包含与所有SMU相关活动的测试程序,包括判决程序。

图3:传统测试系统的软件架构。
这类架构的一个主要缺点就是中央控制器必须照顾到测试程序中的每一步。例如,在标准的等温电迁移测试中,为了保证测试架构的各个地方的温度恒定,需要对电流进行动态调整。SMU采集电流并测量电阻。然后将GPIB总线上的电阻值报告给中央控制器。控制器计算温度,然后决定下一个采集的电流。带有一个新电流值的下一条指令被送到SMU,然后送到GPIB总线上。该过程对于几百个也许是数千个数据点不断重复。通常这种情况要调用所有的程序,许多情况下总线延迟是一个严重的问题。
新一代的测试设备
目前有一种新的测试系统架构,基于“智能”的SMU,能够提供更高的吞吐量,更好的测试完整性,更大的灵活度,以及总体上更强的信息处理和判决能力。这是由于在设备中内嵌了一个满32位的测试脚本处理器(TSP),该处理器运行全功能编程语言。该类智能SMU被用在Keithley2600系列的SourceMeter仪器中。
由于具有类似计算机的计算能力,2600系列SourceMeter测试系统中的软件架构有所改变(图4)。注意现在控制测试程序连同所有的判决的职责都转移到了仪器上,而中央控制器(计算机)只保留了对嵌入式测试脚本和数据管理进行功能调用的职责。
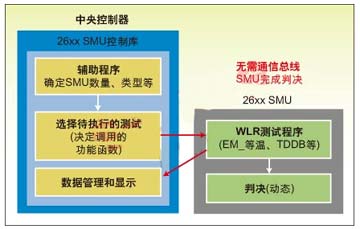
图4:基于智能SMU概念的新型软件架构。
具有更复杂判决的客户测试程序可以驻留在仪器中。SMU不再需要通过GPIB将数据返回到计算机控制程序,而是等待判决和下一个指令。简言之,总线延迟将不再是一个问题-测试可以以更自动的方式进行,而且执行速度更快。
该仪器的TSP脚本语言基于众所周知的开放源语言引擎,其在视频游戏开发者中间有大量沿用。该脚本语言设计得简单,效率高,轻便且嵌入成本低。该语言值得设计师称颂的是具有小脚本的快速语言引擎,对于嵌入式系统特别理想。似乎其所有所需的都是为复杂判决而构建的,还有其他丰富的功能-不过这些都超越了文本的讨论范畴。 尽管可以使用任意的字处理器来编写测试脚本,2600系列SourceMeter还是带有一个方便的脚本构建工具-测试脚本生成器。一旦书写后,脚本可以存储在2600中的非易失性缓冲器中。从软件移植的观点出发,绝大多数的用户测试序列都可以在该仪器中实现。在很多情况下,将一个功能调用到嵌入式测试脚本中,使用一个单GPIB写命令,将会生成整个测试序列。
一般地,基于2600系统的软件配置包括两个主要部分,见图5。

图5 :2600系列SourceMeter的软件架构的两个主要部分。
1. 一个驻留在计算机中的GUI,用于读取用户输入和显示数据
2. 驻留在2600主机中的测试脚本,用来对所有的测试程序和判决进行排序。
注意,任何其程序基于计算机的GUI的主要职责现在仅限于进行测试参量和选择方面的功能调用,还有数据显示和管理。
为了适应日益增长的处理需求,2600系列还大大增强了数据存储能力。这包括多路非易失性缓冲器,能够存储用于每个SMU的大约5万个测量和时间印记数据对。此外,还为每个SMU配备了多路易失性缓冲器。实际上,用户可以为易失性缓冲器创建和规定所需的存储容量。该缓冲器时间印记的分辨率为1微妙,定时精度为百万分五十。
系统架构和并行测试
为了进一步利用增强的处理能力,2600系列还有另一个独特功能,就是具备“无主机(mainframe-less)”扩展能力。该功能允许多路的SourceMeter利用称为TSP-Link?的内部单元通信总线联系到一起,该总线采用标准的以太网电缆。通过利用这一虚拟架构,所有的SMU就像位于同一个大型主机系统中一样。主机单元占据一个GPIB地址,它可以通过TSP-Link总线来控制128个SMU。主机单元运行用户书写的嵌入式脚本并作为受其控制的所有SMU的判决单元。
该功能在满足特定的测试需求的系统架构中提供了空前的灵活度。可以根据测试的强度,或者根据需要的并行测试数量,来设计系统使其具有适当的主机单元数量。图6a中,系统只有一个主机单元,控制16个SMU(每个单元中有两个SMU);而在6b中,则有四个主机单元,每一个分别控制四个SMU。由一个主机单元控制一组SMU就是众所周知的“通道组”技术。

图6a 具有一个控制16个SMU(每个仪器中有两个SMU)的主机单元的多通道测试系统

图6b :利用一个主机单元控制一个通道组中的四个SMU、并共有四个通道组的多通道测试系统。
注意只有要求2600作为主机单元时它才占用一个GPIB地址。图6b的配置特别适合于每个测试端口需要一个SMU的四端口器件。因为每个通道足有一个控制该通道组内所有SMU的主机单元,因此在并行测试时配置非常方便。特别地,测试脚本库要预装载到所有的主机单元中,然后只需对带有用户输入参数的脚本进行一次功能调用就可以运行测试。GUI软件需要做的所有事情就是通过GPIB写入线发送带有用户输入参数的功能调用。如果在并行测试时需要更高的同步性能,计算机可以向所有的主机单元发送一个GPIB组触发信号,它可以启动组内SMU上测试程序的运行。出于这一工作安排,GUI程序上仅需的主要功能就是具有基本的GPIB功能-即GPIB读取,GPIB写入等。
图6b中的安排与将处理电源分布到网络中的各个地方的现代计算机网络也有点类似。具有许多“从”端设备的单独的中央处理器架构已是过时。在2600系列基础测试系统中也采用了分布式技术,将运行测试功能和判决的职责分布到所有的主机单元上。
与处理能力相匹配的硬件性能
Keithley2600系列的源测量硬件引擎的多功能性是无可比拟的。其高速度允许捕获瞬变行为,而且每秒征集的读数高达10,000个,或者说每秒多达5,500个源测量点。
该力感应电路(图7)带有力(输入/输出)“高(Hi)”/“低(Lo)”和感应“高(Hi)”/“低(Lo)引端,对于返回电流允许使用力Lo或感应Lo引端。2600系列的力Lo和感应Lo与底盘地电气隔离,故一个单独的SMU就能执行全4线开尔文测量。这是许多测试协议中的显著优点,如电迁移协议,因为在每个采样架构中仅需要一个SMU。因为不需要公共地,故对于2600基础平台来说,测量多路器件不再是问题。
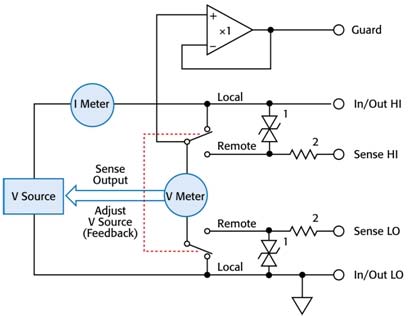
图7:2600系列的力感应电路(含源电压配置)。
所有的2600系列仪器都具备四象限操作(图8),使得他们能够适应于更广的应用,他们可以用作为源或接收器(负载)。
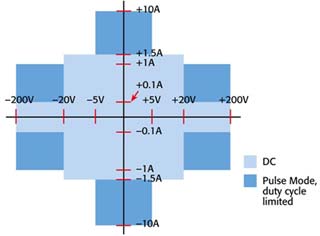
图8:Keithley2611和2612的四象限工作参数。
更进一步,每一个SMU含有两个A/D变换器,可以同时进行电流和电压测量。于是减少了延迟并增加了测试吞吐率。另外可以方便地对该系统的规模进行升级,见图9。

图9:构建升级系统非常容易,可以实现高达896个SMU通道。
充分利用SMU测试序列(可选)
在从单一源-测试仪器向SMU转换时,吞吐率方面最大的收益来自于系统程序的改变。不再用基于计算机的控制,而是让SMU的测试序列器和程序存储器来控制测试。这就充分利用了SMU的许多特色和功能,例如四象限操作,电压和电流扫描,内置的波形产生器,程序深存储器,皮秒级的灵敏度,5位半数字分辨率,判定测试通过与否的测量比较器,以及用来控制其它设备的I/O接口。
所有这些功能把Keithley 2600系列SMU提升到了一个新高度。其嵌入式测试脚本程序增强了灵活性,自动执行测试的能力非常强大。用户可以利用一台仪器实现很多应用,硬件/软件集成任务大为简化。人们能够容易地为精密DC、脉冲、低频AC源-测试构建具备成本效益、可升级、具有大吞吐率的测试解决方案。
2600系列仪器在I-V可靠性测试应用中,能够提供比其竞争对手高2-4倍的测试速度。还能提供更高的源-测量通道密度和低成本。在每个测试点上,模数转换器提供小于100?s的电流和电压的同时测量,源-测量扫描速度小于230?s。其高速的源-测量能力,加上嵌入式测试脚本,使得吞吐率比通过GPIB来运行基于计算机的程序提高了多达10倍。
结论
目前半导体测试又一次面临新兴的测试需求远远超过了现有系统能够提供的能力的局面。需要改变测试系统架构来成功满足新的测试需求。Keithley 2600系列代表新一代的智能SMU,其架构能够提供高吞吐率,数据完整性,在半导体可靠性测试项目所需的扩展和重新改变用途方面具有很大的灵活性。
dc相关文章:dc是什么
模数转换器相关文章:模数转换器工作原理
晶体管相关文章:晶体管工作原理
电荷放大器相关文章:电荷放大器原理 晶体管相关文章:晶体管原理
















评论