微电子工艺专有名词(2)
——
52 DRIVE IN 驱入 离子植入(ion implantation)虽然能较精确地选择杂质数量,但受限于离子能量,无法将杂质打入芯片较深(um级)的区域,因此需借着原子有从高浓度往低浓度扩散的性质,在相当高的温度去进行,一方面将杂质扩散道教深的区域,且使杂质原子占据硅原子位置,产生所要的电性,另外也可将植入时产生的缺陷消除。此方法称之驱入。在驱入时,常通入一些氧气,因为硅氧化时,会产生一些缺陷,如空洞(Vacancy),这些缺陷会有助于杂质原子的扩散速度。另外,由于驱入世界原子的扩散,因此其方向性是各方均等,甚至有可能从芯片逸出(out-diffusion),这是需要注意的地方。
53 E-BEAM LITHOGRAPHY 电子束微影技术 目前芯片制作中所使用之对准机,其曝光光源波长约为(365nm~436nm),其可制作线宽约1μ之IC图形。但当需制作更细之图形时,则目前之对准机,受曝光光源波长之限制,而无法达成,因此在次微米之微影技术中,及有用以电子数为曝光光源者,由于电子束波长甚短(~0.1A),故可得甚佳之分辨率,作出更细之IC图型,此种技术即称之电子束微影技术。电子束微影技术,目前已应用于光罩制作上,至于应用于光芯片制作中,则仍在发展中。
54 EFR(EARLY FAILURE RATE) 早期故障率 Early Failure Rate是产品可靠度指针,意谓IC到客户手中使用其可能发生故障的机率。当DRAM生产测试流程中经过BURN-IN高温高压测试后,体质不佳的产品便被淘汰。为了确定好的产品其考靠度达到要求,所以从母批中取样本做可靠度测试,试验中对产品加高压高温,催使不耐久的产品故障,因而得知产品的可靠度。故障机率与产品生命周期之关系类似浴缸,称为Bathtub Curve.
55 ELECTROMIGRATION 电子迁移 所谓电子迁移,乃指在电流作用下金属的质量会搬动,此系电子的动量传给带正电之金属离子所造成的。当组件尺寸越缩小时,相对地电流密度则越来越大;当此大电流经过集成电路中之薄金属层时,某些地方之金属离子会堆积起来,而某些地方则有金属空缺情形,如此一来,堆积金属会使邻近之导体短路,而金属空缺则会引起断路。材料搬动主要原动力为晶界扩散。有些方法可增加铝膜导体对电迁移之抗力,例如:与铜形成合金,沉积时加氧等方式。
56 ELECTRON/HOLE 电子/ 电洞 电子是构成原子的带电粒子,带有一单位的负电荷,环绕在原子核四周形成原子。垫洞是晶体中在原子核间的共享电子,因受热干扰或杂质原子取代,电子离开原有的位置所遗留下来的“空缺”因缺少一个电子,无法维持电中性,可视为带有一单位的正电荷。
57 ELLIPSOMETER 椭圆测厚仪 将已知波长之射入光分成线性偏极或圆偏极,照射在待射芯片,利用所得之不同椭圆偏极光之强度讯号,以Fourier分析及Fresnel方程式,求得待测芯片模厚度
58 EM(ELECTRO MIGRATION TEST) 电子迁移可靠度测试 当电流经过金属导线,使金属原子获得能量,沿区块边界(GRAIN Bounderies)扩散(Diffusion),使金属线产生空洞(Void),甚至断裂,形成失效。其对可靠度评估可用电流密度线性模型求出:AF=【J(stress)/J(op)】n




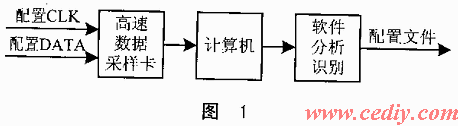

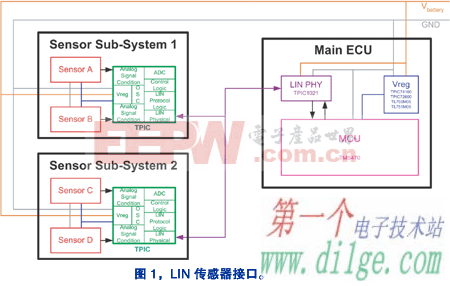





评论