微电子工艺专有名词(1)
——
2 ACTONE 丙酮 1. 丙酮是有机溶剂的一种,分子式为CH3COCH3。2. 性质为无色,具刺激性及薄荷臭味之液体。3. 在FAB内之用途,主要在于黄光室内正光阻之清洗、擦拭。4. 对神经中枢具中度麻醉性,对皮肤黏膜具轻微毒性,长期接触会引起皮肤炎,吸入过量之丙酮蒸汽会刺激鼻、眼结膜及咽喉黏膜,甚至引起头痛、恶心、呕吐、目眩、意识不明等。5. 允许浓度1000PPM。
3 ADI 显影后检查 1.定义:After Developing Inspection 之缩写2.目的:检查黄光室制程;光阻覆盖→对准→曝光→显影。发现缺点后,如覆盖不良、显影不良…等即予修改,以维护产品良率、品质。3.方法:利用目检、显微镜为之。
4 AEI 蚀刻后检查 1. 定义:AEI即After Etching Inspection,在蚀刻制程光阻去除前及光阻去除后,分别对产品实施全检或抽样检查。2.目的:2-1提高产品良率,避免不良品外流。2-2达到品质的一致性和制程之重复性。2-3显示制程能力之指针2-4阻止异常扩大,节省成本3.通常AEI检查出来之不良品,非必要时很少作修改,因为重去氧化层或重长氧化层可能造成组件特性改变可靠性变差、缺点密度增加,生产成本增高,以及良率降低之缺点。
5 AIR SHOWER 空气洗尘室 进入洁净室之前,需穿无尘衣,因在外面更衣室之故,无尘衣上沾着尘埃,故进洁净室之前,需经空气喷洗机将尘埃吹掉。
6 ALIGNMENT 对准 1. 定义:利用芯片上的对准键,一般用十字键和光罩上的对准键合对为之。2. 目的:在IC的制造过程中,必须经过6~10次左右的对准、曝光来定义电路图案,对准就是要将层层图案精确地定义显像在芯片上面。3. 方法:A.人眼对准B.用光、电组合代替人眼,即机械式对准。
7 ALLOY/SINTER 熔合 Alloy之目的在使铝与硅基(Silicon Substrate)之接触有Ohmic特性,即电压与电流成线性关系。Alloy也可降低接触的阻值。
8 AL/SI 铝/硅 靶 此为金属溅镀时所使用的一种金属合金材料利用Ar游离的离子,让其撞击此靶的表面,把Al/Si的原子撞击出来,而镀在芯片表面上,一般使用之组成为Al/Si (1%),将此当作组件与外界导线连接。
9 AL/SI/CU 铝/硅 /铜 金属溅镀时所使用的原料名称,通常是称为TARGET,其成分为0.5﹪铜,1﹪硅及98.5﹪铝,一般制程通常是使用99﹪铝1﹪硅,后来为了金属电荷迁移现象(ELEC TROMIGRATION)故渗加0.5﹪铜,以降低金属电荷迁移。
10 ALUMINUN 铝 此为金属溅镀时所使用的一种金属材料,利用Ar游离的离子,让其撞击此种材料做成的靶表面,把Al的原子撞击出来,而镀在芯片表面上,将此当作组件与外界导线之连接。
11 ANGLE LAPPING 角度研磨 Angle Lapping 的目的是为了测量Junction的深度,所作的芯片前处理,这种采用光线干涉测量的方法就称之Angle Lapping。公式为Xj=λ/2 NF即Junction深度等于入射光波长的一半与干涉条纹数之乘积。但渐渐的随着VLSI组件的缩小,准确度及精密度都无法因应。如SRP(Spreading Resistance Prqbing)也是应用Angle Lapping的方法作前处理,采用的方法是以表面植入浓度与阻值的对应关系求出Junction的深度,精确度远超过入射光干涉法。
12 ANGSTRON 埃 是一个长度单位,其大小为1公尺的百亿分之一,约为人的头发宽度之五十万分之一。此单位常用于IC制程上,表示其层(如SiO2,Poly,SiN….)厚度时用。
13 APCVD(ATMOSPRESSURE) 常压化学气相沉积 APCVD为Atmosphere(大气),Pressure(压力),Chemical(化学),Vapor(气相)及Deposition(沉积)的缩写,也就是说,反应气体(如SiH4(g),B2H6(g),和O2(g))在常压下起化学反应而生成一层固态的生成物(如BPSG)于芯片上。
14 AS75 砷 自然界元素之一;由33个质子,42个中子即75个电子所组成。半导体工业用的砷离子(As+)可由AsH3气体分解得到。砷是N-TYPE DOPANT 常用作N-场区、空乏区及S/D植入。
15 ASHING,STRIPPING 电浆光阻去除 1. 电浆预处理,系利用电浆方式(Plasma),将芯片表面之光阻加以去除。2. 电浆光阻去除的原理,系利用氧气在电浆中所产生只自由基(Radical)与光阻(高分子的有机物)发生作用,产生挥发性的气体,再由帮浦抽走,达到光阻去除的目的。3. 电浆光组的产生速率通常较酸液光阻去除为慢,但是若产品经过离子植入或电浆蚀刻后,表面之光阻或发生碳化或石墨化等化学作用,整个表面之光阻均已变质,若以硫酸吃光阻,无法将表面已变质之光阻加以去除,故均必须先以电浆光阻去除之方式来做。
16 ASSEMBLY 晶粒封装 以树酯或陶瓷材料,将晶粒包在其中,以达到保护晶粒,隔绝环境污染的目的,而此一连串的加工过程,即称为晶粒封装(Assembly)。封装的材料不同,其封装的作法亦不同,本公司几乎都是以树酯材料作晶粒的封装,制程包括:芯片切割→晶粒目检→晶粒上「架」(导线架,即Lead frame)→焊线→模压封装→稳定烘烤(使树酯物性稳定)→切框、弯脚成型→脚沾锡→盖印→完成。以树酯为材料之IC,通常用于消费性产品,如计算机、计算器,而以陶瓷作封装材料之IC,属于高性赖度之组件,通常用于飞弹、火箭等较精密的产品上。
17 BACK GRINDING 晶背研磨 利用研磨机将芯片背面磨薄以便测试包装,着重的是厚度均匀度及背面之干净度。一般6吋芯片之厚度约20mil~30 mil左右,为了便于晶粒封装打线,故需将芯片厚度磨薄至10 mil ~15mil左右。
18 BAKE, SOFT BAKE,HARD BAKE 烘烤,软烤,预烤 烘烤(Bake):在集成电路芯片上的制造过程中,将芯片至于稍高温(60℃~250℃)的烘箱内或热板上均可谓之烘烤,随其目的的不同,可区分微软烤(Soft bake)与预烤(Hard bake)。软烤(Soft bake):其使用时机是在上完光阻后,主要目的是为了将光阻中的溶剂蒸发去除,并且可增加光阻与芯片之附着力。预烤(Hard bake):又称为蚀刻前烘烤(pre-etch bake),主要目的为去除水气,增加光阻附着性,尤其在湿蚀刻(wet etching)更为重要,预烤不全长会造成过蚀刻。
19 BF2 二氟化硼






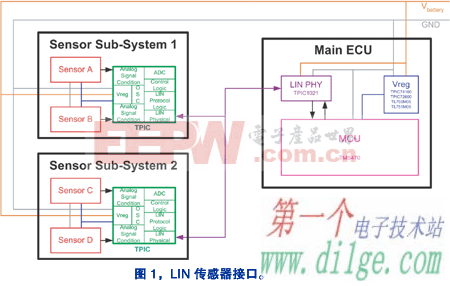
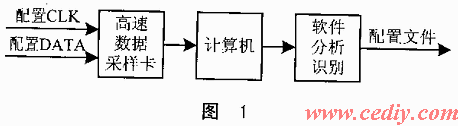




评论