检测10nm以下半导体 CD-SEM量测技术迈大步
半导体进入10奈米以下技术节点或三维(3D)结构时,将面临严重的导孔偏移问题,所幸,设备商已研发出具备更高影像解析能力的微距量测扫描式电子显微镜(CD-SEM),可提供更清晰的对焦和更精细的量测影像,有效克服导孔对准挑战。
本文引用地址:https://www.eepw.com.cn/article/261910.htm多年来,业界一直使用微距量测扫描式电子显微镜(CD-SEM)来进行量测,此种显微镜会射出电子束,与要扫描的材料作用,然后回传讯号,再由量测机台比对运算这些讯号。今日,针对小于10奈米(nm)的尺寸,CD-SEM或其他所有量测设备,必须处理更多的薄膜层、更高的纵横比(HAR)、更窄的间距,以及三维(3D)架构的轮廓和形状,人们对于这些设备是否具备此等能力,提出严重的质疑。
在量测技术、多重微影技术与材料的改良下,半导体装置的3D记忆体与临界尺寸(CD)能够沿用到小于10奈米制程。在10奈米制程上,元件的复杂度不断提高,使得目前的光微影技术遭遇到极为重大的挑战。鳍式场效电晶体(FinFET)与3D储存型快闪记忆体(NANDFlash)设计,让需要量测与控制的参数持续增加,进一步提高图案制作与量测的复杂性。
技术新突破CD-SEM量测精准度受瞩目
应用材料对CD-SEM技术进行重大的改良,在最近于加州举行的国际光学工程学会(SPIE)先进微影技术研讨会上,展示这项量测技术的可沿用性。此项改良技术的主要应用,包括有效将新的先进CD-SEM技术应用于逻辑导孔(LogicVias)、复杂的叠层(Overlay)、超高纵横比的先进记忆体(HARContacts)等高难度制程挑战。
CD-SEM已可做为有效量测技术
从图1可看出在沟槽内导孔底部临界尺寸与对准方面,所面临的量测与监控挑战--导孔的边缘与位置必须精确,才能确保底层与叠覆金属层间的正确连结。位在右侧的导孔并未与下方的铜线对准,将会影响到各层间的导电性;底下的SEM影像则显示偏移与对准导孔间的差异。这两组关键影像,都是采用称为背向散射电子(BSE)影像技术取得,这项技术正成为可行的量测技术。这个例子显示,在此等复杂的多步骤制程中,可使用CD-SEM做为有效的量测与对准技术。
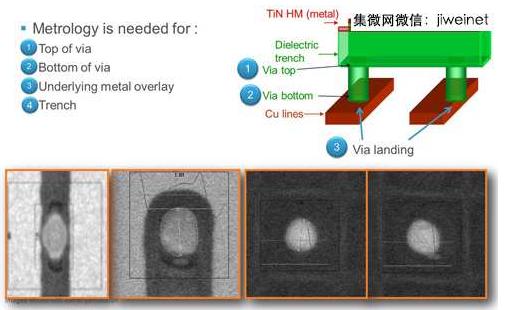
图1沟槽中的导孔影像,由Fischer博士等人在2013年SPIE会议上发表。
CD-SEM拥有高解析影像显示能力
由于目前的CD-SEM技术不够精确,若要针对小于10奈米尺寸找出导孔对准的问题,则须提高扫描电子显微镜(SEM)的解析度。由于制程必须一路往下对准底部抗反射涂层(BARC)、硬质罩幕层,以及金属(接点或鳍片),因此今日业界的新发展,是使用数千伏特能源的SEM来「透视」到最低层,比较先进CD-SEM与传统SEM技术,可看出在透视材料时,拥有更高解析度影像显示能力。
CD-SEM可结合BSE讯号轻取导孔真实影像
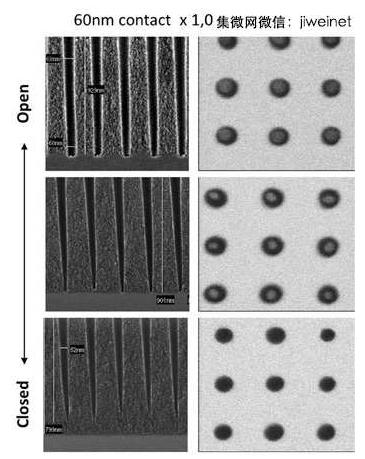
图2中最上方的SEM显示适当蚀刻后的接触导孔,导孔完全蚀刻穿透,而下图中的导孔则未完全穿透,须要在进行沉积前修正。能够针对此等HAR接触导孔取得影像,是因为使用改良的侦测与收集技术。结合BSE讯号与增强的过滤技术(只针对碰到底层表面后返回的电子,运用其讯号),就能够取得底层的影像,并传回HAR导孔的真实影像。
2D升级3D量测技术迭有突破
除了以上范例成功针对小于10奈米尺寸运用CD-SEM技术外,应用材料也提出先前所述应用的案例,将CD-SEM应用于FinFET电晶体与矽奈米线3D量测。前述的这些主题都有一个共通点,就是能够让受到光微影限制的2D影像缩放技术,转换为以量测与材料为主的3D图案影像技术。
幸运的是,量测技术的进展正在克服主要的制程微缩问题。小于10奈米结构与3D记忆体需要更高解析度的SEM,提供更清晰的对焦、更精细的影像与资料撷取方法,以及对形状更为敏感、以物理学为基础的模型和模拟技术。未来也会须要结合不同的量测技术,包括CD-SEM、CD原子力显微镜(AFM),以及穿透式电子显微镜(TEM)。
















评论