助力高级光刻技术:存储和运输EUV掩模面临的挑战
引言
本文引用地址:https://www.eepw.com.cn/article/201907/402257.htm随着半导体行业持续突破设计尺寸不断缩小的极限,极紫外 (EUV) 光刻技术的运用逐渐扩展到大规模生产环境中。对于 7 纳米及更小的高级节点,EUV 光刻技术是一种能够简化图案形成工艺的支持技术。要在如此精细的尺寸下进行可靠制模,超净的掩模必不可少。
与所有掩模一样,用于 EUV 光刻的掩模依靠掩模光罩盒实现安全存储,以及保护它们免受光刻图案形成、检测、清洁和修复的影响。防护光罩盒必须能够使用多年,而且不会造成有害的污染或物理损坏。
专为 193 纳米沉浸式光刻而设计的光罩盒无法为 EUV 掩模提供足够的保护。EUV 光刻的独特要求对光罩盒提出了额外的限制条件和要求,使得 EUV 掩模光罩盒成为一种具有多个关键元件且高度专业化的设备。
本文介绍了为 EUV 光刻设计光罩盒所面临的内在挑战, 并提出了解决方案以便让更多晶圆厂能够在其工厂中采用先进的光刻节点。
保护EUV掩模
光刻图案越精细,发生掩模污染的风险就越高。潜在污染源包括外来颗粒和化学残留物。掩模涂层比较脆弱,容易损坏。接触掩模的任何物体都可能造成损坏,无论是意料之中的制程部件(例如,晶圆厂里的机械臂),还是意外污染物(例如,人的毛发)。
沉浸式光刻采用薄膜作为“防尘罩”,以保护掩模在图案曝光期间免受颗粒污染。薄膜需要是光学透明的,从 EUV 光刻角度来说,这意味着它们必须对波长约 13.5 纳米的EUV 光谱中的光透明。现有的大多数薄膜材料都会吸收EUV 光,但半导体行业已开始采用 EUV 专用薄膜(见图 1)。
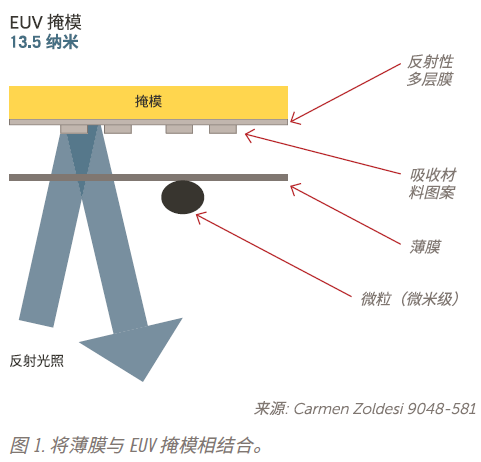
在薄膜成为 EUV 光刻技术的使用标准之前,EUV 光罩盒需要保护没有添加薄膜的掩模。用于 EUV 光刻的 NXE 机台需要采用双光罩盒配置,包括处于真空条件下的金属内光罩盒以及与周围环境接触的外光罩盒。内光罩盒只有在处于机台设备内部时才会打开。
双光罩盒配置是 EUV 光刻的标准惯例,而且这种光罩盒可以在市场上买到。虽然它们很容易买到,但不能因此就将它们视为商品。EUV 光罩盒设计(见图 2)会不断改进,以满足性能和光刻产率的要求。

尽管双光罩盒配置可以提供保护,但发生污染的可能性依然很大。因此,开发 EUV 光罩盒时必须考虑如何降低污染风险。尤其是对于没有添加薄膜的掩模,内光罩盒起着主要保护作用,但也是潜在污染物的主要来源。
光罩盒的设计考量包括内外光罩盒的几何结构及其制作材料。
材料清洁度
接触或围绕掩模的所有表面(包括光罩盒的表面)都必须保持超净,避免以颗粒或通过空气传播的化学蒸气的形式引入有害污染物。
聚合物放气会产生不良化学污染物,而且它们会沉积在掩模表面。因此,应秉持着最大限度减少放气可能性的目标来选择光罩盒材料。内光罩盒由金属制成,不会发生释气。但是,外光罩盒是采用聚合物制成的,正如非 UV 光刻中使用的单掩模光罩盒。
践行的缩小设计准则使得无污染环境更为重要,因为即使很小的污染颗粒也很有可能导致图案转移错误和良率损失。
确保有效的机械保护
在晶圆厂内和工厂之间运输过程中,例如通过空运或陆运从掩模工厂运输到集成器件制造商 (IDM) 时,光罩盒必须妥善保护其中的掩模。不仅需要保护光罩盒中的掩模,还需要尽量减少接触力过高所引起的机械损伤,这两者之间存在微秒的平衡。如果阻力过小,掩模将无法承受运输过程中出现的机械加速和振动,并将遭到损坏。
如果接触片的阻力过大,将在掩模上造成过多的接触痕迹。若是掩模边缘的玻璃被刮掉,玻璃颗粒就会成为导致光刻缺陷的污染物。从颗粒产生的角度来看,接触力越小越好。
只要光罩盒能够将掩模牢牢固定在原位即可,接触点越少,光罩盒引起颗粒污染的可能性就越低。接触点的大小同样很重要。接触面越大,光罩盒关闭时的接触应力就越小。
光罩盒材料的选择对于尽可能减少接触痕迹也至关重要。理想的光罩盒材料能够抵抗在固定掩模以及打开和关闭光罩盒时的磨损。
净化光罩盒
需要定期净化外光罩盒以除去内部的水分,为掩膜保持干洁的环境。净化气体(极净的干燥空气 (XCDA) 或氮气)通过进气口进入外光罩盒即可进行净化。
虽然净化期间的大部分气体交换都发生在外光罩盒中, 但在净化或 NXE 机台内的真空抽气和排气过程中,确实会有一些气体流入和流出内光罩盒。内光罩盒中内置有过滤器,可用于进行气体分子的交换,并最大限度减少进入内光罩盒的颗粒。处于关闭状态时,还需对内光罩盒进行密封,从而几乎所有气体交换都通过过滤器完成,而不是任何密封漏洞。
在理想的设计中,过滤器传导性(对气体流经过滤器的能力的衡量)应显著高于密封传导性,从而进入内光罩盒的空气中至少有 90% 是经由过滤器进入的。
内光罩盒中的过滤器必须有足够的渗透性,以允许充足的气流进入,但还要足够稳固,以便能够承受清洁的力度。为了实现适当的平衡,必须要谨慎选择过滤器材料和几何结构。
如果颗粒通过盖板和基板之间的密封处进入掩模,则掩模和基板之间的间隙尺寸应尽可能小,以确保颗粒处于掩模外边缘,而不是转移到可能导致良率损失的活跃区(见图 3)。
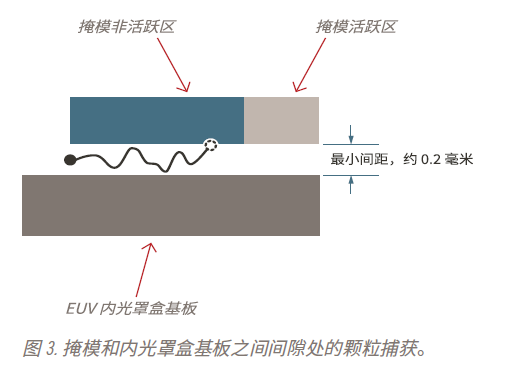
设备兼容性
大部分光刻制程都是自动执行,处理光罩盒的机械臂需始终能与光罩盒尺寸相匹配。尺寸方面几乎没有调整的空间,光罩盒必须与标准机械接口兼容。光罩盒的设计使用寿命为七到十年,因此新设备需要与现有光罩盒向后兼容。
光罩盒的预期使用寿命较长,这意味着它们会在多年内经历数千次的开/关循环。使用抗磨损材料既能最大限度地减少颗粒污染,又能延长光罩盒的使用寿命。
掩模光罩盒的光学窗口必须与自动化设备兼容。光刻机中的摄像头需要能够观察光罩盒内部以便正确检测掩模情况,这对光罩盒中窗口的反射性和平整度提出了严格的要求。
安置薄膜
掩模光罩盒需要能够使用多年,因而它们必须满足当前和未来 EUV 光刻的要求。因此,现今的光罩盒设计人员应该考虑设计两款光罩盒,一款具有可容纳薄膜的空间,另一款可在不添加薄膜的情况下使用。可通过添加薄膜袋来修改内光罩盒,但仍要满足光罩盒的整体尺寸和重量要求。
要设计与薄膜兼容的光罩盒,光罩盒制造商、薄膜供应商和光刻机制造商需要密切协作。自动化设备假定内光罩盒的重量变化范围很小,这意味着在为了制作薄膜袋而去除一部分材料后,必须在光罩盒的其他地方添加相近的重量。确定内光罩盒中接触点和窗口的位置时,必须考虑薄膜的几何结构。
薄膜极其易碎。在进行光刻操作期间,真空净化和通风会导致内光罩盒中发生压力变化。必须将此压差控制在特定阈值以下,从而过度偏转也不会损坏薄膜。在与薄膜兼容的内光罩盒中正确放置窗口可以提供可见性,这样光刻机就能够检测薄膜损坏情况。
EUV 设备必须能够处理带有或不带薄膜的掩模,并能够区分这两种掩模之间的区别。如果不小心将带有薄膜的掩模放入没有薄膜袋的光罩盒,将会对薄膜造成不可挽回的损伤。内光罩盒应包含相应设计功能,确保 EUV 设备中的摄像头能扫描并光学检测出光罩盒类型,从而降低错误识别光罩盒的风险。
总结
EUV 掩模光罩盒是一种高度专业化的设备,在 EUV 光刻中起着至关重要的作用。在使用、存储和运输过程中,它们必须保护掩模,同时确保不引入其他污染物或导致损坏。光罩盒必须与光刻设备兼容,还要能够保持为掩模提供干洁的环境。对于带有和不带薄膜的掩模,精确设计的双光罩盒配置可以实现这些目标,从而确保 EUV 光刻技术满足未来发展需求。
参考文献
1 Zoldesi, C.,2014 SPIE Advanced Lithography, San Jose CA, 9048-54,幻灯片 21
https://staticwww.asml.com/doclib/misc/asml_20140306_EUV_lithography_-_NXE_platform_performance_ overview.pdf



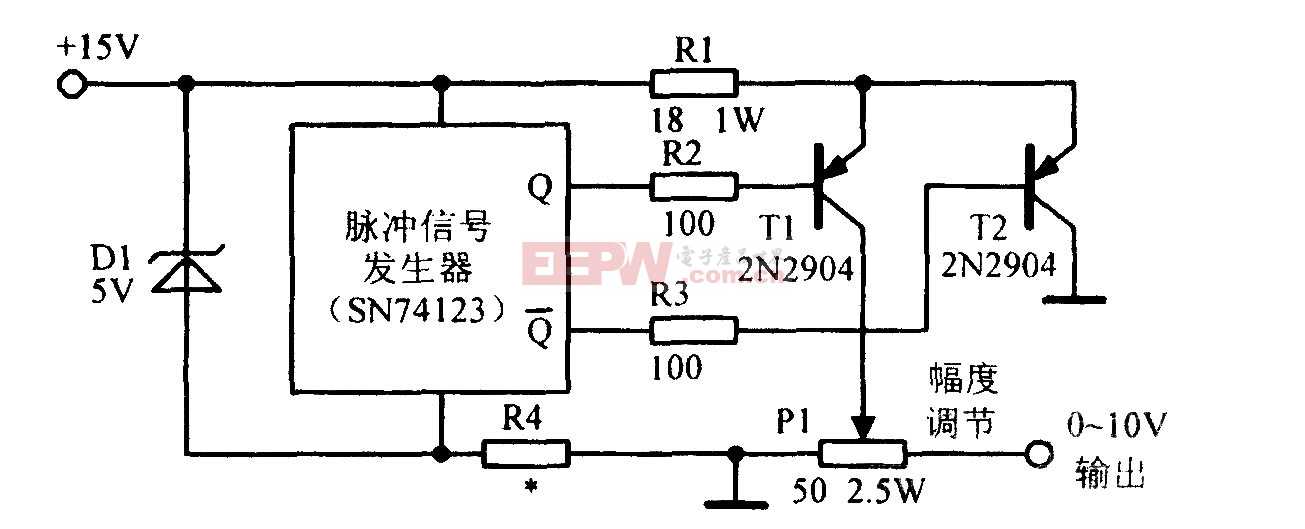

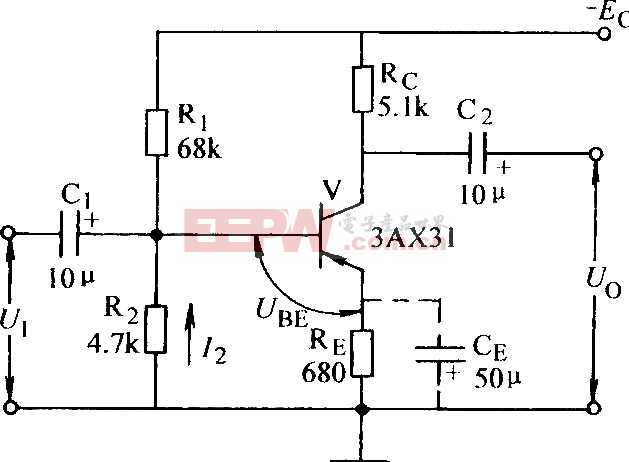







评论