基于magnum 2 测试系统的NAND FLASH VDNF64G08RS50MS4V25-III的测试技术研究
摘要:NAND FLASH在电子行业已经得到了广泛的应用,然而在生产过程中出现坏块和在使用过程中会出现坏块增长的情况,针对这种情况,本文介绍了一种基于magnum II 测试机的速测试的方法,实验结果表明,此方法能够有效提高FLASH的全空间测试效率。另外,针对NAND FLASH的关键时序参数,如tREA(读信号低电平到数据输出时间)和tBERS(块擦除时间)等,使用测试系统为器件施加适当的控制激励,完成NAND FLASH的时序配合,从而达到器件性能的测试要求。
本文引用地址:https://www.eepw.com.cn/article/201710/370011.htm关键词:magnum II,VDNF64G08RS50MS4V25-III,NAND FLASH
1. 引言
NAND FLASH是一种廉价、快速、高存储密度、大容量的非易失性存储器,广泛应用在需要存储大量数据的场合。由于其块擦除、页编程比较快和容量比较大。NAND FLASH通常会伴随坏块,所以出产时会有坏块标记,这些坏块通常不使用,而没有标记成坏块的可正常使用。在使用过程中,由于环境和使用年限等因素的影响,通常会出现坏块增长,这些坏块的出现会导致系统出现故障。所有通常在使用前可进行测试,以找出增长的坏块,本文章介绍了一种基于magnum II 测试机的NAND FLASH的测试方法。
2. VDNF64G08RS50MS4V25-III模块介绍
2.1 VDNF64G08RS50MS4V25-III的结构
VDNF64G08RS50MS4V25-III NAND FLASH存储器采用叠层型立体封装工艺进行封装,内部采用4片相同型号的塑封芯片(型号:MT29F16G08ABABAWP-AITX:B,温度等级:工业级-40~85℃,版本号:1612 WP 29F8G08ABABA AITX B 1-2 ,生产厂家:镁光),分八层进行叠装,每层一个芯片。模块的重量约为6.7±0.5克。其主要特性如下:
Ø 总容量:64G bit;
Ø 工作电压:3.3V(典型值),2.7~ 3.6V(范围值);
Ø 数据宽度:8位;
Ø 页大小:(4K+224)byte;
Ø 块大小:128页=(512K+28K) byte;
Ø 片选块容量:2048块;
Ø 页读操作
—读时间:25us(最大) ;
—串行读取时间:25ns(最小) ;
Ø 快速写周期时间
—页编程时间:230us(典型) ;
—块擦除时间:0.7ms(典型)。

图1 VDNF64G08RS50MS4V25-III原理框图
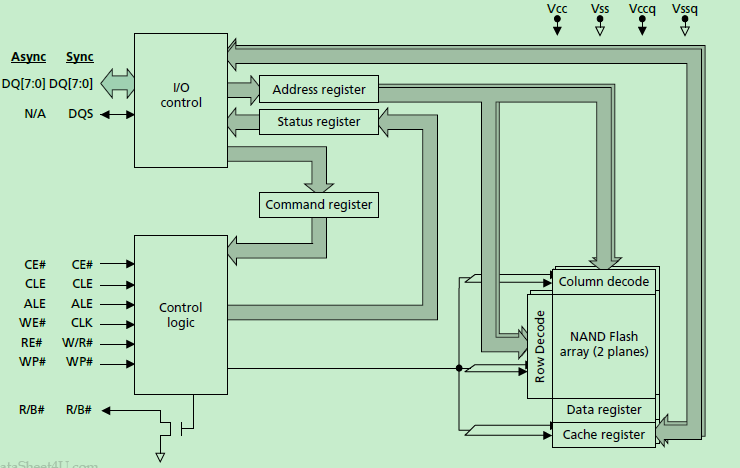
图2 VDNF64G08RS50MS4V25-III存储器基片内部结构框图
2.2 VDNF64G08RS50MS4V25-III的引脚说明
VDNF64G08RS50MS4V25-III存储器采用的是SOP封装工艺,整块芯片表面镀金,这样可以大幅度增强了芯片的抗干扰和抗辐射的能力,有利于该芯片能应用于航空航天等恶劣的环境。
VDNF64G08RS50MS4V25-III 存储器各引脚的功能说明如下:
VCC:+3.3V电源输入端。滤波的旁路电容应尽可能靠近电源引脚, 并直接连接到地;
VSS:接地引脚;
#CE0/#CE1/#CE2/#CE3:片选信号,低电平有效时选中该片;
CLE: 命令锁存,高电平有效;
ALE:地址锁存,高电平有效;
#WE:写信号,低电平有效,数据有效发生在相应地址有效之后的两个周期;
#RE:读信号,低电平有效。
DQ0~DQ7:数据输入/输出脚,地址输入输出脚;
#WP: 写保护。
2.3 VDNF64G08RS50MS4V25-III的功能操作
表1 器件功能真值表
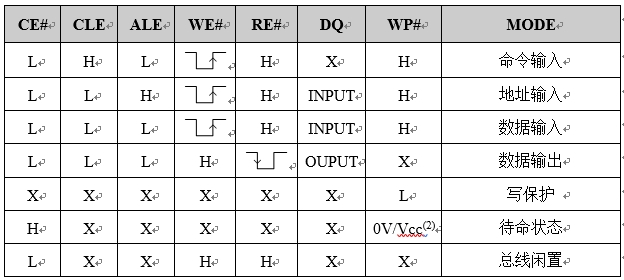
注:“H”代表高电平,“L”代表低电平,“X”代表可以是任何状态
3. VDNF64G08RS50MS4V25-III的电特性
VDNF64G08RS50MS4V25-III电特性见表2:
表2:产品电特性

表3:AC特性


4. VDNF64G08RS50MS4V25-III的测试方案
在本案例中,我们选用了Teradyne公司的magnum II测试系统对VDNF64G08RS50MS4V25-III进行全面的性能和功能评价。该器件的测试思路为典型的数字电路测试方法,即存储阵列的读写功能测试及各项电特性参数测试。
4.1 magnum II测试系统简介
Magnum II测试系统是上海Teradyne公司生产的存储器自动测试机,它由主机和测试底架组成,每个测试底架包含5个网站装配板(Site Assembly Board),每个装配板有128组测试通道,可用来连接DUT(Device Under Test)的管脚,5个装配板之间完全相互独立,故可以联合多个装配板测试管脚数更多的产品。除了与主机通信的装配板外,测试底架还包括系统电源供给、电源监控板、冷却风扇、以太网集线器和测试板锁定装置。使用Magnum II测试系统时,通过主机编程的方式配置各装配板,再由各装配板对DUT进行一系列向量测试,最终在主机的UI界面打印出测试结果。
Magnum II测试系统有着强大的算法模块APG(Algorithmic Pattern Generator),可生成各种检验程序,即测试pattern,如棋盘格测试程序,反棋盘格测试程序,全空间全1测试,全空间全0测试,读写累加数测试,读写随机数测试,对角线测试等,采用这些测试向量可以对器件进行较为全面的功能检测。
4.2 采用Magnum II测试系统的测试方案设计
1)硬件设计
按照magnum II测试系统的测试通道配置规则,绘制VDNF64G08RS50MS4V25-III的测试转接板,要对器件速率、工作电流、抗干扰等相关因素进行综合考量。
2)软件设计
考虑到使用该模块为器件提供需要施加激励信号的特殊性,我们采用了magnum II系统的特殊编程语言和C++编程语言,在VC++环境中调试测试程序,来完成相应的控制操作。具体实施步骤如下:
A、按照magnum II的标准编程方法,先完成对VDNF64G08RS50MS4V25-III的Pin Assignments 定义,Pin Scramble定义,Pin Electronics,Time Sets等的设置。
B、确定Sequence Table Execution Order,编辑每一组测试项,即Test Block, Test Block 里面需要包含Pin Electronics,Time Sets,funtest()函数,funtest()函数中就会使用到pattern。
C、编辑pattern使用的是magnum II测试系统的特殊编程语言,运用APG中各模块的功能编辑所需要的算法指令,编译生成object code。
4.3 VDNF64G08RS50MS4V25-III的功能测试
针对NAND FLASH等存储单元阵列的各类故障模型,如阵列中一个或多个单元的一位或多位固定为0或固定为1故障(Stuck at 0 or 1 fault)、阵列中一个或多个单元固定开路故障(Stuck open fault)、状态转换故障(Transition fault)、数据保持故障(Data maintaining fault)、状态耦合故障(Coupling fault)等,有相应的多种算法用于对各种故障类型加以测试,本文采用,全0、全1,棋盘格、反棋盘格,累加,随机数的测试算法。
1)APG简介
APG即为Algorithmic Pattern Generator(算法模式生成器)模块的简称,它其实就是一个简单的电脑,用特殊的编程语言和编译器生成目标代码供测试系统使用,APG主要由两个地址生成器(XALU和YALU)、一个数据生成器(Data Generator)、一个时钟选择信号生成器(Chip Select)组成。
一组地址生成器最多可编辑24位地址长度,结合两个地址生成器可产生一系列的地址算法,如单个地址的递增(increment)、递减(decrement)、输出全为1(all 1s)、输出全为0(zeros)等操作,两个地址的关联操作有相加(add)、相减(subtract)、或运算(or)、与运算(and)、异或(xor)运算等,运用这些地址算法可以非常灵活地寻址到器件的任一一个存储单元,以满足各种测试需求。
数据生成器最多可编辑36位数据长度,其功能除了有相加(add)、相减(subtract)、或运算(or)、与运算(and)、异或(xor)运算等以外,还可以与地址生成的背景函数(bckfen)配合使用,以生成需要的数据,如当地址为奇数是生成0x55的数据,当地址为偶数时生成0xaa的数据等等。
时钟信号生成器最多可编辑18个片选通道,并且可产生4种不同的波形,即脉冲有效,脉冲无效,电平有效,电平无效。
除以上四个模块外,APG还包括管脚定义模块(pinfunc),计数器(count),APG控制器(mar)等,使用magnum II特殊的编程语言并运用这些模块的功能编辑出所需要的算法指令,便可以对器件进行功能测试。
4.4 VDNF64G08RS50MS4V25-III的电性能测试
针对NAND FLASH类存储器件,其电性测试内容主要有管脚连通性测试(continuity)、管脚漏电流测试(leakage),电源管脚静态电流测试(ICC1/ ICC2)、电源管脚动态电流测试(ICC3)、输出高/低电平测试(voh/vol),时序参数测试(TACC、TOE、TCE)。
1)PMU简介
PMU即为Parametric Measurement Unit,可以将其想像为一个电压表,它可以连接到任一个器件管脚上,并通过force电流去测量电压或force电压去测量电流来完成参数测量工作。当PMU设置为force 电流模式时,在电流上升或下降时,一旦达到系统规定的值,PMU Buffer就开始工作,即可输出通过force电流测得的电压值。同理,当PMU设置为force 电压模式时, PMU Buffer会驱动一个电平,这时便可测得相应的电流值。NAND FLASH 器件的管脚连通性测试(continuity)、漏电流测试(leakage)、voh/vol测试均采用这样的方法进行。
2) 静态电流测试((ICC1/ ICC2)、动态电流测试(ICC3)、时序参数测试(TACC、TOE)。
静态电流测试不需要测试pattern,而动态电流测试需要测试pattern,使用的电流抓取函数分别是test_supply()和ac_test_supply(),需要注意的是测试静态电流时器件的片选控制信号需置成vcc状态,测试动态电流时负载电流(ioh/iol)需设为0ma。
对时序参数进行测试时, pattern测试是必不可少的。采用逐次逼近法进行,可以固定控制信号的时序,改变data strobe的时序来捉取第一次数据输出的时间;也可以固定data strobe的时序,改变控制信号的第一次有效沿的时间,与data strobe的时序做差运算即可得到器件的最快反应时间。
参考文献:
[1] Neamen,D.A.电子电路分析与设计——模拟电子技术[M]。清华大学出版社。2009:118-167。
[2] 珠海欧比特控制工程股份有限公司VDNF64G08RS50MS4V25-III使用说明书[Z]. 2013。
[3] Magnum II Programmer’s Manual。上海泰瑞达。





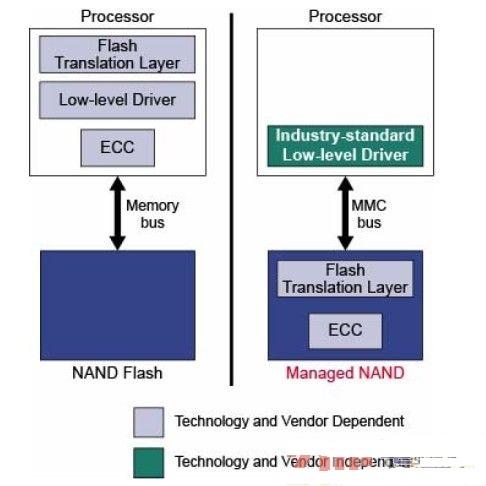




评论