制造大功率LED芯片的几种方法
要想得到大功率LED器件,就必须制备合适的大功率LED芯片。国际上通常的制造大功率LED芯片的方法有如下几种:
本文引用地址:https://www.eepw.com.cn/article/168033.htm①加大尺寸法。通过增大单体LED的有效发光面积和尺寸,促使流经TCL层的电流均匀分布,以达到预期的光通量。但是,简单地增大发光面积无法解决散热问题和出光问题,并不能达到预期的光通量和实际应用效果。
②硅底板倒装法。首先制备出适合共晶焊接的大尺寸LED芯片,同时制备出相应尺寸的硅底板,并在硅底板上制作出供共晶焊接用的金导电层及引出导电层(超声金丝球焊点),再利用共晶焊接设备将大尺寸LED芯片与硅底板焊接在一起。这样的结构较为合理,既考虑了出光问题又考虑到了散热问题,这是目前主流的大功率LED的生产方式。
美国Lumileds公司于2001年研制出了AlGaInN功率型倒装芯片(FCLED)结构,其制造流程是:首先在外延片顶部的P型GaN上淀积厚度大于500A的NiAu层,用于欧姆接触和背反射;再采用掩模选择刻蚀掉P型层和多量子阱有源层,露出N型层;经淀积、刻蚀形成N型欧姆接触层,芯片尺寸为1mm×1mm,P型欧姆接触为正方形,N型欧姆接触以梳状插入其中,这样可缩短电流扩展距离,把扩展电阻降至最小;然后将金属化凸点的AlGaInN芯片倒装焊接在具有防静电保护二极管(ESD)的硅载体上。
③陶瓷底板倒装法。先利用LED晶片通用设备制备出具有适合共晶焊接电极结构的大出光面积的LED芯片和相应的陶瓷底板,并在陶瓷底板上制作出共晶焊接导电层及引出导电层,然后利用共晶焊接设备将大尺寸LED芯片与陶瓷底板焊接在一起。这样的结构既考虑了出光问题也考虑到了散热问题,并且采用的陶瓷底板为高导热陶瓷板,散热效果非常理想,价格又相对较低,所以为目前较为适宜的底板材料,并可为将来的集成电路一体化封装预留空间。
④蓝宝石衬底过渡法。按照传统的InGaN芯片制造方法在蓝宝石衬底上生长出PN结后,将蓝宝石衬底切除,再连接上传统的四元材料,制造出上下电极结构的大尺寸蓝光LED芯片。
⑤AlGaInN碳化硅(SiC)背面出光法。美国Cree公司是全球唯一采用SiC衬底制造AlGaInN超高亮度LED的厂家,几年来其生产的AlGaInN/SiCa芯片结构不断改进,亮度不断提高。由于P型和N型电极分别位于芯片的底部和顶部,采用单引线键合,兼容性较好,使用方便,因而成为AlGaInNLED发展的另一主流产品。










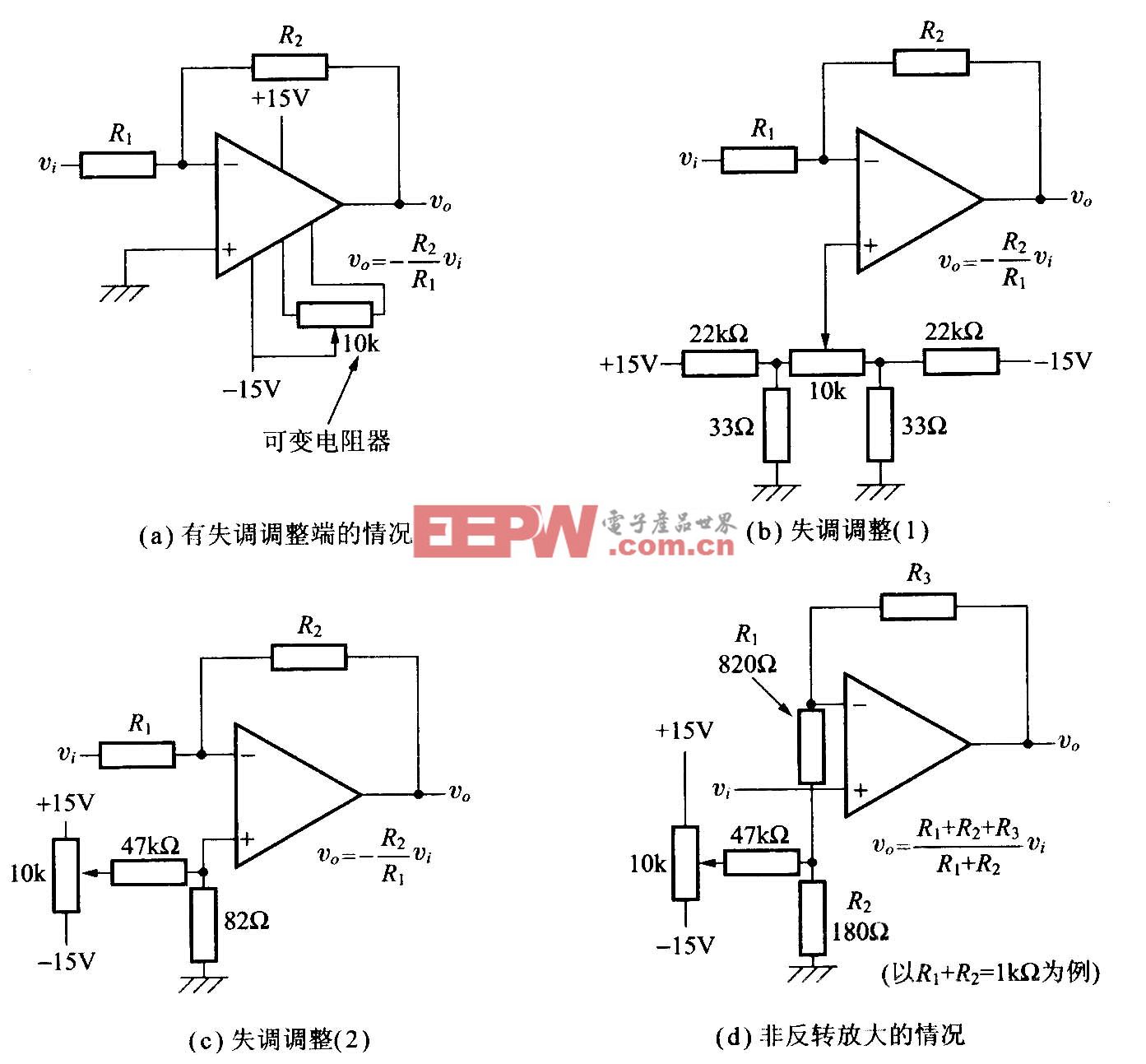







评论