大功率LED单芯片封装和多芯片封装简介
美国LumiLEDs公司研制出了Luxeon系列大功率LED单芯片封装结构,这种功率型单芯片LED封装结构与常规的Φ5mm LED封装结构全然不同,它是将正面出光的LED芯片直接焊接在热衬上,或将背面出光的LED芯片先倒装在具有焊料凸点的硅载体上,然后再将其焊接在热衬上,使大面积芯片在大电流下工作的热特性得到改善。这种封装对于取光效率、散热性能和电流密度的设计都是最佳的,其主要特点有:
本文引用地址:https://www.eepw.com.cn/article/167777.htm① 热阻低。传统环氧封装具有很高的高热阻,而这种新型封装结构的热阻一般仅为14℃/W,可减小至常规LED的1/20。大功率LED 0.5W 大功率LED 3W 大功率LED 5W 大功率LED 10W 大功率LED 50W
② 可靠性高。内部填充稳定的柔性胶凝体,在40~120℃时,不会因温度骤变产生的内应力使金丝和框架引线断开。用这种硅橡胶作为光耦合的密封材料,不会出现普通光学环氧树脂那样的变黄现象,金属引线框架也不会因氧化而脏污。
③ 反射杯和透镜的最佳设计使辐射可控,光学效率最高。在应用中可将它们组装在一个带有铝夹层的电路板(铝芯PCB板)上,电路板作为器件电极连接的布线用,铝芯夹层则可作为功率型LED的热衬。这样不仅可获得较高的光通量,而且还具有较高的光电转换效率。
单芯片瓦级功率LED最早是由Lumileds公司于1998年推出的Luxeon LED,该封装结构的特点是采用热电分离的形式,将倒装片用硅载体直接焊接在热衬上,并采用反射杯、光学透镜和柔性透明胶等新结构和新材料,现可提供单芯片1W、3W和5W的大功率LED产品。OSRAM公司于2003年推出单芯片的Golden Dragon系列LED,其结构特点是热衬与金属线路板直接接触,具有很好的散热性能,而输入功率可达1W。
功率型LED的多芯片组合封装
六角形铝衬底的直径为3.175cm(1.25英寸),发光区位于其中央部位,直径约为0.9525cm(0.375英寸),可容纳40个LED芯片。用铝板作为热衬,并使芯片的键合引线通过在衬底上做成的两个接触点与正极和负极连接。根据所需输出光功率的大小来确定衬底上排列管芯的数目,组合封装的超高亮度芯片包括AlGaInN和AlGaInP,它们的发射光可为单色、彩色(RGB)、白色(由RGB三基色合成或由蓝色和$二元合成)。最后采用高折射率的材料按照光学设计形状进行封装,不仅取光效率高,而且还能够使芯片和键合的引线得到保护。由40个AlGaInP(AS)芯片组合封装的LED的流明效率为20lm/W。采用RGB三基色合成白光的组合封装模块,当混色比为0:43(R)0:48(G):0.009(B)时,光通量的典型值为100lm,CCT标准色温为4420K,色坐标x为0.3612,y为0.3529。由此可见,这种采用常规芯片进行高密度组合封装的功率型LED可以达到较高的亮度水平,具有热阻低、可在大电流下工作和光输出功率高等特点。LED节能灯 LED灯具 LED路灯 CREE LED CREE代理商
多芯片组合封装的大功率LED,其结构和封装形式较多。美国UOE公司于2001年推出多芯片组合封装的Norlux系列LED,其结构是采用六角形铝板作为衬底。Lanina Ceramics公司于2003年推出了采用公司独有的金属基板上低温烧结陶瓷(LTCC-M)技术封装的大功率LED阵列。松下公司于2003年推出由64只芯片组合封装的大功率白光LED。日亚公司于2003年推出超高亮度白光LED,其光通量可达600lm,输出光束为1000lm时,耗电量为30W,最大输入功率为50W,白光LED模块的发光效率达33lm/W。我国台湾UEC(国联)公司采用金属键合(Metal Bonding)技术封装的MB系列大功率LED的特点是,用Si代替GaAs衬底,散热效果好,并以金属粘结层作为光反射层,提高了光输出。
功率型LED的热特性直接影响到LED的工作温度、发光效率、发光波长、使用寿命等,因此,功率型LED芯片的封装设计、制造技术显得尤为重要。大功率LED封装中主要需考虑的问题有:
① 散热。散热对于功率型LED器件来说是至关重要的。如果不能将电流产生的热量及时地散出,保持PN结的结温在允许范围内,将无法获得稳定的光输出和维持正常的器件寿命。
在常用的散热材料中银的导热率最高,但是银的成本较高,不适宜作通用型散热器。铜的导热率比较接近银,且其成本较银低。铝的导热率虽然低于铜,但其综合成本最低,有利于大规模制造。
经过实验对比发现较为合适的做法是:连接芯片部分采用铜基或银基热衬,再将该热衬连接在铝基散热器上,采用阶梯型导热结构,利用铜或银的高导热率将芯片产生的热量高效地传递给铝基散热器,再通过铝基散热器将热量散出(通过风冷或热传导方式散出)。这种做法的优点是:充分考虑散热器的性价比,将不同特点的散热器结合在一起,做到高效散热并使成本控制合理化。LED灯具
应注意的是:连接铜基热衬与芯片的材料的选择是十分重要的,LED行业常用的芯片连接材料为银胶。但是,经过研究发现,银胶的热阻为10~25W/(m·K),如果采用银胶作为连接材料,就等于人为地在芯片与热衬之间加上一道热阻。另外,银胶固化后的内部基本结构为环氧树脂骨架+银粉填充式导热导电结构,这种结构的热阻极高且TG点较低,对器件的散热与物理特性的稳定极为不利。解决此问题的做法是:以锡片焊作为晶粒与热衬之间的连接材料[锡的导热系数为67W/(m·K)],可以获得较为理想的导热效果(热阻约为16℃/W)。锡的导热效果与物理特性远优于银胶。
② 出光。传统的LED器件封装方式只能利用芯片发出的约50%的光能,由于半导体与封闭环氧树脂的折射率相差较大,致使内部的全反射临界角很小,有源层产生的光只有小部分被取出,大部分光在芯片内部经多次反射而被吸收,这是超高亮度LED芯片取光效率很低的根本原因。如何将内部不同材料间折射、反射消耗的50%光能加以利用,是设计出光系数的关键。LED灯具
通过芯片的倒装技术(Flip Chip)可以比传统的LED芯片封装技术得到更多的有效出光。但是,如果说不在芯片的发光层与电极下方增加反射层来反射出浪费的光能,则会造成约8%的光损失,所以在底板材料上必须增加反射层。芯片侧面的光也必须利用热衬的镜面加工法加以反射出,增加器件的出光率。而且在倒装芯片的蓝宝石衬底部分与环氧树脂导光结合面上应加上一层硅胶材料,以改善芯片出光的折射率。
经过上述光学封装技术的改善,可以大幅度提高大功率LED器件的出光率(光通量)。大功率LED器件顶部透镜的光学设计也是十分重要的,通常的做法是:在进行光学透镜设计时应充分考虑最终照明器具的光学设计要求,尽量配合应用照明器具的光学要求进行设计。LED灯具














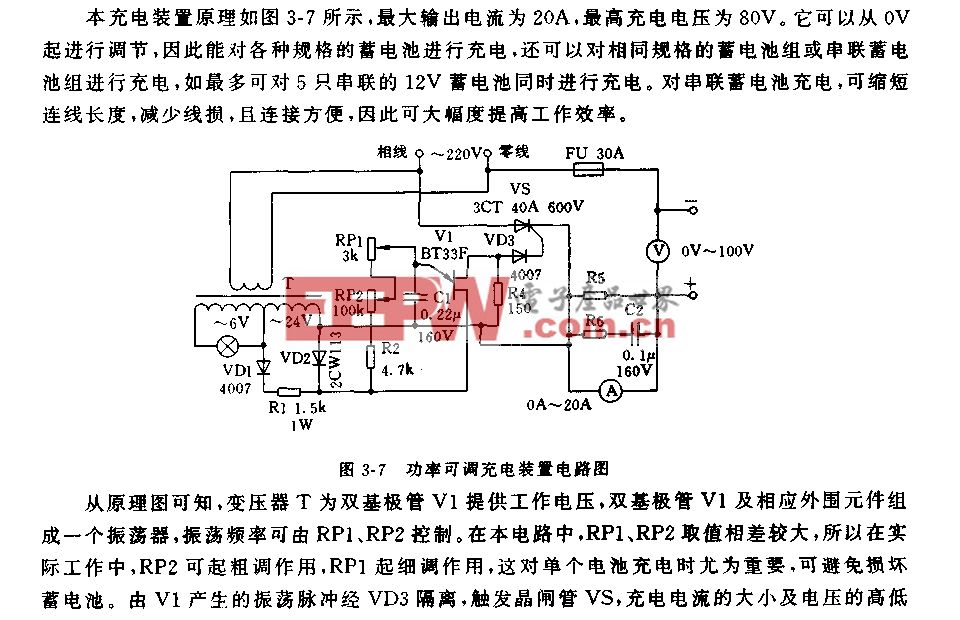


评论