移动与运算融合高通新处理器强打整合牌
高通正积极打造终极SoC,满足行动与运算装置融合新趋势。行动与运算装置的界线愈来愈模糊,使得晶片商除须致力提升处理器效能外,亦得兼顾低功耗表现。为此,高通已计划在2013年发布新一代处理器微架构,以提高SoC整合度。
本文引用地址:https://www.eepw.com.cn/article/140776.htm乘着2012年营收创新高的气势,高通(Qualcomm)特别举办2012年Editors' Week活动,广邀全球记者参访位于美国圣地牙哥的高通大本营;并针对应用处理器、无线通讯晶片、物联网(IoT)技术,以及行动作业系统、扩增实境(AR)等软体发展动态举行多场演讲,揭示该公司未来在行动市场的重要战略。
一踏进高通总部,映入眼帘就是整片贴满专利的大墙,涵盖3G、长程演进计划(LTE)、无线区域网路(Wi-Fi)、数位讯号处理器(DSP)、射频( RF)与系统单晶片(SoC)设计架构等各个层面,展现其坚强技术实力。的确,高通在行动晶片领域的地位不容忽视,拜行动装置快速普及之赐,该公司营收表现也屡传捷报;甚至在2012年11月站上全球半导体厂市值第一宝座,拉下盘据王位已久的英特尔(Intel),正式揭开以行动装置为核心的“后PC时代”序幕。
其实,后PC时代并非意味个人电脑的终结,较适当的说法是开启行动与运算装置融合设计的新风气。因此,可发现华硕、联想、戴尔(Dell)与索尼(Sony)等PC品牌大厂,纷纷开发兼容PC与平板使用体验的变形装置,迎合消费市场转变。
不可讳言,智慧型手机的普及正是助长行动与运算装置合一风气的重要因素。随着消费者将一部分网路浏览、影像编辑等工作由PC转移至智慧型手机上,导致晶片商、品牌厂须在低功耗前提下,持续推升手机运算效能。瞄准此一需求,高通也在2012年Editors' Week活动中宣告,将改写高整合处理器的定义,具备顶尖效能、超低耗电的SoC将于2013年亮相。
推升SoC整合度高通改造晶片微架构
面对行动装置日益严格的效能与功耗要求,高通近期已展开处理器微架构革新,并计划在既有中央处理器(CPU)与绘图处理器(GPU)之外,再整合3G/4G数据机(Modem)、Wi-Fi、DSP、RF及全球卫星定位系统(GPS)晶片(图1),甚至是触控与感测器晶片等,期打造兼顾效能与功耗,且整合度更高的SoC。
高通总裁暨营运长Steve Mollenkopf(图2)表示,Windows 8/RT正式亮相后,行动装置与PC之间的界线正逐渐模糊,未来产品设计势将朝兼容两者优点的方向前进,因而为行动晶片商带来极大挑战。除须快速推进IC制程外,还须提升内部CPU、GPU、无线通讯及定位晶片的整合度,方能让SoC在维持低功耗、小尺寸的前提下,持续拉高整体运算效能。
也因此,高通正聚焦20奈米(nm)以下先进制程晶片研发,同时也展开新一代处理器微架构改造计划,达成最佳化效能与功耗平衡。高通资深副总裁暨行销长Anand Chandrasekher补充,再过几个月,高通将升级现有的Krait架构,打造新一代适合整合更多元异质晶片的处理器设计框架,从而催生高整合、高效能又低功耗的SoC方案,助力行动与电脑装置汇流设计成形。
同时,行动装置品牌厂致力提升萤幕解析度达1,080p,并积极布局扩增实境应用,亦推升GPU、DSP功能升级需求。Chandrasekher指出,多数业者认为只要扩增GPU及DSP核心就能有效提升效能,但却忽略整个系统运作的流畅度与功耗加剧的情形;相较之下,直接在SoC内整并GPU、DSP与CPU协同运作,便不须一味追求多核设计,即可改善影像、数位讯号处理延迟问题(图3)。
除针对SoC效能与功耗拟定新的研发战略外,高通更计划于2013年率先在行动应用处理器中整并LTE-Advanced与802.11ac功能,提升无线通讯晶片规格,并持续发挥高整合SoC设计威力,解决行动数据量暴涨问题。
优化行动数据分流SoC整并LTE-A/11ac
随着行动装置快速普及,网路卸载(Offload)与分流机制已成通讯晶片、设备与电信商的布局重点;为此,高通计划于2013年量产支援载波聚合(Carrier Aggregation)的LTE- Advanced多频多模晶片,并将结合802.11ac模组催生更强处理器平台,一举扩充联网装置的无线通讯频宽与资讯分流功能。
高通行动运算(QMC)资深行销总监Peter Carson表示,LTE、802.11ac晶片与设备陆续到位,电信商也全速推动商转服务。然而,即便新标准传输速率翻倍,但受限于频宽与覆盖率不足,仍无法有效纾解资讯塞车问题;因此,业界遂转向发展网路分流方案,促进Wi-Fi、3G/4G甚至LTE-Advanced等无线通讯技术协同运作,确保能随时随地提供用户优异的行动联网体验。
然而,行动装置内建无线通讯功能包罗万象,所有可用频段加总起来已超过二十个;还要在3G/4G频宽吃紧时,安全换手(Handover)至Wi-Fi分流,势将为晶片软硬体设计带来艰巨挑战。
对此,高通已部署LTE数据机加Wi-Fi的高整合SoC方案,从而在有限空间内发挥最大联网效能,并维持较低功耗,减轻散热问题。Carson指出,该公司旗下28奈米多核心行动应用处理器平台已成功结合3G/LTE多频多模晶片,以及802.11ac、蓝牙(Bluetooth)加调频(FM)的Wi-Fi模组,并获三百款装置导入。
2013年,高通则将领先业界发布首款LTE-Advanced产品,大幅提高传输速率,并运用该标准新增的载波聚合功能,扩增频宽与频谱使用效益;同时,也将延续与802.11ac晶片整合的SoC研发方针,更进一步强化网路资讯分流机制,并缩减LTE-Advanced传输功耗。
据悉,LTE-Advanced载波聚合可在不同频段中结合多重无线电频道,系提升传输速率的关键推手,可显著减少资讯延迟。此外,该功能亦可助力电信商整并较松散的低频频谱达到20MHz频宽,从而利用低频讯号穿透力较佳的优势,扩大讯号覆盖率。
除硬体迈向高速、高整合设计外,要实现LTE-Advanced与Wi-Fi分流架构,还须加强软体安全性。Carson透露,现阶段业界已开始研拟IP网路、无线电网路协同作业的新标准,期明确定义相关的软体层规格特性,确保网路换手时不会产生资讯流失或外泄疑虑,进而加快无线通讯分流机制推展脚步。
技术屏障高SoC整合设计挑战艰巨
高整合SoC设计虽有其优势,但此种方案对高通以外的晶片业者而言,不仅须投入大量研发人力、资金,还要扩充矽智财(IP)阵容与先进制程研发能力,才能顺利实现。
Chandrasekher指出,高通近2年来均挹注20%以上营收,专攻晶片研发,且拥有强大的IP阵容,遂能顺利发展高整合度SoC,提供业界高性能、低耗电产品。同时也透过加入异质系统架构(HSA)基金会,与业界合作伙伴共同催生最佳化异质晶片软硬体设计架构。
SoC设计固然重要,亦是高通一贯的产品布局重点,但要持续降低晶片制造成本与功耗,仍须借微缩制程或引进大尺寸晶圆技术,提高电晶体密度,才能跨越SoC设计极限。
Chandrasekher进一步强调,半导体制程进化与SoC架构改良将相辅相成,缺一不可。现阶段,高通已投注大量资金与各大晶圆厂合作布局20奈米以下晶片,对延续摩尔定律的发展极具信心。









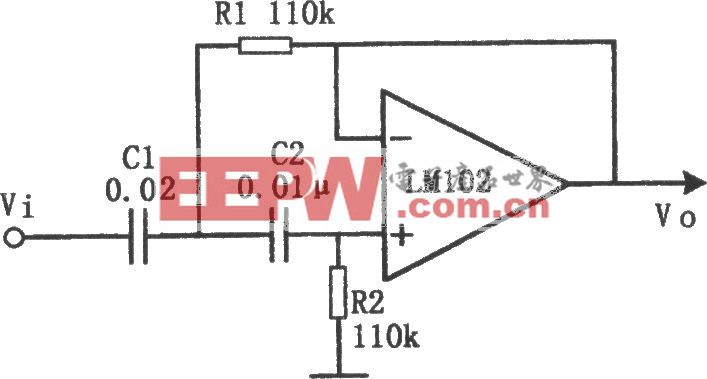
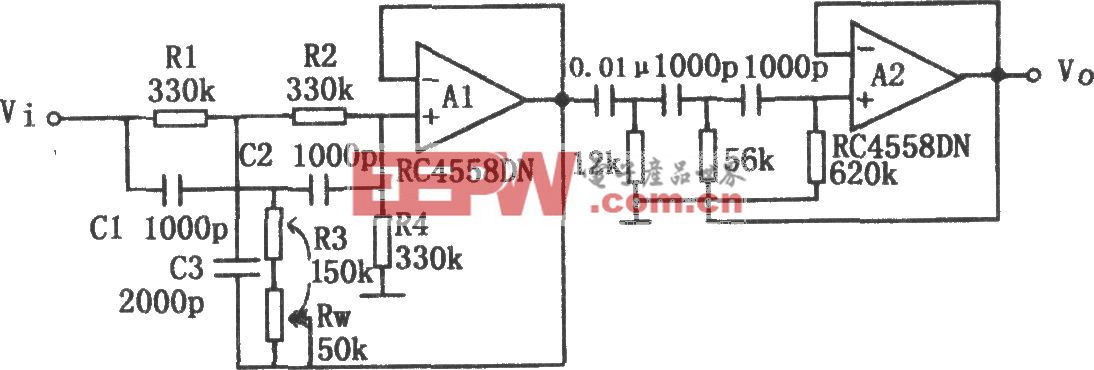



评论