化学机械抛光 Slurry 的蜕与进
新型slurry创意无限
吴国俊博士认为,尽管目前的研磨颗粒仍为SiO2、Al2O3和CeO2为主,但是slurry的整体趋势朝着更强的化学反应活性、更温和的机械作用的方向发展。这将促进柔软研磨颗粒的研发,从而减少在低k绝缘材料表面产生线状划痕的可能。在slurry中采用混合型的颗粒,即聚合物与传统陶瓷颗粒的结合体,在平整度改善以及缺陷度降低方面展示出了良好的前景。
陶瓷颗粒通常具有较强的研磨能力,因此去除率较高,但同时这也会在与硅片接触点附近产生更强的局部压强。很多时候,这会导致缺陷的产生。因此,研磨颗粒的形状变得至关重要(边缘尖锐的或是圆滑的),而通常这依赖于slurry颗粒的合成工艺。与陶瓷颗粒相反,聚合物颗粒通常比较柔软,具有弹性且边缘圆滑,因此能够将所施加的应力以一种更加温和、分布均匀的方式传递到硅片上。理论上讲,带聚合物外壳的陶瓷颗粒能够将这两者的优点完美的结合在一起,因为坚硬的颗粒可以以一种非损伤的方式施加局部应力。这种结合体具有提高研磨移除率、改善平整度、降低缺陷发生率的潜力。
在slurry中添加抑制剂或其它添加剂也是未来slurry发展的趋势之一。Tim Tobin认为,在IC器件进一步向着体积更小,速度更快的技术要求驱动下,互连技术平坦化要求集中体现在:提高平面度、减少金属损伤、降低缺陷率。对于铜互连结构来说,由于铜本身无法产生自然钝化层,发生在宽铜线上的分解或腐蚀力,可能对窄线条产生极大的局部影响,造成严重的失效。对于先进的铜互连工艺,slurry中的抑制剂成分至关重要。已有研究人员正在研究采用阴离子吸附的铜钝化工艺中的热力学问题。用贵金属钌作为阻挡层材料可以减少甚至消除对籽晶层的需要,这样就可以直接在钌的阻挡层上电镀金属铜,这也是如今铜互连的研究重点之一。但是,金属钌在电化学腐蚀中具有更高的驱动力,因此需要更为有效或者浓度更高的阳极抑制剂。此外,向slurry中添加吸附剂也可以使CMP工艺所造成的碟形凹陷得以降低。
越来越平的IC制造是不可逆转的趋势,同样不可逆转的还有更多的新兴材料和集成结构闯入半导体的大家族。当大家还在揣测“摩尔定律的发展如何为继?”的时候,身处其中的人已经明白:不断的研发进步乃是最好的应对之策。




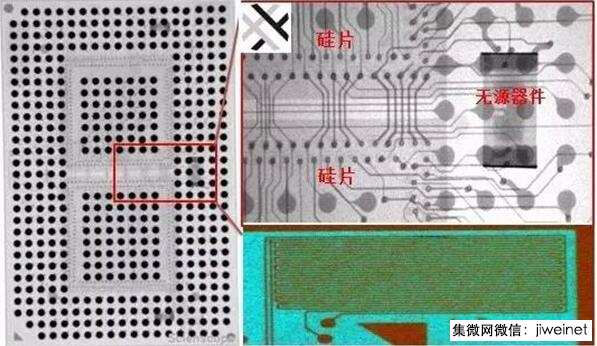

评论