化学机械抛光 Slurry 的蜕与进
Slurry急需“与时俱进”
尽管CMP工艺在0.35μm节点就被广为采用,但是其发展和进步还是随着IC集成的发展“与时俱进”,特别是新材料和新结构为其带来了不少进步良机。
“CMP工艺相当复杂,其发展速度一直处于IC制造工艺的前沿。”Entrepix的总裁兼CEO Tim Tobin说,“新材料包括了掺杂氧化物、稀有金属、聚合物、高k/低k材料以及III-V族半导体材料等,比较热门的前沿结构则有MEMS、TSV、3D结构以及新的纳米器件等(图3),所有这些新兴技术都是摆在CMP面前亟待解决的课题。也正因为如此,CMP在半导体整个制造流程中的重要性不言而喻,成本与性能的博弈是未来不得不面对的问题。”
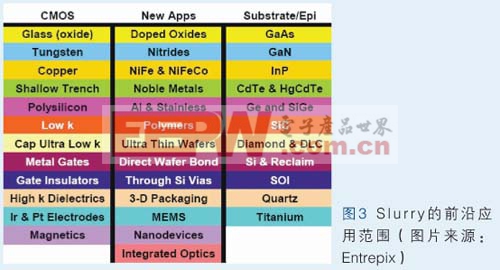
那么,所有这些芯片制造的“新宠儿”对于slurry来说意味着什么呢?“随着芯片制造技术的提升,对slurry性能的要求也愈发的严格。除了最基本的质量要求外,如何保证CMP工艺整体足够可靠、如何保证slurry在全部供应链(包括运输及储藏)过程中稳定等,一直是slurry过去和现在面对的关键。摩尔定律推动技术节点的代代前进,这将使slurry的性能、质量控制、工艺可靠性及供应稳定性面临更大的挑战。”王淑敏博士说。
对于新材料来说,slurry不仅要有去除材料的能力,还要保证能够适时恰当的停留在所要求的薄膜层上。对于某些新材料,如低k材料,其亲水性差,亲油性强,多孔性和脆性等特点还要求slurry的性能要足够温和,否则会造成材料的垮塌和剥离。因此,如何去除线宽减小和低k材料带来的新缺陷,如何在减低研磨压力的情况下提高生产率等也是研发的重点。“Cabot目前传统材料的slurry就包括氧化物(D3582和D7200)、Cu(C8800)、Barrier (B7000)等,”吴国俊博士说,“同时,其它一些新材料,如Ru、Nitride、SiC等的slurry也有所涉足。”





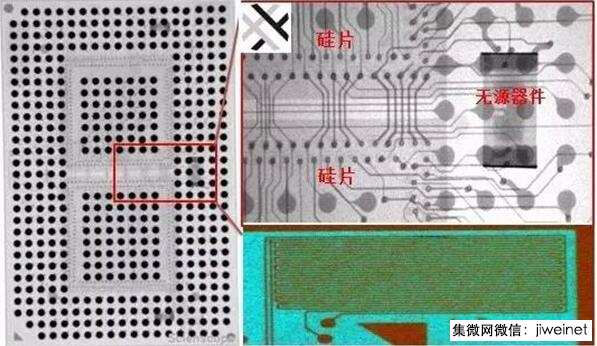
评论