化学机械抛光 Slurry 的蜕与进
Slurry是CMP的关键要素之一,其性能直接影响抛光后表面的质量。Slurry一般由超细固体粒子研磨剂(如纳米级SiO2、Al2O3粒子等)、表面活性剂、稳定剂、氧化剂等组成。固体粒子提供研磨作用,化学氧化剂提供腐蚀溶解作用。影响去除速度的因素有:slurry的化学成分、浓度;磨粒的种类、大小、形状及浓度;slurry的粘度、pH值、流速、流动途径等。Slurry的精确混合和批次之间的一致性对获得硅片与硅片、批与批的重复性是至关重要的,其质量是避免在抛光过程中产生表面划痕的一个重要因素。
Cabot Microelectronics的亚太地区研发总监吴国俊博士介绍说,抛光不同的材料所需的slurry组成、pH值也不尽相同,最早也是最成熟的是氧化物研磨用slurry。用于氧化物介质的一种通用slurry是含超精细硅胶颗粒(均匀悬浮)的碱性氢氧化钾(KOH)溶液,或氢氧化胺(NH4OH)溶液。KOH类slurry由于其稳定的胶粒悬浮特性,是氧化物CMP中应用最广的一种slurry。K+离子是一种可移动的离子玷污,非常容易被互连氧化层,如硼磷硅玻璃(BPSG)俘获。NH4OH类的slurry没有可动离子玷污,但它的悬浮特性不稳定,并且成本较高。此类slurry的pH值通常为10-11,其中的水含量对表面的水合作用和后面的氧化物平坦化至关重要。
在金属钨(W)的CMP工艺中,使用的典型slurry是硅胶或悬浮Al2O3粒子的混合物,溶液的pH值在5.0~6.5之间。金属的CMP大多选用酸性条件,主要是为了保持较高的材料去除速率。一般来说,硅胶粉末比Al2O3要软,对硅片表面不太可能产生擦伤,因而使用更为普遍。WCMP使用的slurry的化学成分是过氧化氢(H2O2)和硅胶或Al2O3研磨颗粒的混合物。抛光过程中,H2O2分解为水和溶于水的O2,O2与W反应生成氧化钨(WO3)。WO3比W软,由此就可以将W去除了。
Slurry研究的最终目的是找到化学作用和机械作用的最佳结合,以致能获得去除速率高、平面度好、膜厚均匀性好及选择性高的slurry。此外还要考虑易清洗性、对设备的腐蚀性、废料的处理费用及安全性等问题。与二十多年前相比,slurry的研究已经从基于经验转变为成熟的基于理论和实践的结合。因此,最终用户可以更好地控制并提高系统和工艺的稳定性、可靠性及可重复性。




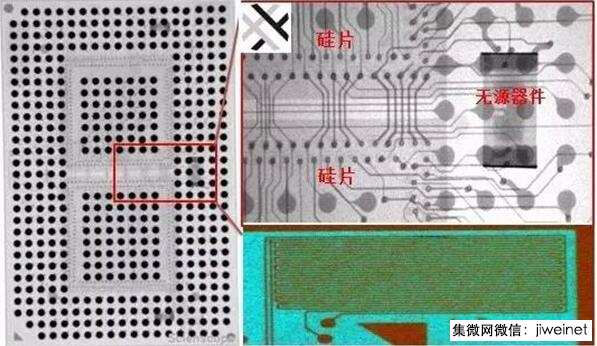

评论