台积电谈逆光刻技术的过去、现在和未来
来源:本文由半导体行业观察编译自Semiwiki。
逆光刻技术 (IInverse lithography technology:ILT) 代表了过去二十年来 EDA 最重要的进步。” 台积电的彭丹平(Danping Peng )在最近的 SPIE 高级光刻 + 图案化会议上发表了这一论断,他的演讲题为《用于 HVM 的 ILT:历史、现在和未来》。
本文总结了他富有洞察力的演讲的亮点。事实上,ILT 已经提高了以更高的保真度打印晶圆级特征的能力。
ILT 历史
首先,简要回顾设计流片后与掩模制造相关的步骤:
• 掩模车间将光学邻近校正 (OPC) 或 ILT 算法应用于掩模数据。
• 掩膜数据准备 (Mask data prep:MDP) 将以适合掩码写入器的格式组合 OPC/ILT 生成的数据。
• 掩模写入已经从(基于光学的)图案生成光刻胶涂层掩模坯的曝光发展到基于电子束的曝光。可变形状光束 (VSB) 和多光束询问书写系统均可用。(稍后会详细介绍。)
• 掩膜检测步骤包括:
• 临界尺寸 (CD) 计量 (CD-SEM)
• 使用航空影像测量系统(例如,Zeiss AIMS)进行掩模审查
• 掩模缺陷修复
然后掩膜进入晶圆厂,晶圆级印刷品将经过类似的步骤:CD-SEM 尺寸评估、晶圆检测和缺陷分析。
下图中突出显示了对掩模校正算法的需求。
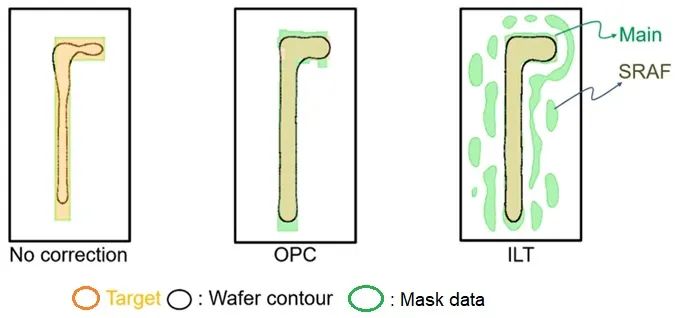
随着晶圆上的打印尺寸随着连续的工艺节点而缩放,图像的保真度——即目标图像和打印的晶圆轮廓之间的差异——变得很差。需要更正版图设计数据。
生成掩模更新的原始方法被称为光学邻近校正 (OPC)。(直线)设计数据中的各个部分以适当的间隔被一分为二,并且通常使用基于规则的算法来移动子部分。在形状角处添加了矩形衬线——在外角处扩展段,在内角处缩小。(OPC 结果被赋予了不同的名称——例如,“hammerheads”、“dogbones”。)
随后,OPC 算法将亚分辨率辅助功能 (SRAF) 添加到掩膜码数据中。这些是与原始设计不同的形状,其尺寸是有意选择的,以便不以晶圆光刻胶分辨率打印,但由于设计形状边缘的光学衍射提供适当的(建设性和破坏性)干涉。
如上图和下图所示,ILT 算法做出了根本不同的假设,利用曲线掩模数据进行校正和 SRAF。下图说明了 OPC 的基于边缘的性质与基于像素的 ILT 算法之间的主要区别。
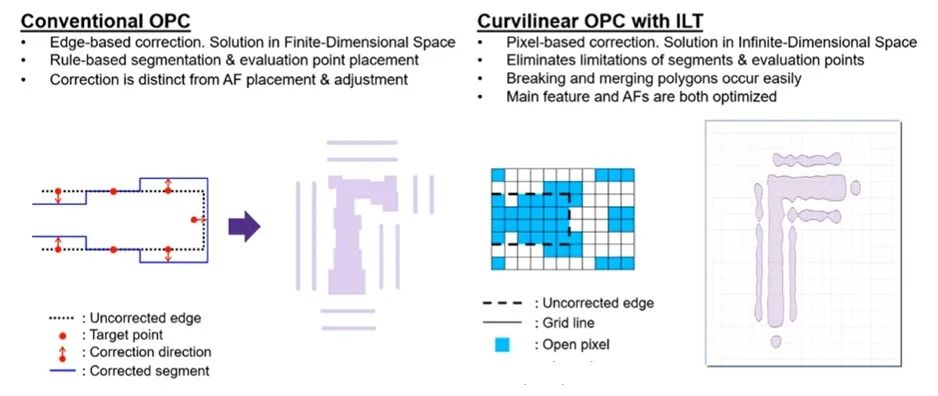
ILT 的工作原理
Danping用下面两张图来说明ILT是如何工作的。下面的第一个图是一个高级流程图,提供了掩模数据生成和蚀刻后晶圆级计量之间的综合(理想)迭代循环。(稍后将详细介绍这个完整的循环。)
下图提供了有关 ILT 流程的更多详细信息。两个相邻的形状用于说明。
计算强度的三维表示。计算误差函数,其中包含构成元素的加权和。每个权重乘以与计算的打印图像和跨像素场的硅片目标之间的差异相关的因子。
误差函数可能包括来自各种印刷图像特征的贡献:
•标称尺寸(打印到目标的差异)
•建模的三维光刻胶轮廓
•要抑制的目标区域外的像素光强度
•对照明剂量和焦点变化的敏感性
追求迭代优化以减少该误差函数的大小。请注意,上图提到了基于梯度的优化,以减少从模型预测和目标之间的差异计算得出的误差函数——ILT 与机器学习方法的相似性很大,正如 Danping 在他的演讲的 Futures 部分中强调的那样。
当前 ILT 的采用和挑战
在过去的二十年里,ILT 的采用一直存在障碍。丹平回顾了这些挑战,以及如何应对这些挑战。
1. 掩膜写入时间
与传统 OPC 方法相比,曲线(基于像素)ILT 掩模数据提供了改进的焦深。然而,相应的数据复杂性导致使用可变尺寸光束 (VSB) 技术写入掩模的电子束****次数大幅增加。
丹平解释说:“当 ILT 最初被追求时,并没有多光束掩模写入器。因此,使用 VSB 系统曝光 ILT 掩膜需要数天时间。现在,使用多光束系统,掩模写入时间基本恒定,大约 8 小时。”
请注意,ILT 数据生成应用了“中等约束”以帮助加快速度——例如,SRAF 区域/空间/CD 的最小设计规则,形状数据曲率的最大限制。
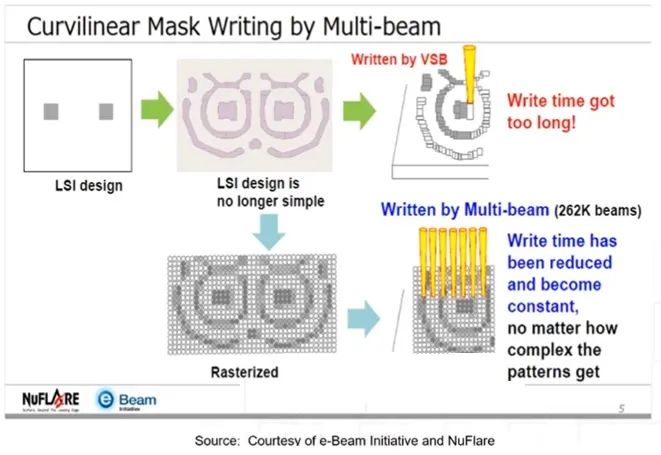
2. ILT 掩码数据生成时间
“ILT 的首次采用是由内存代工厂所采用的。”丹平表示。 “他们的布局具有高度重复性,经过精心制作,减少了重复模式的数量。”
逻辑设计的 ILT 采用速度较慢。丹平详细阐述了其中的一些挑战:
•计算运行时间长(“比 OPC 慢 20 倍”)
•曲线边缘的掩模数据规则检查技术滞后
•曝光系统的改进提高了图像分辨率(例如,193 到 193i)和剂量均匀性,降低了 ILT 优势
用于模型生成和误差函数+梯度计算的 ILT 算法以矩阵运算为主。为了解决运行时挑战,ILT 代码已移植到基于 GPU 的计算资源中。根据 Danping 的说法,这提供了“比严格基于 CPU 的计算快 10 倍” 。
为了解决掩模数据验证挑战,SEMI Curvilinear Task Force 正在研究一种数据表示,该表示将作为模型交换的标准格式。(这也是由与硅光子结构相关的曲线设计布局数据驱动的。)下图说明了新的“规则定义”,它将成为掩模数据检查的一部分。

丹平就 ILT 相对于曝光系统改进的市场机会提供了以下观察,“ILT 可用于从现有工具中榨取更多性能。” 从这个意义上说,ILT 可以扩展现有扫描仪的使用。
丹平分享了一个预测,“EUV 和 193i 掩模将在 2023 年普遍采用曲线形状。” (来源:eBeam Initiative)
ILT 未来
丹平对 ILT 技术提出了三个预测。
1. 采用深度学习技术
如上所述,ILT 算法与深度神经网络方法的计算和优化技术有很多共同之处。下图说明了如何采用深度学习。
“经过训练的深度学习模型可用于生成掩膜数据,然后进行少量 ILT 迭代。ILT 掩膜数据可以在之前运行时间的 15% 中获得。” ,丹平提到。
2. 增加曲线设计数据的使用
除了硅光子结构,在先进工艺节点的电路布局中直接使用曲线数据的机会可能很快就会被采用。(考虑在 Mn+1 层上使用金属“跳线”来改变 Mn 层上长信号的布线轨道的情况。)行业对曲线数据表示的支持将使这种可能性成为可能,尽管它也会对整个 EDA 工具流程。
3. 指导 ILT 的完整“逆向蚀刻技术”(IET) 流程
较早的图显示了掩模数据生成的“完整循环”流程,并结合了蚀刻后的结果。与其将 ILT 误差函数基于抗蚀剂曝光/显影轮廓的计算模型,不如从最终蚀刻材料图像模型中导出成本函数,如下图所示。

(DOM:掩模尺寸;ADI:光刻胶显影后检测;AEI:蚀刻后检测)
为蚀刻工艺构建“数字孪生”模型需要付出巨大努力。然而,全面的掩膜数据到工艺流程优化的好处将是巨大的。
总结
ILT 显然将扩展到其当前(以内存为中心的)应用程序之外。业界努力支持高效和全面的曲线数据表示标准——包括掩模和设计数据——将有助于加速相应的 EDA 和制造设备的启用。正如丹平所说,“这不是是否使用ILT的问题,而是何时使用ILT以及使用多少层的问题。”
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。



